Коммутационных плат
Техника поверхностного монтажа обусловливает разработку коммутационных плат с повышенными электрическими характеристиками и теплоотводом, что важно для быстродейст-вующих устройств. Выполнение требований к электрическим
характеристикам связано прежде всего с объемным сопротивле-
нием диэлектрического материала основания коммутационной
платы, которое должно быть как можно выше (диапазон объем-
ного удельного сопротивления используемых или рассматривае-
мых как пригодные к использованию материалов обычно состав-
ляет 109-1016 Ом×см). В отношении материалов плат для быст-
родействующих устройств предпринимаются попытки максималь-
но снизить их диэлектрическую проницаемость для уменьшения
паразитной емкости. Вместе с тем необходима совместимость ма-
териалов коммутационных плат с материалами разрабатываемых
сверхбыстродействующих интегральных схем, например, с арсен-
идом галлия. Обычно традиционная стеклоэпоксидная плата
имеет диэлектрическую проницаемость порядка 4,8. Большинство
новых материалов имеет меньшую диэлектрическую проницае-
мость, например, арамидэпоксидные материалы – 3,9, а некото-
рые стеклотефлоновые композиционные материалы – 2,3. Весьма
перспективны для изготовления коммутационных плат фторполи-
меры из-за простоты технологии их обработки и низкой диэлек-
трической проницаемости [9].
Две близкие конструкторско-технологические разработки ком-
мутационных плат представляются весьма перспективными для
ТПМК: заказные платы с заданных полным сопротивлением ли-
нии коммутации и со встроенными пассивными компонентами.
Согласование характеристического сопротивления коммутацион-
ной платы с наиболее важной из устанавливаемых на ней интег-
ральных схем означает отсутствие отражений или искажений в тракте
передачи сигнала на высоких частотах. В настоящее вре-
мя осуществить такое согласование исключительно трудно, по-
скольку допуски
-
на импеданс коммутационной платы могут доходить до ±25%. Это объясняется комплексом причин: разбросом по толщине диэлектрического материала, неточностью соотношений эпоксидной смолы и стекловолокна в составе материала основания платы от партии к партии, просто воздействием медной фольги или подтравленной коммутационной дорожки, которые во многом определяют допуск на импеданс. Вероятно, в течение пяти ближайших лет развитие быстродействующих устройств будет способствовать уменьшению допуска на импеданс до уровня не более ±5%, что в свою очередь потребует от изготовителей коммутационных плат реализации более жестко контролируемых технологических процессов. Использование для плат материалов, обеспечивающих заданный импеданс, и соответствующих технологических процессов позволило создать конструкцию, содержащую пассивные компоненты непосредственно в структуре коммутационной платы. Встраивание конденсаторов малых номиналов в принципе представляется возможным, однако на практике в настоящее время получены пока лишь платы с резистивными нагрузками. Это означает,что резисторы могут
быть электрически соединены непосредственно с полупроводни-
ковой ИС через металлизированное сквозное отверстие. В наи-
более известной на настоящий момент технологии патентованный
материал для плат («Ohmega-Ply» производства Ohmega Tech
nologes Corp.), представляющий собой комбинацию слоев ни-
келя и меди, наносится на диэлектрический слоистый материал
основы (выбираемый из широкого набора материалов - от стек-
лоэпоксидного до фторполимеров), после чего методом селектив-
ного травления формируются встроенные резисторы. Допуск на
номинал резистора равен ±10% и более надежно обеспечивает-
ся электролитическим осаждением, чем при использовании на-
весных чип-резисторов, которые при выполнении полного электри-
ческого соединения их с коммутационной платой могут быть
смещены с места их позиционирования.
Для менее ответственных применений на рынке можно при-
обрести недавно появившиеся резистивные полимеры. В случае,
когда требования к стабильности не являются решающим кри-
терием, можно рекомендовать использование проводящих паст
на основе углеродосодержащих чернил.
В сочетании с TПMK толстопленочные системы на основе по-
лимеров открывают большое разнообразие возможности их реа-
лизации. Применение толстых полимерных пленок обеспечивает
ряд преимуществ: пасты довольно быстро отверждаются (при до-
статочно низких температурах) и могут использоваться для со-
здания полностью аддитивного технологического процесса (са-
мые простые коммутационные платы обычно изготавливаются
методами субтрактивной технологии). Кроме того, при этом су-
ществует возможность широкого выбора материалов основы пла-
ты, поскольку в данном случае к материалу предъявляются всего
лишь два основных требования: минимальная рельефность по-
верхности платы и устойчивость к температурным воздействиям.
Причем требования к рельефности весьма относительны, так как
по всей вероятности в будущем внушительное количество плат
будет производиться в виде монолитных систем с трехмерной
разводкой коммутации (рельефные или объемные платы), выпол-
няющих одновременно функцию коммутационных плат и корпу-
са устройства. Имеются сведения о реализации рельефных плат
с применением по крайней мере двух технологий. Так
называемая «фотоселективная» технология включает литье пласт-
массы с использованием нагрева УФ-излучением и последующую
металлизацию медью. С помощью этой технологии можно полу-
чить металлизированные сквозные отверстия, при этом вся рель-
ефная поверхность платы должна,подвергаться воздействию УФ-
излучения, за исключением участков, закрытых фотомаской. Это
метод одноступенчатого литья. Существует вариант с коммерческим названием «Mould-n-Plate», предполагающий двухступен-
чатое литье, но без применения фотомаски. Пластмасса, с-
формированная на первом этапе литья, покрывается медью методом химического осаждения; на втором этапе литья следующий слой пластмассы формируется в виде маски для создания разводки в проводящем слое, полученном после первого этапа. Другие процессы предполагают широкое привлечение лазерной
технологии, например, для формирования ком-мутационных до-
рожек, но эти технологические разработки еще не вышли из ста-
дии НИР. Лазер может использоваться для удаления сложного
покрытия, нанесенного на изолирующую подложку, а также для
вскрытия проводящего материала через изолирующий слой. Kpo-
ме того, уже реализована лазерная селективная трассировка
коммутации путем удаления экспонированного («темного») по-
лимера, вскрытия подслоя металлизации и формообразования
элементов коммутации.
Исследователи фирмы Toshiba используют также лазеры для
получения недорогим способом углеродосодержащих резистив-
ных слоев из полимерного композиционного материала на стек-
лоэпоксидной и бумажнофенольной подложках. Последние япон-
ские фирмы предпочитают использовать для большинства изде-
лий бытовой электроники. Полученные углеродосодержашне
пленочные резисторы, как следует из сообщений, по качеству
сравнимы со стандартными полимерными резисторами. Толстые полимерные пленки в перспективе позволят реализовать возможности смешанных технологий, поскольку паяемые медные подложки коммутационных плат с мед-
ными контактными площадками, содержащими припой, могут
быть совместимыми с толстопленочной технологией, используе-
мой для изготовления резисторов. На их поверхность можно так-
же монтировать компоненты, например, чип-резисторы. С по-
мощью многослойной структуры проводников можно, вероятно,
также реализовывать, частично или полностью, внешние слои
коммутации, но без проведения повторного отжига, как в случае
обычной толстопленочной технологии. Имеются и другие существенные преимущества. Так, подлож-
ка, коммутационные дорожки, и резисторы, выполненные мето-
дами полимерной технологии, требуют меньших затрат средств,
чем в традиционной технологии. Однако полимеры в настоящее
время непригодны для высоконадежных схем, поскольку темпе-
ратурный коэффициент сопротивления у них хуже, чем у тради-
ционных резисторов. Существуют некоторые сомнения относи-
тельно паяемости многих толстопленочных проводников, поэтому
перед пайкой, обычно требуется дополнительная металлизация контактных площадок. В противном случае должна применяться микросварка с помощью алюминиевой микропроволоки.
Выбору полимерной системы следует уделять большое внимание. Основными материалами в полимерной технологии являются термореактивные и термопластичные полимеры (последние отличаются тем, что плавятся при повторном нагревании, после отверждения). Очень важно также правильно выбрать режим от
верждения. Процесс отверждения обычно проходит в конвекционной печи, хотя в настоящее время для промышленного применения разрабатываются печи с использованием ИК-нагрева, что значительно сокращает длительность процесса отверждения. Эф
фективность методов с ИК нагревом также существенно выше,
поскольку разные полимерные системы характеризуются сильным поглощением излучения на длинах волн ИК-диапазона; образующиеся при этом химические связи имеют максимальную прочность (на молекулярном уровне полимера). Благодаря это-
му формируется пленка со стабильными электрическими пара-
метрами и минимальной усадкой после отверждения.
Проведенные исследования, касающиеся вопросов паяемости показали, что для большинства применений проводящие
пасты имеют вполне приемлемую удельную проводимость. О-
днако, несмотря на то что алюминиевая проволока достаточно хо-
рошо приваривается с помощью клинообразного инструмента к
контактным площадкам платы, покрытым медью (никелем), свар-
ные соединения обладают невысокой прочностью. Сам же ком-
понент закрепляется надежно. Что касается диэлектрических
паст, то исследователи столкнулись с некоторыми трудностями, свя-
занными с их печатью, в частности с недостаточной разрешающей
способностью печати для формирования отверстий межслойных
переходов, в том числе глухих. Вообще печать этих паст явля-
ется сложной технологической операцией из-за различной реоло-
гии паст, хотя по своим электрическим свойствам они пригодны
для использования. Качество резисторов, формируемых на осно-
ве полимерных систем, также оказалось достаточно высоким, но
все же, как правило, оно уступает по некоторым показателям
толстопленочным резисторам (и, естественно, показателям на-
весных чип-резисторов). Допуск на номи-нальное сопротивление полимерного резистора во многом зависит от материалов исполь
зуемой подложки: исследователи полагают, что максимальная
точность достижима лишь при увели-чении количества техноло-
гических операций, например, с помощью нанесения между под-
лож-кой и резистором промежуточного диэлектрического слоя.
Разнообразные конструктивно-технологические варианты изго-
товления устройств с использованием полимерных материалов
представлены в таблице 2.17 (см. также рисунки 2.44 и 2.45) [14].
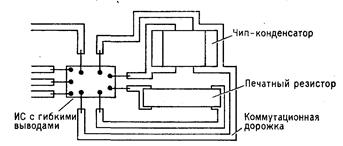
Рисунок 2.44 - Фрагмент микросборки с применением полимерной технологии
Метод трафаретной печати иногда применяется наряду с фотолитографией, например при маскировании проводящих дорожек от затеканий припоя. Разрешающая способность ручной операции получения толстопленочных элементов с использованием трафарета на основе ткани составляет 0,002 дюйма (0,0508мм); металлический трафарет имеет разрешение 0,001 дюйма (0,0254 мм), однако многие изготовители еще не имеют достаточного опыта трафаретной печати с разрешающей способностью лучше 0,001 дюйма (0,0254 мм). Распространенное, но дорогое оборудование может реально пропечатывать линии шириной от 0,003 дюйма (0,0762 мм) до 0,005 дюйма (0,127 мм) с точностью 0,001 дюйма (0,0254 мм). На таком уровне точности воздействие окружающей среды становится существенно значимым фактором и может возникнуть необходимость в использовании чистой комнаты.
Таблица 2.17 - Конструктивно-технологические варианты изготовления
устройств с использованием полимерных материалов
| Конструктивно-технологичекий вариант | Подложка | Коммутация | Особенности монтажа компонентов | Применяемые резисторы |
| Полностью полимерная система Коммутационная плата и полимерная многослоная структура Наружные полимерные проводники | Полимерный композиционный материал (FR4 или другая многослойная структура), а также пластмассовый конструктив Стандартная двухсторонняя плата с металлизированными сквозными отверстиями Керамическая | Полимерные толстопленочные проводники, чередуемые с толстопленочным диэлектриком Медные проводники, полимерные толстопленочные проводники, чередуемые с диэлектрическим покрытием Толстопленочные проводники; структура на основе керамических материалов, покрытая с одной или двух сторон слоем полимерного проводника и полимерного диэлектрика | Пайка или приклейка (проводящим клеем) на контактных площадках платы; монтаж гибкой проволокой на полимерных проводниках Пайка на медных или полимерных проводниках; монтаж с помощью проводящего клея на полимерных проводниках; монтаж гибкой проволокой на полимерных и медных проводниках Пайка или приклейка на любую из толстых пленок; монтаж гибкой проволокой на толстопленочной керамической или полимерной проводящей толстой пленке | Печатные резисторы и (или) навесные чип-резисторы Печатные резисторы и (или) навесные чип-резисторы Печатные толстопленочные резисторы из керамики на основе оксида рутения (подвергаются подгонке перед нанесением на них полимерной толстой пленки); печатные полимерные чип-резисторы, монтируемые с помощью пайки или с применением проводящего клея |
Другие материалы для коммутационных плат.
Одним из способов решения проблемы согласования материалов коммутационных плат по ТКР (температурный коэффициент расширения) с точки зрения качества паяных соединений является правильный выбор материалов для изготовления самой платы. Было бы идеально, если бы ТКР известного или вновь разработанного материала основания платы совпадал, скажем, с ТКР керамического кристаллоносителя. Обычно керамика имеет ТКР порядка 6×10-6 град-1; ТКР широко применяемого стеклоэпоксидного материала, например типа FR4, более чем в два раза больше, порядка (14-18)×10-6 град–1. Большинство новых материалов, рассматриваемых применительно к ТПМК, имеет довольно близкие значения ТКР, лежащие в пределах (6-16)×10-6 град-1. Стеклотефлоновая слоистая структура, являющаяся довольно перспективным в некоторых отношениях материалом, имеет величину ТКР, равную 20×10-6 град-1, и низкую температуру стеклования (75 °С). Некоторые слоистые структуры из модифицированного политетрафторэтилена (например, семейство, материалов RIOSHI, разработанных фирмой Rogers Corp.) действительно обладают низким ТКР (8∙10-6 град–1), низким модулем упругости и малой диэлектрической постоянной.
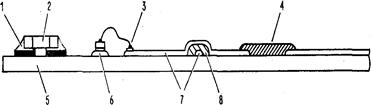
а
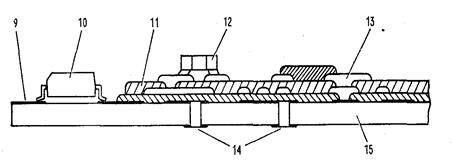
б
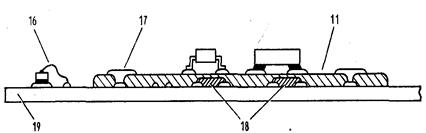
в
Рисунок 2.45 - Варианты конструкции толстопленочной гибридной микросборки, выполненной с применением полимерной технологии: а - толстопленочная ГИС (для наглядности показана однослойная конструкция, хотя возможны многослойные, выполненные на полимерной плате); б - коммутационная плата толстопленочной микросборки с многослойными полимерными покрытиями; в - толстопленочная микросборка, выполненная на анодированной алюминиевой плате по полимерной технологии:
1 - припой; 2 - чип-конденсатор; 3 - припойная площадка; 4 -толстопленочный резистор; 5 - полимерная несущая плата; 6 - навесной бескорпусной активный компонент; 7 - толстопленочный проводник; 8 - диэлектрик; 9 - проводник из меди; 10 - корпусированный компонент, монтируемый на поверхности платы; 11 - полимерный диэлектрик; 12 - чип-конденсатор; 13 - полимерный толстопленочный проводник; 14 - металлизированное сквозное отверстие; 15 - коммутационная плата; 16 - гибкий монтаж безкорпусного компонента с помощью полимерного клея, содержащего золото; 17 - полимерный проводник;18 - печатный резистор (после подгонки); 19 - подложка из анодированного алюминия
В настоящее время выделились два основных направления развития исследований в области создания материалов коммутационных плат [9]:
• Сочетание волокнистых модификаторов, имеющих низкий ТКР, с органическими смолами (например, эпоксидная смола - кевлар, полиимид - кевлар, полиимид - кварц).
• Сочетание компенсационного слоя (или сердечника) платы, имеющего низкий ТКР (например, медь – инвар - медь, сплав 42, сплав медь - молибден - медь, медь - графит) со стекло-эпоксидной или стеклополиимидной многослойной структурой (рисунок 2.46).

Рисунок 2.46 - Типичная многослойная плата с шинами питания и заземления из инвара, плакированного медью:
1 - сигнальная медная шина (либо шина заземления) толщиной 0,0014 дюйма (0,0356 мм); 2 - стеклоэпоксидный материал толщиной 0,004 дюйма (0,1016мм); 3 -стеклоэпоксидный материал толщиной 0,006 дюйма (0,1524 мм); 4 - шина заземления из инвара, плакированного медью, толщиной 0,005 дюйма (0,127 мм); 5 - шина питания из инвара, плакированного медью, толщиной 0,005 дюйма (0,127 мм); 6 - стеклоэпоксидный материал толщиной 0,006 дюйма (0,1524 мм)
Таблица 2.18 - Материалы для изготовления коммутационных плат и их основные характеристики
| Материал | Рабочая температура | Модуль упругости, фунт/дюйм2 | ткр, °С | ΔТКР (по отношению к оксиду алюминия) | J-фактор (модуль упругости×DТКР) | Коэффициент прогиба, фунт/дюйм |
| Оксид алюминия | 40×10 6 | 6,4×10 -6 | 40×10 6 | |||
| Тефлон (не модифицированный) | 100 °С 23 °С 56 °С | 0,015×10 6 0,0516×10 6 0,1×××10 6 | 100×10 6 | 94,6×10 -6 | 1,4 4,9 9,46 | 15×10 3 51,6×10 6 100×10 3 |
| Полиимид (кантон) | 0,61.10 6 | 45×10 -6 | 38,6 ×10 -6 | 23,5 | 610×10 3 | |
| Полиимидное стекловолокно | 4,5.10 6 | 16×10 -6 | 9,6×10 -6 | 43,2 | 4,5×10 4 | |
| Медь | 17×10 6 | 17,6×10 -6 | 11,2×10 -6 | 190,4 | 17×10 4 | |
| Припой (63/37) | 100 °С | 1,8×10 6 | 22×10 -6 | 27,6 | 1,8×10 4 | |
| 23 °С | 3,0.10 6 | 21,5×10 -6 | 15,35×10 -6 | 46,1 | 3,0×10 4 | |
| -56 °С | 4,7×10 6 | 21,5×10 -6 | 72,1 | 4,7×10 4 | ||
| Силиконовая резина | -23 °С | 0,225×10 3 | 810×10 -6 | 804,5×10 -6 | 0,1822 | 0,225×10 3 |
| Алюминий | 10×10 6 | 23,7×10 -6 |
Кевлар, в сущности, имеет самый низкий ТКР (по оси X, Y) из всех перечисленных материалов (3-7)×10 -6 град –1 и меньшую диэлектрическую постоянную, чем стекло (что особенно важно для быстродействующих устройств), но довольно сильно поглощает влагу и подвержен микрорастрескиванию, что связано с высоким ТКР по оси Z (перпендикулярно подложке). Существуют также трудности в получении хорошей адгезии составов «смола - волокно» с композиционными материалами, включая кевлар. В сравнении с имеющимися материалами для изготовления коммутационных плат кевлар обладает значительными преимуществами: он примерно на 20% легче стеклоэпоксидного материала и т. д., однако специалисты считают технологию его обработки довольно сложной.
Основным доводом против использования материалов с компенсационным слоем является их вес, но с учетом перспективы уменьшения габаритов коммутационной платы в будущем этот фактор может стать менее существенным. Кроме того, металлические компенсаторы могут служить в качестве теплоотвода. Вероятно, основным материалом компенсационного слоя в плане перспективы применения является инвар, плакированный медью, который достаточно широко применяется в производстве коммутационных плат на фирмах-изготовителях сложной аппаратуры, таких как АТТ, которая использует его в своей системе WE 32000. Каждая система содержит шестислойные платы 2,5 х 3,5 дюйма (63,5 х 88,9 мм), несущие на одной плате до шести безвыводных керамических (с 84 контактными площадками) кристаллоносителей. В качестве материала компенсационного слоя инвар относительно недорог. Перспективным материалом для более эффективного отвода тепла является молибден, плакированный медью, хотя и стоит дороже. В таблицах 2.18 и 2.19 приведены материалы, используемые в настоящее время для изготовления коммутационных плат, и их основные характеристики.
Таблица 2.19 - Сравнение слоистых структур для коммутационных плат
| Материал | Показателя, оцениваемые положительно | Показатели, оцениваемые отрицательно |
| Эпоксидная смола - стекловолокно | Диапазон выбора размеров достаточно широк; ремонтопригодность; хорошие диэлектрические свойства; возможность использования приемов традиционной технологии обработки | Невысокая удельная теплопроводность; ТКР по осям X, Y и Z |
| Полиимид - стекловолокно | Те же, что и для материала эпоксидная смола – стекловолокно. Кроме того, линейная деформация по оси Х наблюдается при высоких температурах | Невысокая удельная теплопроводность; ТКР по осям X, Y и Z; повышенная влагопоглощаемость |
| Эпоксидная смола - арамидное волокно (кевлар) | Те же, что и для материала эпоксидная смола - стекловолокно, но вес гораздо меньше (наилегчайший); небольшой ТКР по осям Х и Y | Невысокая удельная теплопроводность; ТКР по осям Х и Y; возможны микрорастрескивания смолы; повышенный ТКР по оси Z; влагопоглощаемость |
| Полиимид - арамидное волокно | Те же, что и для материала эпоксидная смола - арамидное волокно, но ТКР по оси Z значительно меньше | Невысокая удельная теплопроводность; ТКР по осям Х и Y; возможны микрорастрескивания смолы; влагопоглощаемость |
| Эпоксидная смола - кварц (плавленый кремнезем) | Диапазон выбора размеров, а также небольшой вес, ремонтопригодность такие же, как у материала эпоксидная смола – стекловолокно; диэлектрические свойства и технология обработки такие же, как у обычных плат | Невысокая удельная теплопроводность; ТКР по осям Х и У; повышенный ТКР по оси Z; недостаточно высокое качество сверления; объем выпуска ограничен; стоимость недостаточно низкая; малое содержание смолы |
| Полиимид – кварц (плавленый кремнезем) | Те же, что и для материала полиимид - арамидное волокно; малый ТКР по оси Z; приемлемый диапазон выбора размеров; небольшой вес; ремонтопригодность, высокие деиэлектрические сваойства | Невысокая удельная теплопроводность; ТКР по осям X и Y; недостаточно высокое качество сверления; ограничен объем выпуска; высокая стоимость |
| Стекловолокно - композиционное арамидное волокно | Те же, что и для материала полиимид - арамидное волокно, но отсутствуют микротрещины; малый ТКР по оси Z; диапазон выбора размеров платы достаточно широк; малый вес; ремонтопригодность; высокие диэлектрические свойства | Недостаточная удельная теплопроводность; ТКР по осям X и Y; влагопоглощаемость; наличие ловушек припоя флюса |
| Коммутационная плата на жестком основании из материала с низким ТКР (металла или неметалла) | Наличие диапазона выбора размеров; ремонтопригодность; возможность использования приемов традиционной технологии обработки; ТКР по осям X и Y; обеспечивается жесткость конструкции, экранирование от наводок и охлаждение устройства | Вес платы недостаточно мал |
| Коммутационная плата со встроенным металлическим слоем (сердечником), имеющим низкий ТКР | Те же, что и у плат на жестком основании из материала с низким ТКР | Вес платы недостаточно мал; требуется точное совмещение внутренних слоев |
Дата добавления: 2020-10-14; просмотров: 808;











