По собственным точечным дефектам
Диффузия примесей замещения в кремнии происходит по непрямому вакансионно-междоузельному механизму при участии собственных точечных дефектов (СТД) – вакансий или СМА. Поэтому отклонение концентраций СТД от своих термодинамически равновесных значений должно влиять на скорость диффузии. Нарушение равновесия по СТД может происходить при отжиге в активных газовых средах, например, при термическом окислении (см. 2.8) или при нитризации кремния, а также в неактивных газовых средах или в вакууме при высоких температурах. Коэффициент диффузии примеси замещения (A) в кремнии может быть представлен в виде суммы коэффициентов диффузии по вакансионному (DAV) и по непрямому междоузельному (DAI) механизмам:
DA = DAV + DAI.
Каждая из составляющих пропорциональна относительной концентрации соответствующих СТД:
 ,
,
где значок «*» соответствует условию термодинамического равновесия по СТД, aV и aI – относительные пересыщение или недосыщение по вакансиям и СМА, соответственно, при выполнении условия локального равновесия aV = 1/aI. Таким образом, имеем
 ,
,
где fV и fI – долевые коэффициенты вакансионного и непрямого междоузельного механизмов диффузии соответственно, определяемые выражениями
 fV + fI = 1.
fV + fI = 1.
В результате изучения поведения примесей в условиях нарушения равновесия по СТД были определены долевые коэффициенты вакансионного и непрямого междоузельного механизмов диффузии для примесей замещения в кремнии: fI (Al, In, Ga) @ 0.99; fI (B) @ 0.95; fI (P) @ 0.9; fI (As) @ 0.5; fI (Sb) @ @ 0.02. Cоответственно, fV (Al, In, Ga) @ 0.01; fV (B) @ 0.05; fV (P) @ 0.1; fV (As) @ 0.5; fV (Sb) @ 0.98.
Таким образом, примеси Al, In, Ga, B и P диффундируют в кремнии преимущественно по непрямому междоузельному механизму, примесь Sb – преимущественно по вакансионому механизму, а примесь As – по смешанному.
ИОННАЯ ИМПЛАНТАЦИЯ
3.1. Ионная имплантация в технологии ИМС
Ионная имплантация (ИИ) – это процесс внедрения ионов в подложку с энергией от E = 1…10 кэВ до E @ 1 МэВ. Ионное легирование (ИЛ) помимо имплантации включает электрическую активацию внедрённой примеси, что достигается с помощью отжигов. Отжиги могут проводиться с помощью термических печей (обычный термический отжиг), некогерентного излучения мощными лампами накаливания (быстрый термический отжиг), когерентного светового излучения импульсными лазерами (лазерный отжиг), сканирующего пучка электронов (электронный отжиг) или ионов (ионный отжиг), а также СВЧ-излучения (СВЧ-отжиг). Во всех вариантах происходит трансформация энергии излучения в энергию колебания атомов решетки подложки, т. е. отжиги носят термический характер. ИИ и, соответственно, ИЛ имеют ряд преимуществ перед методом диффузионного легирования.
1. Высокая точность набора дозы (не ниже 1%), q = eQ = jt, где e – заряд электрона (e = 1.6×10–19 Кл); Q – количество примеси, внедрённой в подложку; j – плотность ионного тока; t – время имплантации. Доза обычно измеряется в микрокулонах на квадратный сантиметр, доза q = 1 мкКл/см2 соответствует количеству внедрённой примеси Q = q/e = 6.25×1012 см–2.
2. Возможность управления профилем имплантированной примеси варьированием энергии и дозы при последовательных имплантациях.
3. Универсальность – возможность внедрения любых ионов (в том числе и ионов молекул) в твердые подложки любого состава.
4. Низкие температуры имплантации (обычно используется комнатная ~300 К). Это даёт возможность ионного легирования подложек из термически нестабильных материалов, в частности полупроводниковых соединений, например, GaAs , GaP, InSb, InP.
5. Возможность ИИ через маску (в том числе резистивную) на поверхности подложки.
6. Возможность получения скрытых легированных слоёв в глубине подложки.
7. Возможность получения соединений с помощью ИИ – ионный синтез. Например, получение SiO2 или Si3N4 имплантацией ионов O+ или N+ в кремниевую подложку.
Особенностью ИЛ является образование в имплантированном слое первичных и вторичных радиационных дефектов в процессе имплантации и преобразование их в протяженные структурные дефекты при последующих отжигах.
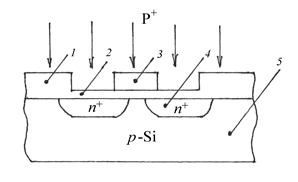 Примеры использования ИИ в технологии ИМС.
Примеры использования ИИ в технологии ИМС.
· Получение слабо легированных слоёв с концентрацией примеси менее ~ 1017 см–3 и высокоомных резисторов со слоевым сопротивлением Rs > > 1000 Ом/кв.
 · Самосовмещённая МОПТ-технология (рис. 3.1) позволяет полу-чать малое перекрытие затвора со стоком и истоком, контролируемое только боковой диффузией и страг-глингом. В обычной МОПТ-технологии размер перекрытия определяется вынужденным допуском на рассовмещение при фотолитографии.
· Самосовмещённая МОПТ-технология (рис. 3.1) позволяет полу-чать малое перекрытие затвора со стоком и истоком, контролируемое только боковой диффузией и страг-глингом. В обычной МОПТ-технологии размер перекрытия определяется вынужденным допуском на рассовмещение при фотолитографии.
· SIMOX-технология (separation by implantation of oxygen) получения скрытых слоёв SiO2 под тонким (0.1…0.3 мкм) монокристаллическим слоем кремния.
Дата добавления: 2016-12-16; просмотров: 1749;











