Лабораторная работа №2
Исследование характеристик и параметров полупроводниковых диодов
| Цель работы: | Изучение вольт – амперных характеристик полу- проводниковых германиевых и кремниевых диодов, их сравнение и анализ. |
ВВЕДЕНИЕ
Наиболее распространенным типом полупроводниковых приборов, получивших широкое применение в радиоэлектронике, являются полупроводниковые диоды (ПД). Это двухэлектродные приборы, работа которых основана на использовании свойств p – n перехода. ПД различного назначения используют и различные свойства p – n перехода (односторонняя проводимость, зависимость емкости перехода от напряжения на нем, нелинейность вольт – амперной характеристики (ВАХ), фоточувствительность, излучательная способность и т.д.).
Основной характеристикой ПД является вольт – амперная характеристика (ВАХ), представляющая собой зависимость тока диода от приложенного к нему напряжения при прямом и обратном смещении. Часть ВАХ, полученная при прямом смещении, называется прямой ветвью ВАХ, а при обратном – обратной.
Функциональные возможности и характеристики ПД определяются выбором типа полупроводникового материала, техно
логией изготовления прибора и рядом других факторов. ПД могут использоваться как самостоятельные элементы, изготовленные в отдельном корпусе (дискретные элементы), либо как составные части достаточно сложных функциональных устройств, выполненных на одном полупроводниковом кристалле – интегральных микросхем (интегральные элементы).
- ТЕОРЕТИЧЕСКАЯ ЧАСТЬ
2.1 Принципы работыp – nперехода.
Работа практически всех полупроводниковых приборов основана на использовании свойств p – n перехода, который формируется на границе раздела двух полупроводников с различными типами носителей или с разной концентрацией носителей одного типа.
Напомним, что чистый полупроводник при 0 К является диэлектриком, поскольку все электроны внешних оболочек атомов заняты в формировании химических связей и свободных носителей заряда, способных проводить электрический ток, просто нет. С повышением температуры усиливаются колебания атомов в кристаллической решетке, и некоторые электроны могут получить дополнительную энергию и стать свободными. Так образуется пара собственных носителей электрон – дырка. Дырка – это вакансия в химической связи, образовавшаяся после выхода из нее электрона. В электрическом смысле она ведет себя как равный по величине электрону, но положительный заряд. С ростом температуры растет и число собственных носителей, поэтому проводимость полупроводника увеличивается. В этом главное отличие полупроводников от металлов. Полупроводник без примесей называется собственным полупроводником.
Введение в собственный полупроводник донорной примеси (атомов химического элемента с большей валентностью, чем у основного полупроводника) приводит к появлению дополнительных свободных электронов, т.к. на внешней электронной оболочке примеси их больше, чем требуется для заполнения всех химических связей. Так получается полупроводник с преимущественно электронным типом проводимости (n - типа). Если же ввести акцепторную примесь (с меньшей валентностью), то возникает избыток дырок в полупроводнике, т.к. у атомов примеси недостаточно внешних электронов для заполнения всех химических связей. Проводимость полупроводника в этом случае преимущественно дырочная (p - типа). Оба типа полупроводников называют примесными полупроводниками. Носители, преобладающие в примесном полупроводнике называются основными, а носители противоположного знака – неосновными.
Если обеспечить надежный электрический контакт между полупроводниками p – и n – типа (например, путем контактной сварки), то из-за градиента концентрации носителей в области контакта возникает диффузионный поток дырок из p – области в n – область и встречный поток электронов из в n – области в p – область. Эти потоки, обусловленные инжекцией электронов и дырок через область контакта (металлургический переход), называют инжекционными (диффузионными). Преодолев металлургический переход, электроны и дырки попадают в области, в которых они являются неосновными носителями, и под действием сил притяжения диффундируют внутрь полупроводника, где встречаются с основными носителями и образуют нейтральную частицу – рекомбинируют. Каждый акт рекомбинации уничтожает пару носителей электрон – дырка.
После ухода дырок из p – области вблизи границы раздела остается объемный отрицательный заряд ионизированных атомов акцепторной примеси, и точно так же появляется объемный положительный заряд донорных атомов в n – области. Таким образом, формируется двойной слой электрических зарядов (аналог конденсатора), поле которого препятствует дальнейшей диффузии электронов и дырок и увеличивается вместе с ростом плотности объемных зарядов. В итоге наступает состояние равновесия, когда контактное поле достигает такой величины, при которой диффузия прекращается. Получившая в результате этого процесса структура называется p – n переходом.
Р – n переходы созданные путем механического соединения двух полупроводников с разным типом проводимости, называются резкими. Плавные p– n переходы создаются введением диффузионным методом донорной примеси с одной стороны собственного полупроводника и акцепторной примеси – с другой стороны.
Энергетические состояния электронов в кристаллах в физике твердого тела описывают на основе зонной теории, согласно которой электроны атомов, формирующих кристалл, могут занимать вполне определенные уровни на энергетической шкале (рис.1а). Внутренние электроны атомов заполняют набор очень близко расположенных энергетических уровней, образующих почти непрерывную зону энергий внутренних электронов (таких зон несколько, но на рис.1а показана только одна). Электроны внешних оболочек, формирующие химические 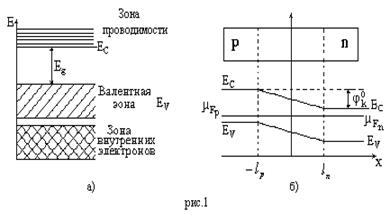 связи атомов, образуют валентную зону энергетических уровней.
связи атомов, образуют валентную зону энергетических уровней.
Уровень с максимальной энергией в этой зоне EV называется потолком валентной зоны. Свободные электроны могут занимать энергетические уровни в зоне проводимости, уровень с наименьшей энергией в которой, EC, называется дном зоны проводимости. Между всеми зонами разрешенных значений энергии на энергетической шкале есть некоторые интервалы, значения энергии из которых электроны иметь не могут. Это запрещенные зоны. Наибольшее влияние на свойства p – n перехода оказывает величина запрещенной зоны Eg между валентной зоной и зоной проводимости.
Процессы переноса заряда в p – n переходе принято описывать с помощью энергетических диаграмм, по оси ординат в которых откладывается энергия, а по оси абсцисс линейные размеры полупроводника в области перехода (рис.1б). Если электрон, находящийся в химической связи, получит энергию E > Eg, то он становится свободным и занимает один из свободных уровней в зоне проводимости (выше EC). Возникшая вакансия в химической связи (дырка) занимает уровень в валентной зоне (ниже EV). Если E < Eg, то электрон освободится, не может, т.к. все уровни в запрещенной зоне для него недоступны. Таким образом, электроны проводимости занимают свободные уровни в зоне проводимости, а дырки - в валентной зоне.
При внедрении в собственный полупроводник донорной или акцепторной примеси возникают дополнительные примесные уровни энергии. Избыточному валентному электрону атома – донора соответствует уровень энергии немного меньший, чем дно зоны проводимости EC. Атомы – акцепторы в полупроводнике p – типа создают примесные уровни вблизи потолка валентной зоны. Эти уровни немного выше EV, т.к. соответствуют состоянию связи, на которой не хватает одного электрона.
Энергия электронов в кристалле полностью определяется его температурой. Распределение электронов по энергиям при заданной температуре описывается вероятностно – статистическими методами. При описании физических свойств полупроводников важную роль играет уровень Ферми, т.е. уровень энергии, вероятность заполнения которого электроном при заданной температуре p=0,5. В собственном полупроводнике уровень Ферми лежит почти посредине запрещенной зоны. Появление примесных уровней приводит к смещению уровня Ферми: в донорном полупроводнике уровень Ферми смещается в сторону зоны проводимости, а в акцепторном – в сторону валентной зоны.
Для перехода электрона (дырки) с примесного уровня в зону проводимости (валентную зону) требуется небольшая дополнительная энергия. Даже при небольшом по величине и времени воздействии (тепловом, световом, электрическим напряжением и т.д.) носители становятся свободными и могут обеспечивать электропроводность. Чем ближе уровень Ферми расположен к одной из границ запрещенной зоны, тем легче носителям примесных уровней стать свободными. Таким образом, полупроводник с уровнем Ферми  (рис.1б) является полупроводником p – типа (дырочный), а с уровнем
(рис.1б) является полупроводником p – типа (дырочный), а с уровнем  - полупроводником n – типа (электронный).
- полупроводником n – типа (электронный).
Наличие контактного поля p – n перехода приводит к изменению положения уровней EV и EС, энергетические зоны в области перехода искривляются (рис.1б). Поэтому при переходе электрона из n –области в p – область он должен преодолеть потенциальный барьер, равный  , где: g – заряд электрона; VK – контактная разность потенциалов. Такой же барьер должны преодолеть и дырки при встречном переходе.
, где: g – заряд электрона; VK – контактная разность потенциалов. Такой же барьер должны преодолеть и дырки при встречном переходе.
В области пространственного заряда (  ), особенно вблизи x=0, концентрация свободных носителей очень мала, поэтому p – n переход представляет собой две низкоомные p – и n –области, разделенные высокоомной областью p – n перехода. Приложенное к такой системе внешнее электрическое поле будет сосредоточено, в основном, в высокоомной области пространственного заряда. В низкоомных областях поле будет малым, и в дальнейшем учитываться не будет.
), особенно вблизи x=0, концентрация свободных носителей очень мала, поэтому p – n переход представляет собой две низкоомные p – и n –области, разделенные высокоомной областью p – n перехода. Приложенное к такой системе внешнее электрическое поле будет сосредоточено, в основном, в высокоомной области пространственного заряда. В низкоомных областях поле будет малым, и в дальнейшем учитываться не будет.
Приложенное внешнее напряжение U суммируется в области p – n перехода с контактной разностью потенциалов VK, определяющей высоту потенциального барьера j0к (рис.2). Величина jк будет изменяться в пределах  где знак определяется полярностью приложенного напряжения. Для подачи внешнего напряжения на торцы p – и n – слоев напыляются слои металла, к которым припаиваются проводники. Так получается простейший прибор с одним p – n переходом, называемый полупроводниковым диодом (рис.2в).
где знак определяется полярностью приложенного напряжения. Для подачи внешнего напряжения на торцы p – и n – слоев напыляются слои металла, к которым припаиваются проводники. Так получается простейший прибор с одним p – n переходом, называемый полупроводниковым диодом (рис.2в).
Если поле внешнего напряжения противоположно полю контактной разности потенциалов, то барьер  с ростом U уменьшается и через p – n переход потечет ток (рис.2а). Когда внешнее напряжение достигнет значения
с ростом U уменьшается и через p – n переход потечет ток (рис.2а). Когда внешнее напряжение достигнет значения  , потенциальный барьер практически исчезнет и величина тока почти полностью будет определяться объемным сопротивлением p – и n – областей.
, потенциальный барьер практически исчезнет и величина тока почти полностью будет определяться объемным сопротивлением p – и n – областей.
При обратной полярности приложенного напряжения потенциальный барьер  будет возрастать с ростом U. В этом случае носители заряда могут двигаться только от тех областей, где они являются неосновными, поэтому и ток будет мал из – за малой концентрации неосновных носителей. Не учитывая генерацию носителей в области перехода, можно утверждать, что напряжение на переходе влияет только на скорость движения носителей в области перехода, но не на их количество.
будет возрастать с ростом U. В этом случае носители заряда могут двигаться только от тех областей, где они являются неосновными, поэтому и ток будет мал из – за малой концентрации неосновных носителей. Не учитывая генерацию носителей в области перехода, можно утверждать, что напряжение на переходе влияет только на скорость движения носителей в области перехода, но не на их количество.
Средняя скорость теплового движения и концентрация неосновных носителей для данного полупроводника при данной температуре - величины постоянные. Поэтому их ток не зависит от величины потенциального барьера и остается малым при любом внешнем напряжении. Таким образом, p – n переход обладает односторонней (униполярной) проводимостью, что широко используется в различных приборах. Напряжение, снижающее потенциальный барьер, называют прямым напряжением. Также прямым
 называется и ток через p – n переход при таком напряжении. Напряжение, увеличивающее высоту потенциального барьера, и ток при этом напряжении называются обратными.
называется и ток через p – n переход при таком напряжении. Напряжение, увеличивающее высоту потенциального барьера, и ток при этом напряжении называются обратными.
2.2 Вольт – амперные характеристики p – n перехода
При выводе уравнения ВАХ принимают два условия:
1) p– n переход работает при низком уровне инжекции, т.е. концентрация прошедших через металлургический переход зарядов из соседней области (неосновных для данной области), мала по сравнению с концентрацией основных носителей;
2) в области p– n перехода отсутствуют генерация и рекомбинация носителей. Это соответствует условию  средняя длина диффузионного пробега носителей заряда(рис.2).
средняя длина диффузионного пробега носителей заряда(рис.2).
Обозначим концентрации электронов и дырок в p–области, соответственно, np и pp, а вn– области nn и pn. По статистике Максвелла – Больцмана равновесная концентрация неосновных носителей (например, дырок вn– области) в отсутствии внешнего напряжения на переходе записывается:

 , (2.1)
, (2.1)
где:  Дж/К - постоянная Больцмана, Т – абсолютная температура (К).
Дж/К - постоянная Больцмана, Т – абсолютная температура (К).
При подаче прямого напряжения U концентрация дырок в области  возрастает в результате снижения потенциального барьера:
возрастает в результате снижения потенциального барьера:
 (2.2)
(2.2)
Следовательно, в области  возникла избыточная концентрация дырок по сравнению с равновесной концентрацией во всем объеме n– области:
возникла избыточная концентрация дырок по сравнению с равновесной концентрацией во всем объеме n– области:
 (2.3)
(2.3)
Отметим, что избыточная концентрация дырок  зависит только от приложенного напряжения U и концентрации дырок в n– области, но не зависит от параметров р– области.
зависит только от приложенного напряжения U и концентрации дырок в n– области, но не зависит от параметров р– области.
Аналогичным путем получим избыточную концентрацию электронов в области  :
:
 (2.4)
(2.4)
Избыточные концентрации электронов и дырок создают условия для диффузии инжектированных в n– область электронов вглубь этих областей. Концентрация этих носителей будет уменьшаться при удалении от p– n перехода за счет рекомбинации с основными носителями. Для сохранения электронейтральности из глубины n– и р– областей к p– n переходу притягиваются электроны и дырки, которые и обеспечивают процессы рекомбинации инжектированных неосновных зарядов. Таким образом инжекционный ток электронов  равен рекомбинационному току дырок в р– области, а инжекционный ток дырок
равен рекомбинационному току дырок в р– области, а инжекционный ток дырок  равен рекомбинационному току электронов в n– области. Поскольку р– и n– области и область p– n перехода включены последовательно, то общий ток в них одинаков. Меняется только соотношение между дырочной и электронной составляющими при постоянном напряжении, но в зависимости от координаты x:
равен рекомбинационному току электронов в n– области. Поскольку р– и n– области и область p– n перехода включены последовательно, то общий ток в них одинаков. Меняется только соотношение между дырочной и электронной составляющими при постоянном напряжении, но в зависимости от координаты x:
 (2.5)
(2.5)
Плотности электронной и дырочной составляющих диффузионных токов в области p– n перехода определяются соотношениями:
 (2.6)
(2.6)
 (2.7)
(2.7)
где: Dp и Dn – коэффициенты диффузии электронов и дырок.
Согласно второму принятому условию в области p – n перехода концентрация инжектированных носителей не меняется поскольку там нет генерации и рекомбинации носителей. Поэтому в области  составляющие токов постоянны. Принимая значения
составляющие токов постоянны. Принимая значения  для тока
для тока  и
и  для тока
для тока  с учетом соотношения (2.5), получим уравнение ВАХ p– n перехода:
с учетом соотношения (2.5), получим уравнение ВАХ p– n перехода:  (2.8)
(2.8)
где:
 (2.9)
(2.9)
S – площадь поперечного сечения p – n перехода.
Ток  , определяемый по (2.9) называется током насыщения p – nперехода. Его величина не зависит от приложенного напряжения. Поэтому на обратной ветви ВАХ (U<0) при условии
, определяемый по (2.9) называется током насыщения p – nперехода. Его величина не зависит от приложенного напряжения. Поэтому на обратной ветви ВАХ (U<0) при условии  можно пренебречь в (2.8) экспонентой по сравнению с единицей. Тогда обратная ветвь ВАХ имеет участок насыщения при указанном условии:
можно пренебречь в (2.8) экспонентой по сравнению с единицей. Тогда обратная ветвь ВАХ имеет участок насыщения при указанном условии:
 . (2.10)
. (2.10)
Эта зависимость справедлива при напряжениях U, меньших, чем напряжение пробоя, речь о котором пойдет ниже.
При прямом напряжении на p – n переходе (U>0) и при выполнении условия  можно пренебречь единицей в (2.8), т.к.
можно пренебречь единицей в (2.8), т.к.  . Тогда прямой ток перехода описывается
. Тогда прямой ток перехода описывается
 (2.11)
(2.11)
Величина прямого и обратного тока p – n перехода весьма сильно зависит от материала полупроводника при прочих равных условиях. Основную роль играет ширина запрещенной зоны Eg, определяющая концентрацию свободных носителей. Так при комнатной температуре T=300 К, Eg=1,12 эВ для кремния (Si) и Eg=0,66 эВ для германия (Ge). При той же температуре концентрация собственных носителей (электронов) составляет  для кремния и
для кремния и  в германии. Аналогично влияние и на концентрацию примесных носителей. Поэтому, согласно (2.9) плотность тока насыщения в p – n переходе на полупроводнике с большей шириной запрещенной зоны должна быть значительно меньше плотности тока в полупроводнике с меньшим значением Eg.
в германии. Аналогично влияние и на концентрацию примесных носителей. Поэтому, согласно (2.9) плотность тока насыщения в p – n переходе на полупроводнике с большей шириной запрещенной зоны должна быть значительно меньше плотности тока в полупроводнике с меньшим значением Eg.
С увеличением концентрации примесей в прилегающих к переходу областях плотность тока насыщения должна уменьшаться.
Если p – n переход не симметричный, т.е. одна из областей содержит большую концентрацию примеси (сильнее легирована), чем другая, и поэтому имеет большую проводимость, то при прямом смещении p – n перехода преобладает поток носителей из сильно легированной области в слабо легированную и ток создается практически носителями, одного знака. Слабо легированную область диода называют базой, а сильно легированную – эмиттером.
Если, например, проводимость sn n – области много больше проводимости sp р – области, т.е. концентрация доноров Nд в n – области много больше концентрации акцепторов Na вp–области, то инжекция электронов из n- эмиттера в p- базу приводит к “заливанию” базы электронами. В этом случае (2.11) можно записать в виде:

 (2.12)
(2.12)
где:

Инжектированные электроны рекомбинируют в базе с дырками и энергия рекомбинации выделяется в виде тепла, что приведет к разогреву диода. Использование полупроводниковых материалов с большой запрещенной зоной (арсенид галлия, фосфид индия, карбид кремния) позволяет преобразовать энергию электронно-дырочной рекомбинации в кванты света. Такие диоды широко применяются в качестве различных индикаторов (светодиоды), либо источников когерентного излучения (полупроводниковые лазеры).
 С ростом прямого напряжения потенциальный барьер понижается и полностью исчезает при напряжении
С ростом прямого напряжения потенциальный барьер понижается и полностью исчезает при напряжении  Формула (2.8) при этом уже не вполне справедлива, т.к. при
Формула (2.8) при этом уже не вполне справедлива, т.к. при  ВАХ определяется электропроводностью n– и р– областей (в несимметричном переходе – проводимостью слабо легированной области).
ВАХ определяется электропроводностью n– и р– областей (в несимметричном переходе – проводимостью слабо легированной области).
Рис.3 представляет типичную ВАХ p – n перехода при обратных напряжениях меньше напряжения пробоя. Область 1 соответствует прямому смещению p – n перехода, область 2 – обратному.
Дата добавления: 2016-11-04; просмотров: 2233;











