Оборудование для подготовки технологических сред
17.1 Оборудование для обеспечения производственной гигиены
Производство надежных и долговечных полупроводниковых приборов и микросхем даже при правильно выбранной технологии немыслимо без соблюдения производственной гигиены, под которой понимают комплекс мероприятий, обеспечивающих защиту элементов и деталей приборов от всевозможных загрязнений. Кристаллы и пластины с электронно-дырочными переходами, соответственно составляющие основу полупроводниковых приборов и микросхем, особенно чувствительны к попаданию на них влаги, кислот, щелочей и других веществ. Взаимодействуя с парами воды, эти вещества образуют подвижные заряды-ионы, переносящие ток через переход и нарушающие нормальную работу прибора, особенно после его разогрева.
Чтобы обеспечить выполнение требований производственной гигиены, необходимо правильно выбрать район расположения предприятия, конструкцию здания, размещение цехов, обеспечить в рабочих помещениях определенные влажность и температуру, а также провести организационные мероприятия, направленные на выполнение правил производственной гигиены работающими. Основные виды загрязнений цехов — это пыль, пары воды и газы.
Стандартом установлено следующее разделение производственных помещений и рабочих объемов в зависимости от максимальной концентрации частиц в 1 л воздуха: 0; 5; 35; 350; 1000; 3500; 10 000; 35 000. Этим же стандартом определен единый минимальный размер аэрозольных частиц в воздушной среде производственных помещений и технологических газах, равный 0,5 мкм. В зависимости от характера выполняемых работ относительная влажность воздуха производственных помещений должна поддерживаться в диапазоне 40-60%, а температура - от 20 до 27 °С.
Такие технологические операции, как окисление, диффузия, наращивание эпитаксиальных слоев, должны выполняться в рабочем объеме (зоне загрузки) с концентрацией не более 5 частиц пыли в 1 л воздуха при концентрации не более 3500 частиц пыли в общем объеме производственного помещения. Если эти операции проводятся в специальных гермозонах (чистых коридорах), концентрация частиц пыли должна быть не более 350 в 1 л воздуха. Температура в зоне загрузки должна быть в пределах 18— 27 °С, относительная влажность — 40—60%, технологические газы (азот, кислород, водород, аргон) — класса чистоты 1, деионизованная вода — марки А.
Примерно при тех же условиях, но в помещениях с концентрацией не более 35 частиц в 1 л воздуха производят вакуумное нанесение диэлектрических и проводящих слоев.
Если проследить основные причины образования загрязнений, окажется, что на поверхности полупроводниковых пластин адсорбируются молекулы газов, так как поверхностные атомы кристаллической решетки полупроводника имеют ненасыщенные связи и поэтому обладают высокой химической активностью. Какие бы меры по сохранению чистоты поверхности полупроводниковых пластин не предпринимались, защитить их от загрязнений невозможно, т.е. нельзя получить идеально чистую поверхность, на которой отсутствуют посторонние атомы или молекулы.
Назначение электронной гигиены — создание условий для получения практически чистых поверхностей полупроводниковых пластин. Такие поверхности имеют однородный химический состав второго слоя атомов.
Полупроводниковые пластины после механической обработки должны иметь минимальную глубину разрушенного слоя монокристалла (минимальную шероховатость) и загрязненность, так как эти дефекты проявляются на последующих операциях технологического процесса и приводят к значительному браку. Так, на поверхности полупроводниковой пластины с неровностями и царапинами при выращивании пленки диоксида кремния образуются микропоры и нарушается сплошность покрытия. В эти микропоры при диффузии попадает диффузант и образуются дефекты.
На качество эпитаксиальных слоев влияют осевшие на пластины пылинки, неудаленные кислоты, растворители, а также примеси в газе-носителе, газовом травителе, легирующих составах.
Дефекты эпитаксиальных слоев определяются наличием примесей в кремниевых подложках (пластинах), а также захватываемых в процессе наращивания. При прямых процессах эпитаксии наличие примесей в подложках способствует образованию дислокаций. При непрямых процессах эпитаксии, когда наращиваемый слой образуется при разложении кремниевых соединений, дефектов образуется еще больше, так как в переносе кремния участвует значительное количество веществ и, следовательно, совершается больше реакций. Примесь кислорода в газе-носителе приводит к образованию центров дислокаций и локальных дефектов упаковки. Посторонние частицы, температура плавления (сгорания) которых выше температуры плавления подложек, обволакиваются растущим слоем и являются центрами локальных дефектов.
Качество металлических пленок существенно зависит от состояния поверхности подложек, их температуры и наличия большого количества остаточных газов в рабочем объеме вакуумной установки. Хорошая адгезия не образуется, если при осаждении металла температура нагрева недостаточна, а поверхность подложки загрязнена. Большое количество остаточных газов способствует изменению структуры и свойств металлических пленок. Так, при соединении алюминия с остаточным кислородом получается оксид алюминия, отличающийся по физико-химическим свойствам от алюминия. Если попытаться присоединить термокомпрессией электродные выводы к такому слою, то контакт будет ненадежным и иметь большое сопротивление.
Для сокращения загрязнений до минимума необходимо не отступать от технологического процесса изготовления изделий электронной техники, выполнять требования стандарта по электронной гигиене, использовать в основном и вспомогательном производствах, а также в оборудовании и оснастке материалы нужной кондиции. Ремонтировать оборудование разрешается только на специальных площадках во вне рабочее время, а в исключительных случаях — в рабочее время, но с локализацией места ремонта.
Наиболее важные технологические процессы следует проводить в так называемых чистых комнатах, представляющих собой отдельные камеры, расположенные внутри рабочего помещения и отвечающие требованиям стандарта электронной гигиены. В чистых комнатах выполняются процессы фотолитографии и загрузки полупроводниковых пластин в реакторы термических установок и выгрузки из них. Чтобы исключить или сократить до минимума присутствие людей в чистых комнатах, необходимо оборудовать их транспортными системами, робототехнологическими комплексами, управляемыми микропроцессорами.
В дальнейшем, когда появится возможность полностью исключить прикосновение рук человека к полупроводниковым пластинам, на самых ответственных стадиях изготовления приборов в чистых комнатах можно будет применять аналитико-диагностические модули, которые позволят управлять технологическими процессами на расстоянии с передачей информации внешней ЭВМ, расположенной на центральном пульте гибкого автоматизированного производства.
Следует отметить, что стоимость оснащения чистых комнат высока. Для экономии в полупроводниковом производстве оборудуются специальные рабочие места — скафандры (боксы) и герметизированные линии, состоящие из скафандров, внутри которых создают микроклимат. В последнее время вместо герметичных скафандров с микроклиматом широко используются пылезащитные камеры с ламинарным потоком воздуха, так как они просты в изготовлении и эксплуатации, имеют большой объем и удобны для размещения различного оборудования и работы сборщиков и операторов.
Пылезащитные камеры с вертикальным ламинарным потоком воздуха, предназначенные для выполнения операций без выделения продуктов химических реакций и с выделением их, показаны на рис. 17.1, а, б. Воздух из помещения засасывается вентилятором 4 через воздухозаборную решетку 3 с фильтром предварительной очистки, очищается высокоэффективным фильтром 2 и подается в пылезащитную камеру.
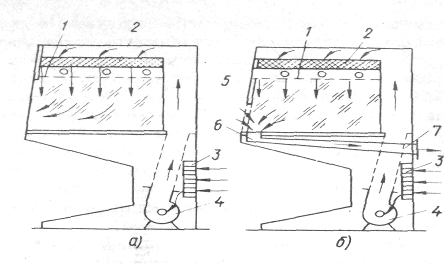
Рисунок 17.1 – Пылезащитные камеры с вертикальным ламинарным потоком воздуха для выполнения операций:
а – без выделения продуктов реакций, б – с выделением продуктов реакций; 1- перфорированная решетка, 2 – высокоэффективный фильтр, 3 – воздухозаборная решетка с фильтром предварительной очистки воздуха, 4 – вентилятор, 5 – подъемная стеклянная шторка, 6,7 – отверстие и воздухопровод для удаления загрязненного воздуха
Высокоэффективный фильтр занимает верхнюю часть камеры. Рабочая площадь фильтра в несколько раз больше площади выходного сечения камеры, что обеспечивает хорошую очистку воздуха. За фильтром расположена перфорированная решетка 1, делящая на отдельные струи воздушный поток, ламинарность которого создается при скоростях 0,2—0,5 м/с. При такой скорости воздушного потока в пылезащитной камере за 1 ч меняется примерно 1500 объемов воздуха, для чего необходим вентилятор высокой производительности.
В результате очистки в 1 л воздуха содержится не более четырех частиц, равных 0,5 мкм. Выделяющиеся в процессе работы аэрозоли сразу удаляются. Время создания рабочей атмосферы в пылезащитной камере перед началом работы не более 1 мин.
Пылезащитная камера освещается лампами, расположенными между высокоэффективным фильтром и перфорированной решеткой, которая способствует также равномерной освещенности стола (не менее 2000 лк). С лицевой стороны камера закрывается подъемной стеклянной шторкой 5. Из пылезащитных камер, служащих для выполнения операций без выделения вредных паров и газов, очищенный воздух попадает в помещение, что снижает его общую запыленность.
В передней кромке стола пылезащитных камер, предназначенных для выполнения операций с выделением продуктов химических реакций, имеется прямоугольное отверстие 6, закрытое сеткой и служащее для удаления загрязненного воздуха по специальному воздуховоду 7.
Ламинарный воздушный поток может быть реализован во всем объеме чистого производственного помещения (ЧПП) или на отдельных рабочих местах (чистый коридор) (рис. 17.2 – 17.3).

Рисунок 17.2 – Схема ЧПП с вертикальным ламинарным потоком
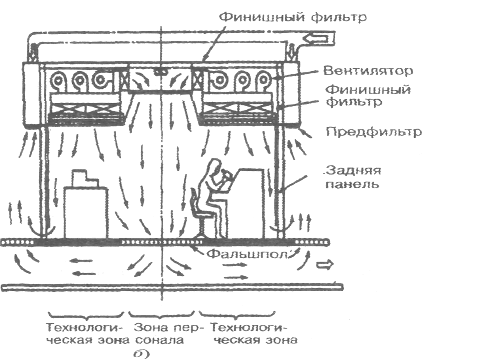
Рисунок 17.3 – Схема ЧПП с чистым коридором
Использование локальных чистых объемов позволяет понизить класс остального помещения на 1-2 порядка при значительном понижении энергопотребления. Локальный чистый объем реализуется в виде пылезащитных камер или стандартных механических интерфейсов.
17.2 Технологические среды
Основные процессы изготовления полупроводниковых приборов выполняют в газовых средах высокой чистоты, которые делятся на восстановительные (водород и его смеси с инертными газами), нейтральные (азот и инертные газы) и окислительные (кислород, пары воды). Наиболее широко используются водород, азот и аргон. В промышленных масштабах водород (для производства полупроводниковых приборов и микросхем) получают электролизом из воды, а азот и аргон — сжижением и ректификацией воздуха. Газы промышленного изготовления по своим характеристикам непригодны для использования в качестве защитной атмосферы при технологических процессах, непосредственно связанных с изготовлением р-n-переходов. Поэтому их дополнительно очищают от примесей.
Из всех примесей, встречающихся в водороде, аргоне и азоте, вредное влияние на качество полупроводниковых приборов и микросхем при их производстве оказывают в основном кислород и пары воды. Чем меньше содержание влаги в каком-либо газе, тем при более низкой температуре она начинает конденсироваться. Температуру, при которой происходит конденсация влаги, содержащейся в газе, называют температурой точки росы или точкой росы. Естественно, что чем ниже точка росы, тем меньше влаги содержится в газе. Газы, очищенные в достаточной степени от кислорода и паров воды, надежно обеспечивают безокислительный нагрев при всех технологических процессах.
Очищают газы в специальных установках (рис. 17.4). Очищаемый водород через ротаметр 1 подают в реактор 3 с палладированным алюмогелем, где происходит каталитическое связывание кислорода с водородом, в результате которого образуется вода. При очистке азота и аргона от кислорода водород специально в оптимальных количествах вводят в реактор 3 через ротаметр 7 и дозатор 2. Чтобы исключить конденсацию образовавшейся воды, реактор подогревают.
Очистка газов от водорода происходит в реакторе 4 с оксидом меди, нанесенным на активный глинозем. При этом свободный водород, вступая во взаимодействие с оксидом меди, восстанавливает его с образованием воды. Здесь же газ вторично очищается от кислорода, так как восстановленная медь снова вступает в реакцию с килородом, связывая его. Для интенсификации процесса восстановления реактор 4 также подогревают. Таким образом, пройдя оба реактора, газ освобождается от кислорода, но при этом увлажняется образующейся водой, которая конденсируется в трубчатом холодильнике 5 и в виде конденсата удаляется из него.
Для окончательной осушки очищаемых газов служат два работающих поочередно адсорбера 7, заполненные в зависимости от необходимой степени осушки силикагелем или цеолитом*. При работе одного из адсорберов в другом происходит регенерация адсорбента азотом (или воздухом), который, проходя через вентили 8 и подогреватель 9, нагревается до необходимой температуры. Регенерируют адсорбент в течение времени, необходимого для восстановления его полной работоспособности. Очищенный и осушенный газ направляется к потребителю через вентиль 8 и фильтр 6, служащий для улавливания механических примесей, выносимых газом из установки очистки.
Очисткой по такой технологической схеме получают аргон и азот с содержанием кислорода до 5 -10_4% и точкой росы от —60 до —70 °С и водород — с содержанием кислорода до 1-10~4% и точкой росы от —65 до —70 С. Для некоторых современных технологических процессов (например, эпитаксии) требуется водород повышенной чистоты, близкой к спектральной. Получают такой водород диффузионной очисткой, пропуская его через металлическую перегородку или мембрану из сплава палладия с платиной, серебром, золотом или другими металлами.
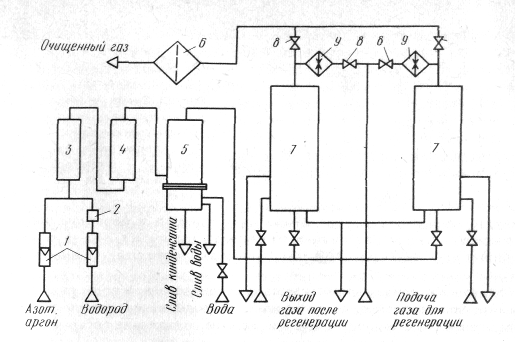
Рисунок 17.4 – Схема установки очистки газов:
1 – ротаметры, 2 – дозатор водорода, 3,4 – реакторы с палладированным алюмогелем и оксидом меди, 5 – холодильник, 6 – фильтр, 7 – адсорбенты, 8 – вентили, 9 – подогреватели воздуха (азота) для регенерации
Не менее важным этапом производства полупроводниковых приборов и микросхем является очистка воды от примесей. Для промывки деталей и собранных конструкций приборов после различных химических операций используют деионизованную воду, получаемую обработкой дистиллированной воды (конденсата) ионообменными смолами (ионитами). Деионизованную воду называют также очищенной или обессоленной.
Схема получения чистой воды для чистых производственных помещений показана на рис. 17.5.

Рисунок 17.5 – Схема получения сверхчистой воды для ЧПП
1 – предварительная обработка, 2 – для исходной воды, 3 – теплообменник, 4 – установка обратного осмоса, 5 – колонна для вакуумного безгаживания, 6 - емкость для воды после обратного осмоса, 7 – колонна с ионообменными смолами, 8 – емкость для соляной кислоты, 9 – емкость для едкого натра, 10 – мембранный фильтр, 11 – емкость для чистой воды, 12 – установка для уничтожения микробов, 13 – колонна для доводки ионообменными смолами, 14 – установка ультрафильтрации, 15 – место использования
Первичная стадия обработки исходной воды включает предварительную обработку (отстой, фильтрацию, адсорбцию) в зависимости от содержания в исходной воде примесей, обратный осмос, ионообменную очистку, вакуумное обезгаживание, фильтрацию через мембранный фильтр с размером пор 0,2 мкм и хранение в емкости для чистой воды, в которой воздух заменен азотом. В процессе удаляется большая часть микрочастиц и микроорганизмов, а удельной электрическое сопротивление воды достигает 10-15 Мом при температуре 25 °С.
На второй стадии вода обеззараживается УФ – излучением, освобождается от ионов высокочистыми ионообменными смолами, подвергается ультрафильтрации и подается на рабочие участки. Удельное сопротивление воды в результате такой обработки составляет 18 Мом.
Обработка ионообменными смолами основана на их способности связывать ионы растворимых в воде примесей в нерастворимые органические соединения (рис. 17.6). Очищаемую воду последовательно пропускают через две колонки 1 и 3, заполненные смолами, соответственно поглощающими катионы (катионитами) и связывающими анионы (анионитами). Процессы обмена катионов и анионов, называемые катионированием и анионированием, получили широкое распространение в производстве полупроводниковых приборов и микросхем для смягчения, обессоливания и обескремнивания воды. Для удаления углекислого газа после катионирования служит дегазатор 2, в котором очищаемая вода продувается противотоком воздуха.
Продолжительность рабочего цикла ионообменных смол определяется их обменной емкостью, т.е. способностью к ионному обмену. После использования ионита до заданного предела обменной емкости необходимо восстановить его обменную способность, удаляя задержанные из обрабатываемой воды ионы и вводя взамен них ионы, которые он отдавал воде в период рабочего цикла. Таким образом, восстановление истощенного ионита является процессом ионного обмена, проводимого в обратном порядке. В качестве катионитов обычно применяют смолу КУ-2-82, а в качестве анионитов — АН-31 или ЭДЭ-10П. Выпускаются эти смолы в виде мелких гранул.
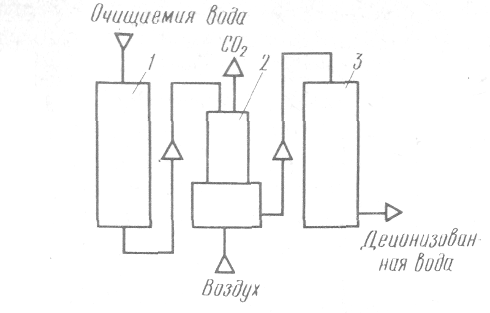
Рисунок 17.6 – Схема установки очистки воды ионообменными смолами:
1 – катионитовая колонка, 2 – дегазатор, 3 – анионитовая колонка
Основными показателями качества деионизованной воды являются ее удельное электрическое сопротивление и содержание органических веществ. Чем больше сопротивление и меньше содержание органических веществ, тем качество деионизованной воды выше.
Установки централизованной очистки воды позволяют получать деионизованную воду, удельное электрическое сопротивление которой не ниже 2 МОм см. Выпускаемые промышленностью ионообменные установки централизованной очистки водыУЦ-2, УЦ-5иУЦ-10 (соответственно производительностью 2,5 и 10 мЗ/ч) построены по типовой технологической схеме и изготовляются из унифицированных элементов.
Для промывки кристаллов и пластин с электронно-дырочными переходами применяют воду с более высоким удельным сопротивлением (10— 12 МОм-см), получаемую дополнительной очисткой в финишных ионообменных установках УФ-250 и УФ-400 соответственно производительностью 250 и 400 л/ч. Кроме того, для финишной очистки воды используют электроионитовые установки (например, УФЭ-250), принцип действия которых основан на одновременной очистке воды ионообменными смолами и постоянным током.
17.3 Очистка полупроводниковых пластин, технологической оснастки и тары
Действие загрязнений особенно усиливается при термических процессах, так как именно при высоких температурах диффузия примесей (загрязнений) из поверхностного слоя в глубь пластины протекает наиболее интенсивно.
Органические загрязнения удаляют с полупроводниковых пластин обработкой в растворителях — трихлорэтилене, толуоле, ацетоне, спирте (иногда в подогретых растворителях с ультразвуковым воздействием) и последующей промывкой в деионизованной (лучше горячей) воде. Механизм очистки состоит в замещении сорбированных поверхностью пластины агломератов и молекул загрязнений молекулами растворителя. При промывке в деионизованной воде происходит десорбция молекул расвторителя, врезультате которой они переходят в жидкость. Наилучшую очистку получают, промывая пластины в проточной деионизованной воде.
Солевые загрязнения хорошо растворяются в воде, поэтому их удаляют, промывая пластины в горячей деионизованной воде (лучшее ультразвуковым воздействием). Механические загрязнения удаляют гидромеханической обработкой ультразвуком в жидкостях. Такая обработка дает хороший эффект после предварительного травления поверхности. При этом загрязнения вместе с растворенным поверхностным слоем переходят в раствор. Кроме того, механические загрязнения удаляют одновременно с другими видами загрязнений.
От ионов некоторых металлов поверхности пластин освобождают последовательной обработкой в царской водке, фтористоводородной кислоте и проточной деионизованной воде.
Технологическую оснастку и межоперационную тару для обработки и переноса полупроводниковых пластин также тщательно очищают от всех видов загрязнений. Изготовляют оснастку и тару из особо чистых материалов: кварца, графита (для термических процессов), фторопласта, винипласта-(для химических процессов), нержавеющей стали, алюминия и его сплавов, керамики, полиэтилена, полистирола и некоторых других пластмасс.
При работе оснастка и тара загрязняются (пылью, конденсирующимися парами химреактивов), поэтому их рекомендуется обрабатывать щелочными (содовыми) растворами, а затем промывать деионизованной водой. Металлическую тару для хранения полупроводниковых пластин применять не рекомендуется, чтобы не загрязнять их ионами металлов, оказывающих вредное влияние на электронно-дырочные переходы. Даже пинцеты должны быть из пластмассы (фторопласта) или из хромированной стали с наконечниками из фторопласта либо кварца.
Кассеты, применяемые в некоторых установках для монтажа кристаллов, как правило, изготовляют из нержавеющей стали. Кассеты для пайки корпусов выполняют из нержавеющей стали или керамики. Чтобы металлические кассеты не смачивались припоем (особенно чистым серебром), их специально периодически окисляют при 900 °С во влажном водороде в течение 20 мин. Все кассеты требуют очистки от загрязнений. Поэтому их периодически промывают в растворителях, а затем деионизованной водой и сушат.
Тема № 18
Дата добавления: 2016-06-29; просмотров: 2293;











