Принцип действия транзистора
Принцип действия транзистора рассмотрим на примере структуры типа р-n-р (рис. 3.2, а). На рис. 3.2, б показано распределение концентрации основных носителей заряда в слоях транзисторной структуры в равновесном состоянии, а на рис. 3.2, в – потенциальная диаграмма, создаваемая объемными зарядами р-n-переходов в отсутствии внешних напряжений. Соотношение концентраций основных носителей заряда в эмиттерном и коллекторном слоях транзистора несущественно, и на рис. 3.2, б они приняты одинаковыми. Отличие же в концентрациях основных носителей заряда эмиттерного и базового слоев весьма важно, т. к. оно влияет на основные параметры транзистора. Эмиттер должен быть более сильно легирован, поэтому концентрация основных носителей заряда pp >> nn, т. е. эмиттерный переход должен быть существенно несимметричным.
В рабочем режиме внешние напряжения подключают к транзистору таким образом, чтобы обеспечивалось смещение эмиттерного перехода в прямом направлении, а коллекторного перехода – в обратном направлении.В простейшем случае это достигается с помощью двух источников питания Uэи Uк.
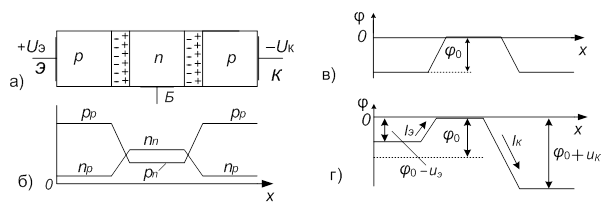 Рис. 3.2. Транзистор р-n-р-типа:
Рис. 3.2. Транзистор р-n-р-типа:
А – структура, б – распределение концентраций носителей заряда, в – потенциальная диаграмма в равновесном состоянии; г – потенциальная диаграмма при прямом смещении эмиттерного и обратном смещении коллекторного перехода
Через прямосмещённый эмиттерный переход, как через обычный р-n-переход, протекает ток Iэ (рис. 3.2, г). Этот ток создается потоком дырок, инжектированных из эмиттера в базу, и электронов – из базы в эмиттер. Дырки в базе создают избыточный положительный заряд. Для его компенсации в базу входят электроны, а база в целом остается нейтральной. Часть дырок рекомбинирует с электронами, а взамен рекомбинировавших в базу входят новые электроны, создавая электронный ток базы. Инжектированные дырки вдоль базы распределены неравномерно. У границы с коллектором концентрация дырок мала, поэтому в базе возникает градиент их концентрации. Дырки диффундируют в сторону коллектора, втягиваются полем коллекторного перехода и создают дырочный ток коллектора. Благодаря малой толщине базы большая часть дырок доходит до коллектора, не успевая рекомбинировать с электронами. Поэтому через обратносмещённый коллекторный переход протекает ток, значительно превышающий неуправляемый ток обычного обратносмещённого р-n-перехода.
На рис. 3.3 показаны направления потоков дырок и электронов при прямом смещении эмиттерного и обратном смещении коллекторного переходов и направления токов Iэ, Iк, Iб в выводах транзистора.
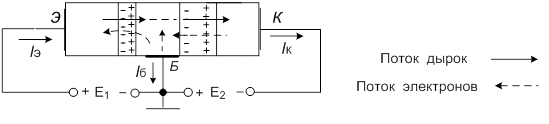
Рис. 3.3. Токи транзистора
Ток эмиттера равен сумме токов, создаваемых потоками дырок и электронов: Iэ = Iэр + Iэn . (3.1)
Дырочная составляющая тока Iэр создается потоком дырок, инжектированных из эмиттера в базу. Большинство дырок посредством диффузии достигают коллектора, создают ток Iкр,который составляет основную часть коллекторного тока. Электронная составляющая тока Iэn замыкается по цепи эмиттер – база и не участвует в создании коллекторного тока. Для оценки эффективности эмиттера используется параметр, называемый коэффициентом инжекции gЭ,
gэ = Iэр /Iэ . (3.2)
Коэффициент gэпоказывает, какая часть общего тока эмиттера Iэ создаётся потоком дырок Iэр.
Ток коллектора общий равен:
Iк = Iкр + Iк0, (3.3) где Iк0 – неуправляемый ток через коллекторный переход. Это ток неосновных носителей, как и ток протекающий через обычный обратносмещенный переход.
Ток базы Iб состоит из двух составляющих: электронной составляющей тока эмиттера Iэn и тока рекомбинации (Iэр – Iкр). Рекомбинационные потери дырок в базе учитываются коэффициентом переноса ε:
ε = Iкр/Iэр . (3.4)
Управляемая часть коллекторного тока транзистора, создаваемая дырочной составляющей эмиттерного тока Iкр, связана с током эмиттера Iэ коэффициентом передачи эмиттерного тока a:
a = Iкр/Iэ. (3.5)
Умножив числитель и знаменатель этого соотношения на Iэр, получим:  (3.6)
(3.6)
Следовательно, коэффициент a тем ближе к единице, чем меньше отличаются от единицы коэффициенты gэ и ε.
Повышение эффективности эмиттера gэ достигается значительным превышением (на два-три порядка) концентрации основных носителей в эмиттере (дырок) над концентрацией основных носителей в базе (электронов).
Желательно, чтобы величина коэффициента εкак можно меньше отличалась от единицы. Это достигается увеличением времени жизни дырок в базе и сокращением времени нахождения их в базе. Последнее достигается путём уменьшения ширины базы.
Наличие в общем токе Iк неуправляемого тока Iк0 является одной из основных причин температурной нестабильности характеристик и параметров транзистора.
Основное соотношение для токов транзистора составляется по первому закону Кирхгофа:
Iэ = Iк + Iб . (3.7)
С учетом теплового тока Iко токи Iки Iб можно выразить через ток Iэ:
Iк = a Iэ + Iко;
Iб = (1 – a) Iэ – Iко. (3.8)
Подобные же процессы происходят и в транзисторе n-p-n-типа, но там меняются ролями дырки и электроны, а также изменяются полярности питающих напряжений и направления токов, показанных на рис. 3.3. Наиболее распространены транзисторы n-p-n-типа, поэтому далее будем рассматривать транзисторы n-p-n-типа.
Дата добавления: 2017-09-01; просмотров: 1564;











