Селективность и контроль размеров элементов
На практике, в особенности при использовании методов сухого травления подложка и маска также подвергаются воздействию травителя. Чаще всего материалы, контактирующие с травителем, характеризуются конечными значениями скорости травления. Следовательно, важным параметром переноса изображений в технологии СБИС является селективность (избирательность) травления, определяемая как отношение скоростей травления различных материалов.
Селективность по отношению к материалу резиста необходимо учитывать при контроле формируемых элементов. Селективность по отношению к материалу подложки определяет качество и процент выхода годных приборов (подложкой считается либо кремниевая пластина, либо пленка, выращенная или осажденная в процессе создания предыдущего слоя полупроводниковой структуры).
Селективность по отношению к материалу подложки зависит от однородности скорости травления как пленки, так и маски, однородности толщины пленки, степени перетравливания, профиля края элемента маски, анизотропии скорости травления маски и максимального допустимого ухода размеров вытравливаемого элемента. Для количественной оценки влияния этих факторов рассмотрим рис. 1.
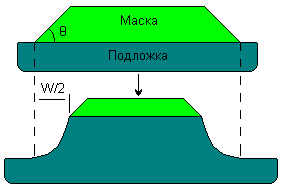
Рис. 1. Формирование контура вытравливаемого элемента
с учетом конечной скорости травления маски. (Разность
между расчетной и реальной шириной линии равна W).
Рассмотрим процесс травления пленки, средняя толщина которой составляет hf, а однородность толщины определяется безразмерным параметром d, так что 0<=d<=1 максимальная толщина пленки равна, hf(1+d), а минимальная толщина составляет hf(1-d). Предположим, что средняя скорость травления равна vf, а однородность скорости травления определяется интервалом скоростей vf(1+ff), где ff - безразмерный параметр (0<=ff<=1). Наиболее распространенным подходом к оценке селективности, необходимой для обеспечения заданных пределов отклонения размеров формируемых элементов в результате вытравливания маски в любом участке пластины, является задание наихудших условий. В рассматриваемом случае наихудшие условия соответствуют максимальной скорости травления маски и минимальной скорости травления наиболее толстых участков пленки. (Скорость травления определяется как частное от деления глубины травления в вертикальном направлении на продолжительность травления). При таких условиях продолжительность вытравливания пленки на всю толщину tc определяется выражением
 .
.
Если продолжительность перетравливания (выраженную в виде доли от продолжительности травления) обозначить D, то продолжительность травления пленки возрастает до tc(1+D) и выражение для полной продолжительности травления tt можно записать в виде
 .
.
В течение этого времени происходит растравливание маски (рис. 1). Если максимальные скорости вертикального и бокового травления маски обозначить соответственно vv и vl, то край элемента рисунка маски смещается на максимальное расстояние W/2, равное
 (1).
(1).
Угол q показан на рис. 1. Подставляя выражение для tt из уравнения (1), получим
 (2).
(2).
Скорость травления маски определяется вертикальной скоростью травления. В рассматриваемом случае взята максимальная величина vv, что соответствует наиболее жестким требованиям к селективности, необходимой для достижения заданного значения W.
Скорость травления маски можно определить с помощью параметра однородности fm : vv=vm(1+fm), где vm - средняя скорость травления маски. Далее, учитывая, что vf/vv=Sfm - заданная селективность травления пленки по отношению к маске и что vl/vv=1-Am, где Am - степень анизотропии травления маски, уравнение (2) можно переписать в виде
 (3),
(3),
где Ufm=[(1+d)(1+D)(1+fm)]/(1-ff) - фактор "однородности", учитывающий наихудшее совпадение всех однородностей.
Полезно рассмотреть пример, иллюстрирующий применение уравнения (3). Предположим, что осуществляется процесс полностью анизотропного травления пленки (Af=1). В этом случае отклонение размеров элемента изображения связано только с растравливанием резиста. Примем далее, что однородность скорости травления пленки и маски составляет 10%, однородность пленки по толщине равна 5%, а заданная степень перетравливания 20%. Тогда ff=fm=0,1, d=0,05 и D=0,2. Подставив эти величины в уравнение (3), получим
Sfm=1,54[ctg q + (1-Am)](hf/W) (4).
Графики зависимостей, определяемых уравнением (4) для q=60° и q=90° при условиях изотропного и полностью анизотропного травления маскирующего слоя, приведены на рис. 2.
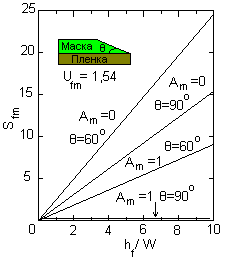
Рис. 2. Зависимость требуемой селективности травления по отношению
к маске Sfm от отношения толщины пленки к искажению ширины
вытравливаемой линии для различных профилей краев элементов
маски и экстремальных случаев анизотропного и изотропного травления маски.
Методы плазменного травления
Дата добавления: 2020-11-18; просмотров: 447;











