Пробіги іонів в твердих тілах.
Теорія пробігу іонів в аморфній і кристалічній мішені детально розглянута Дж. Ліндхардом, М. Шарффом і Х.Шиоттом і отримала назву теорії ЛШШ [І-1, І-5]. Розподіл втілених атомів по глибині в аморфному твердому тілі можна наближено описати формулою Гауса:
 , (3.5.1)
, (3.5.1)
де Rp- середнє значення проекцiї пробiгу іонів на нормаль до поверхні зразка; DRp - середньоквадратичний розкид пробігів (дисперсія пробігу).
При типових енергіях іонів значення Rp знаходиться в межах від сотих до десятих долей мікрона, тобто шар, що імплантується, заляже безпосередньо під поверхнею мішені. Якщо легування проводити через діелектричні чи металічні шари або використовувати іони малих енергій, то можна забезпечити максимальну локалізацію втілених атомів і безпосередньо на поверхні. Це часто виявляється необхідним для коректування параметрів готових пристроїв [І-5].
Для знаходження профілю розподілу втілених атомів в твердому тілі необхідно вміти визначати їх пробіг. Втілені іони зазнають постійну взаємодію з атомами мішені, тому траєкторії їх руху дуже складні.
Гальмування іонів - процес статистичний, тому місцезнаходження їх в мішені носить випадковий характер, що виражається в наявності певного розкиду пробігів іонів. Для визначення місцезнаходження іонів в мішені користуються поняттям повного пробігу R, який дорівнює сумі окремих пробігів між двома послідовними співударами; проекційного пробігу Rp, рівного проекції повного пробігу на напрямок початкового (до першого зіткнення) руху іона, або середньоквадратичного відхилення DRp.
В теорії ЛШШ величини Rp і D Rp знаходять з урахуванням ядерного (Sn) і електронного (Se) гальмування. Якщо вважати ці процеси незалежними один від одного, то середнє значення вільного пробігу іона з початковою енергією E в аморфному тілі описується наступним співвідношенням:
 (3.5.2)
(3.5.2)
Тоді розподіл пробігів імплантованих іонів з врахуванням (3.5.2) визначається середнім пробігом Rp, стандартним відхиленням DRp і дозою опромінення Q:
 (3.5.3)
(3.5.3)
Максимальна концентрація втіленої домішки задається співвідношенням:
 . (3.5.4)
. (3.5.4)
Число Nd,p зміщених атомів, припадають на один падаючий іон при первинному зіткненні, розраховується по формулі:
 (3.5.4)
(3.5.4)
де E - енергія іона, Еd - ефективна порогова енергія зміщення атома гратки для Si Ed »14eB. Рівняння (3.5.4) справедливе, якщо енергія Е падаючої частки менша критичного значення EA:
 (3.5.5)
(3.5.5)
де ER=13.6 еВ (енергія Рідберга); Z1 - порядковий номер іона; Z2 - порядковий номер атома мішені; M1 і M2- маса іона і мішені відповідно.
На рис.3.5.1 представлені розраховані з допомогою рівняння (3.5.3) із використанням значень Rp і DRp, які приведені на рис.3.5.2, профілі розподілу в Si іонів фосфору різних енергій. Із збільшенням енергії іонів і глибини їх проникнення максимальна концентрація іонів зменшується, так як розкид значень Rp збiльшується.


| Рис.3.5.1. Пробіг Rp і розкид пробігів DRp для іонів миш’яку, бору і фосфору, імплантованих в кремній. | Рис 3.5.2. Теоретичні криві розподілу пробігів іонів фосфору в кремнії в лінійних координатах (Q = 1015 см -2). |
Так як рівняння (3.4.4) лінійне відносно енергії, то загальне число атомів, зміщених однією часткою, розраховується по формулі:
 , (3.5.6)
, (3.5.6)
де En - повна енергія, яка втрачається часткою при первинних і вторинних зіткненнях з ядрами атомів.
При більш високих енергіях зміщення атомів лише частково обумовлене пружними зіткненнями і домінуючим в процесі гальмування іонів стає електронне гальмування.
Ефект каналювання .
В кристалічних гратках вздовж певних кристалографічних напрямків існують канали міжвузольних позицій, вздовж яких іон рухається по-іншому, ніж у ’’випадкових’’ напрямках. Це напрямки мають малі індекси (наприк-лад, <110>, <111>, <100> в гратці алмаза). Внаслідок того, що атоми оточені кулонівськими потенціальними полями, які взаємодіють з полем додатних іонів, які рухаються в каналі по законам квантової механіки, іон і атоми зазнають взаємодії сил взаємного відштовхування. В результаті, завдяки правильному розподілу атомів в гратці, акти розсіяння іонів на окремих атомах закономірно зв’язані між собою. Наявність каналювання змінює профіль розподілу імплантованих іонів. Розподіл фосфору  в кремнії при імплантації вздовж <110> має два максимуми , перший на глибині h=0.2 мкм відповідає іонам, які не потрапили до каналу, другий на глибині 0.7 мкм, який зв’язаний з канальованими іонами.
в кремнії при імплантації вздовж <110> має два максимуми , перший на глибині h=0.2 мкм відповідає іонам, які не потрапили до каналу, другий на глибині 0.7 мкм, який зв’язаний з канальованими іонами.
Збільшення дози опромінення до значень, які викликають аморфізацію поверхневих шарів, так само як і підвищення температури (збільшення амплітуди теплових коливань), наявність вакансій і міжвузольних атомів, послаблює ефект каналювання. Якщо падаючий пучок іонів відхиляється від відповідного кристалографічного напрямку більше ніж на критичний кут, то в канали попадає мала частина іонів. Мінімальне каналювання спостерігається при кутах ~7-10°. При великих кутах іони знову потрапляють в область кристалографічних площин.
Одним з найбільш цікавих явищ застосування ефекту каналювання є визначення концентрації і позицій атомів домішок в міжвузлях.
Аморфізація шарів.
В процесі втілення іонів прості дефекти можуть накопичуватися в локалізованих областях - кластерах, в яких зберігається основна кристалічна структура. Кластер має складну структуру і складається з ядра, яке насичене дивакансіями, і оболонки, де основним видом дефектів є асоціації вакансій з домішковими атомами. Якщо доза іонів, а відповідно, і густина радіаційних дефектів достатньо висока, кластери радіаційних дефектів перекриваються і утворюється аморфний шар. Аморфізація структури при великих дозах радіації характерна для всіх напівпровідників, але схильність до неї знижується з ростом долі іонного або металічного зв’язку в кристалі.
Існує декілька гіпотез для пояснення утворення аморфізованого шару в монокристалічній мішені. Перша з них допускає, що для утворення аморфного шару всі атоми мішені повинні бути зміщені. З допомогою формули Кінчіна-Піза для числа зміщених атомів отримують наступний вираз для дози аморфізації:
 (3.5.7)
(3.5.7)
де N - густина атомів підкладки,  втрати енергії при ядерному зіткненні на одиницю довжини. Рівняння (3.5.7) дозволяє тільки оцінити дозу аморфізації майже для всіх іонів, так як воно не враховує відпал радіаційних дефектів в процесі імплантації, наприклад, зворотню дифузію вакансій і зіткнення вже із зміщеними атомами.
втрати енергії при ядерному зіткненні на одиницю довжини. Рівняння (3.5.7) дозволяє тільки оцінити дозу аморфізації майже для всіх іонів, так як воно не враховує відпал радіаційних дефектів в процесі імплантації, наприклад, зворотню дифузію вакансій і зіткнення вже із зміщеними атомами.
Морехед і Кроудер запропонували модель, яка враховує залежність зворотньої дифузії вакансій від температури в процесі імплантації . Вони отримали такий вираз:
 (3.5.7)
(3.5.7)
 виражається формулою (3.5.7), але без множника 2, а
виражається формулою (3.5.7), але без множника 2, а  - зменшення розміру кластера радіаційних дефектів, яке обумовлене зворотньою дифузією:
- зменшення розміру кластера радіаційних дефектів, яке обумовлене зворотньою дифузією:
 (3.5.8)
(3.5.8)
де  постійна дифузії вакансій, t - час, за який дифундують вакансії.
постійна дифузії вакансій, t - час, за який дифундують вакансії.
Існують також інші моделі. Наприклад: формування вздовж кожного треку іона розплавленої області з наступним її затвердінням в аморфному стані; утворення в кластерах аморфних зародків і їх ріст за рахунок стоку до них атомів міжвузлів; процеси аморфізації проходять шляхом накопичення точкових дефектів без стадії теплових піків. Дуже важлива гетерогенність структури на початковій стадії, коли виникають мікроскопічні аморфні області, які є центрами розподілу процесу.
Найбільш реальною є модель, згідно якої звичайне накопичення точкових дефектів має границю із-за їх взаємної анігіляції, тому аморфізація може пройти тільки при неоднорідному накопиченні (нехай локальному) дефектів одного знаку. Дана модель дозволяє кількісно пояснити більшість експериментальних даних, в тому числі шаруватий розподіл аморфної фази, початок аморфізації з поверхні або відразу з двох шарів - поверхневого та поблизу Rp.
Максимум розподілу концентрації радіаційних дефектів, які виникають при іонному втіленні, розташовані дещо ближче до поверхні кристала, ніж максимум розподілу втілених атомів ~0,7 Rp, де Rp - проекція найбільш ймовірного пробігу. В цій області кристала починається виникнення аморфної фази, шар якої потім із збільшенням дози потовщується і захоплює всю область до поверхні втілення.
На даний час існують критерії, які дозволяють визначити, чи має місце перехід в аморфну фазу. Край основної смуги поглинання аморфного кремнію відповідає меншій енергії фотонів, які виникають внаслідок різниці показників заломлення кристалічного і аморфного Si, дозволяє оцінити товщину аморфного шару. Втілення важких іонів в кремній і германій при великих дозах опромінення приводить до утворення локальних аморфних зон діаметром 3-5 нм. Число таких зон лінійно зростає з дозою опромінення аж до насичення - аморфізації. При легуванні легкими іонами основними типами порушень є ізольовані вакансії і атоми в міжвузлях, міграція яких призводить до формування кластерів або комплексів з домішковими атомами. Такий шар складається з двох аморфізованих областей, поверхневої і внутрішньої, які розділені тонкою монокристалічною областю.
Розрізняють три дози аморфізації: дозу аморфізації поверхневого шару; дозу внутрішньої аморфізації і дозу суцільної аморфізації. Якщо на поверхні не утворюється аморфний шар, то доза суцільної аморфізації співпадає з дозою опромінення. Доза аморфізації залежить від атомного номера і маси іонів, від температури мішені (рис.3.5.4). Зазначимо, що доза, яка необхідна для утворення аморфного шару при імплантації іонів фосфору в кремній складає величину ~ 2×1014 іон/см2.
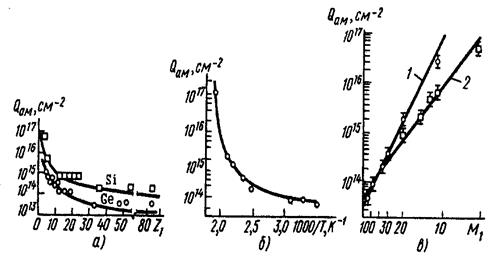
Рис.3.5.4. Залежність дози аморфізації кремнію і германію від атомного номера іона, що втілюється (Е=30 кеВ, Т - кімнатна) (а); температурна залежність дози аморфізації германію при втіленні іонів  (Е=30 кеВ) (б) та залежність дози суцільної 1 і поверхневої 2 аморфізації кремнію від маси іона, що втілюється (в).
(Е=30 кеВ) (б) та залежність дози суцільної 1 і поверхневої 2 аморфізації кремнію від маси іона, що втілюється (в).
Зміна властивостей матеріалів.
Внаслідок генерації більш або менш складних дефектів радіаційні пошкодження чинять цілковито конкретний вплив на різні властивості матеріалів. Цей вплив може бути корисним, майже непомітним або дуже шкідливим. У випадку напівпровідників він завжди виявляється шкідливим, так як радіаційні дефекти дуже сильно зменшують рухливість і час життя неосновних носіїв заряду. Наприклад, імплантація іонів фосфору з енергією 100 кеВ в Si при дозі 1012см -2 зменшує час життя неосновних носіїв заряду до значення нижче 10-9с. Сильний вплив, але не в такому масштабі, чинять радіаційні дефекти і на рухливість носіїв заряду. Після імплантації великої дози іонів (в залежності від маси - від 1013 до 1014 см-2) рухливість носіїв заряду в Si знижується нижче 1 см2/В×с. Концентрація носіїв заряду після імплантації в більшості випадків дуже мала, так як іони частково захоплюються дефектами і тому стають електрично неактивними.
Імплантація у великих дозах, які приводять до утворення аморфних шарів, майже завжди викликає зміну об’єму, особливо в монокристалічних напівпровідниках. В загальному випадку спостерігається збільшення об’єму (наприклад, в Si), але можливе і зменшення об’єму, тобто збільшення густини. По зміні об’єму можна судити про утворення аморфних шарів. Напруги, які при цьому виникають можуть бути дуже великими і підкладка буде прогинатися.
Електрична активація імплантованих іонів.
Після іонного бомбардування поверхневі шари мішені знаходяться в структурно нестабільному стані, що робить нестабільними властивості імплантованих шарів. Стан поверхні напівпровідника впливає на розподіл втілених атомів і дефектів, які вводяться при імплантації. Обумовлено це тим, що поверхня кристалу є стоком для дефектів і домішкових атомів. Необхідність переводу домішки в більш стійкий стан потребує використання постімплантаційного відпалу.
Після достатньо тривалого відпалу при 9000С всі іони в Si, які здатні активуватися, вже активовані, але їх поведінка при низьких температурах може бути іншою. Важливим параметром процесу термообробки, який необхідний для активації при рекристалізації, поряд з температурою, є час. Звичайний час відпалу складає від 10 до 13 хв. В основному він залежить від умов експерименту і від часу нагріву зразка. Більш триваліший час відпалу використовують тоді, коли поряд з активацією іонів передбачають проведення дифузії.
Треба відзначити, що чистота іонного пучка ще не дає підстав вважати, що втілюється лише один тип іонів. Забруднення (частіше всього кисень) і інші атоми, які присутні на поверхні кристалу, під дією іонного бомбардування забиваються в об’єм. Подібних явищ вдається уникнути, якщо імплантація проводиться в умовах високого вакууму і перед втіленням іонів заданого типу знімається тонкий поверхневий шар попереднім бомбардуванням тяжкими іонами.
Зазначимо, що серед експериментальних методів, які використо-вуються для вивчення спотворень кристалічної структури, що виникають в процесі іонної імплантації, рентгенівські дифракційні методи є найбільш привабливими завдяки їх неруйнуючій природі і високій чутливості до малих спотворень кристалічної гратки.
Контрольні питання
1.Пояснити фізичні основи іонної імплантації
2. Які процеси дефектоутворення відбуваються в процесі іонної імплантації?
3. Пояснити, як відбувається аморфізація поверхневих шарів
4. Як змінюються фізичні властивості імплантованих іонами кристалів?
5. Якими характеристиками іонів визначається їх розподіл та концентрація після імплантації в кристал?
6. Як в пливає відпал на електричну активацію домішок?
Дата добавления: 2020-07-18; просмотров: 597;











