Легирование эпитаксиальных слоёв
Легирование эпитаксиальных слоёв осуществляется в процессе их выращивания путем добавления к исходным реагентам реагента, содержащего легирующую примесь. В случае эпитаксии из газовой фазы легирующий реагент также должен быть газообразным. Для получения атомов легирующей примеси на поверхности эпитаксиального слоя, также как и для получения атомов основного вещества, используются реакции восстановления галогенидов и пиролиза гидридов легирующих элементов, например:
2PCl3 + 3H2 « 2P + 6HCl;
2AsH3 « 2As + 3H2.
Различают два основных метода легирования эпитаксиальных слоёв при выращивании из газовой фазы: жидкостный и газовый.
В жидкостном методе исходные основной и легирующий реагенты находятся в жидком состоянии. Для получения их пара применяется система барботирования, при которой газ-носитель (обычно H2 или Ar) пропускается через барботер с жидкостью, в котором насыщается парами реагента. Обычно в барботер заливается смесь основного и легирующего жидких реагентов, так что на выходе из барботера газ-носитель содержит пары того и другого реагентов. В этом случае концентрация примеси в эпитаксиальном слое пропорциональна относительному давлению пара легирующего реагента
 ,
,
где Pm, Pd и Pg – давление пара основного и легирующего реагентов и газа-носителя. Для реакторов открытого типа суммарное давление в системе Pm + + Pd + Pg равно атмосферному, поэтому концентрация примеси в эпитаксиальном слое пропорциональна только степени разбавления легирующего реагента в барботере. Последняя практически не меняется в процессе эпитаксии, поэтому не меняется и уровень легирования, т. е. жидкостный метод может использоваться только для однородного легирования эпитаксиальных слоёв.
В газовом методе исходные основной и легирующий реагенты находятся в газообразном состоянии, обычно в баллонах, разбавленные инертным газом. Из газовых баллонов через систему вентилей и ротаметров основной и легирующий газообразные реагенты вместе с газом-разбавителем поступают в эпитаксиальный реактор. В этом случае концентрация примеси в эпитаксиальном слое пропорциональна относительному расходу газообраз-ного легирующего реагента

 ,
,
где Rm, Rd и Rr – расходы газов основного и легирующего реагентов и газа-разбавителя. Таким образом, изменяя расход газа легирующего реагента, можно управлять уровнем легирования в процессе эпитаксии, т. е. газовый метод может использова-ться для неоднородного легирования эпитаксиальных слоёв.
 При высоких концентрациях примеси наблюдается отклонение от пропорциональности в зависимости уровня легирования от расхода (или давления) легирующего реагента (рис. 4.8). Этот эффект объясняется влиянием высокой концентрации примеси в эпитаксиальном слое на скорость роста эпитаксиального слоя.
При высоких концентрациях примеси наблюдается отклонение от пропорциональности в зависимости уровня легирования от расхода (или давления) легирующего реагента (рис. 4.8). Этот эффект объясняется влиянием высокой концентрации примеси в эпитаксиальном слое на скорость роста эпитаксиального слоя.
Автолегирование
Под автолегированием понимается попадание неконтролируемых примесей в эпитаксиальный слой в процессе его роста дополнительно к твердотельной диффузии из подложки. При газофазной эпитаксии автолегирование осуществляется путем переноса паров неконтролируемых примесей на поверхность растущего эпитаксиального слоя вследствие их десорбции или испарения:
– с незащищённых торцов и обратной стороны подложки;
– с подложкодержателя (пьедестала);
– с других более сильно легированных пластин, расположенных ближе к началу газового потока;
– из соседних локальных легированных областей на подложке (боковое автолегирование).
Результатом автолегирования является искажение концентрационного профиля носителей заряда в области, прилегающей к подложке (появление “хвоста” автолегирования), смещение эпитаксиального p–n-перехода к поверхности и, соответственно, уменьшение эффективной толщины эпитаксиального слоя (рис. 4.9).
Для борьбы с автолегированием применяют следущие меры:
– защита торцов и обратной стороны подложки диэлектрическими плёнками, препятствующими испарению легирующих примесей (SiO2, Si3N4);
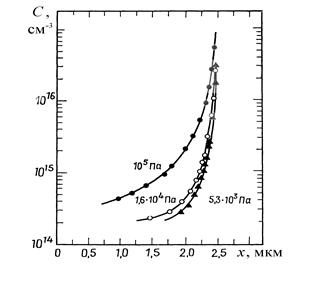 – защита графитового пье-дестала плёнкой поликристаллического карбида кремния (осуществляется путём карбиди-зации пьедестала);
– защита графитового пье-дестала плёнкой поликристаллического карбида кремния (осуществляется путём карбиди-зации пьедестала);
– использование подложек с одинаковым уровнем легирования в одной загрузке;
– использование подложек, скрытых слоёв, легированных примесями с низким давлением пара, например, фосфором или ещё лучше сурьмой вместо мышьяка;
 – уменьшение температуры эпитаксиального процесса;
– уменьшение температуры эпитаксиального процесса;
– увеличение скорости эпитаксиаль-ного роста;
– понижение рабочего давления в реакторе (рис. 4.9).
Дата добавления: 2016-12-16; просмотров: 3018;











