Дырочный полупроводник (р-типа).
В случае добавления в полупроводник акцепторной примеси одна из валентных связей вблизи атома-акцептора остаётся незаполненной (рис.6,а).

Рис. 6,а. Примесной атом In в кристалле Ge.
Такое состояние нельзя назвать дыркой, т.к. атом акцептора электрически нейтрален. Потенциальная функция вблизи атомов примеси искажается (рис.6,б).
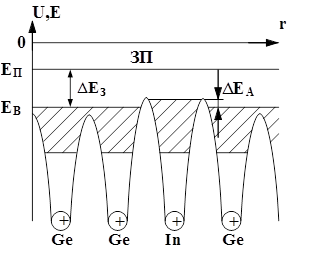
Рис. 6,б. Положение примесного атома In на потенциальной диаграмме.
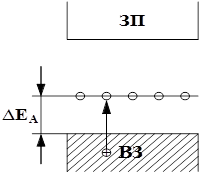 Рис. 6,в. Энергетическая диаграмма р-полупроводника.
Рис. 6,в. Энергетическая диаграмма р-полупроводника.
|
У края потенциальной ямы акцептора энергитический уровень, лежащий несколько выше потолка валентной зоны, остаётся незаполненным.
В результате теплового возбуждения один из валентных электронов соседних атомов может нарушать валентную связь и заместить свободный энергитический уровень (заполнить валентную связь) вблизи атома акцептора. При этом четвёртый электрон связан с акцептором лишь квантомеханическими силами, т.е. его энергетическое состояние окажется выше энергии остальных трёх электронов на величину, примерно равную классической кулоновской энергии. В результате такого перехода вблизи соседнего атома, которому ранее принадлежал рассмотренный электрон, образуется дырка, а атом акцептора превратится в неподвижный отрицательно заряженный ион. Следовательно, в процессе ионизации акцепторов образуется преимущественная концентрация дырок – образуются подвижные носители лишь одного знака. Такие полупроводники называются дырочными или р-полупроводниками. Как и в случае донорных примесей, положение акцепторов в зонной диаграмме характеризуется единым локальным энергетическим уровнем, расположенным вблизи потолка валентной зоны (рис.6,в).
Выводы:
В полупроводнике, в отличие от металлического проводника, ток образуется не только за счет направленного движения (дрейфа) отрицательно заряженных свободных электронов, но и за счет дрейфа положительно заряженных дырок.
- Электропроводность собственного (беспримесного) полупроводника очень мала, т.к. при комнатной температуре в нем мало носителей заряда – свободных электронов и дырок. Из–за этого собственный полупроводник имеет ограниченное применение в полупроводниковой технике.
Типы рекомбинации
В зависимости от механизма различают три вида рекомбинации: межзонную рекомбинацию, рекомбинацию через локальные центры и поверхностную рекомбинацию.
Межзонная рекомбинация осуществляется при переходе свободного электрона из зоны проводимости в валентную зону, что сопровождается уничтожением свободного электрона и дырки, на месте которой появляется связанный электрон. Этот процесс совершается при соблюдении законов сохранения энергии и импульса. Так как энергия электрона в валентной зоне меньше энергии электрона в зоне проводимости, то процесс межзонной рекомбинации должен сопровождаться выделением энергии
ΔE ≈ Eпр – EB (49)
В зависимости от того, на что расходуется энергия, различают следующие виды межзонной рекомбинации:
Излучательную, при которой энергия ΔЕ излучается в виде кванта света (фотона);
безизлучательную, при которой энергия ΔЕ передается кристаллической решетке, то есть расходуется на образование фононов.
При излучательной межзонной рекомбинации в соответствии с законом сохранения энергии должен испускаться фотон с энергией
hυ ≈ Eпр – EB (50)
Вместе с тем из закона сохранения импульса следует, что
hυ/С = Pпр –PB (51)
Поскольку импульс фотона hυ/С ничтожно мал по сравнению с импульсом электрона, то последнее равенство можно переписать так
Pпр –PB ≈ 0 (52)
Рассматривая – PB как импульс свободной дырки, приходим к выводу, что при межзонной излучательной рекомбинации возможны лишь такие переходы, при которох электрон зоны проводимости встречается с дыркой валентной зоны, имеющей равный по величине и противоположный по направлению импульс.
Несложно показать, что скорость межзонной излучательной рекомбинации увеличивается по мере уменьшения ширины запрещенной зоны полупроводника и увеличение его температуры. Поэтому данный вид рекомбинации может иметь единственное значение лишь для полупроводников с узкой запрещенной зоной и при достаточно высоких температурах.
 При безизлучательной (фононной) рекомбинации избыточная энергия выделяется в виде фононов. Оценки показывают, что максимальная энергия фононов в кристаллах не превышает 0,1 эВ. Это означает, что при рекомбинации через запрещенную зону шириной порядка 1 эВ должно произойти одновременно испускание большого числа фононов. Следовательно, межзонная безизлучательная рекомбинация через относительно широкую запрещенную зону должна быть многофононной. Известно, что вероятность многофононных процессов быстро падает с увеличением числа фононов, участвующих в процессе. Это означает, что в полупроводниках с широкой запрещенной зоной межзонная фононная рекомбинация является также маловероятной.
При безизлучательной (фононной) рекомбинации избыточная энергия выделяется в виде фононов. Оценки показывают, что максимальная энергия фононов в кристаллах не превышает 0,1 эВ. Это означает, что при рекомбинации через запрещенную зону шириной порядка 1 эВ должно произойти одновременно испускание большого числа фононов. Следовательно, межзонная безизлучательная рекомбинация через относительно широкую запрещенную зону должна быть многофононной. Известно, что вероятность многофононных процессов быстро падает с увеличением числа фононов, участвующих в процессе. Это означает, что в полупроводниках с широкой запрещенной зоной межзонная фононная рекомбинация является также маловероятной.
Опыт, однако, показывает, что с увеличением ширины запрещенной зоны безизлучательная рекомбинация все более преобладает над излучательной. Это противоречие объясняется тем, что по мере увеличения ширины запрещенной зоны более вероятными становятся не прямые переходы через нее, а переходы через локальные уровни, расположенные в запрещенной зоне.
Рекомбинация через локальные уровни (центры). Как мы выяснили раньше, наличие дефектов и примесей в полупроводнике приводит к появлению в его энергетической диаграмме локальных энергетических уровней, расположенных в запрещенной зоне. Рассмотрим, какую роль они играют в процессе рекомбинации свободных носителей зарядов.
Пусть в запрещенной зоне донорного полупроводника, имеющего значительную концентрацию электронов зоны проводимости, располагается свободный локальный уровень Ел (рис. 8а), наличие которого обусловлено присутствием примесного атома или дефекта решетки. В этом случае рекомбинация проходит в два этапа .
Первым этапом является захват электрона зоны проводимости указанным примесным атомом ёёёёёё (или, как горят, захват электрона проводимости локальным уровнем Ел, как показано стрелкой 1 на рис. 8а). Дальнейшее поведении захваченного электрона может быть двояким. Электрон может перейти в валентную зону (стрелка 2) на свободный уровень, что эквивалентно захвату на локальный уровень дырки и ее рекомбинации с электроном. Возможен и показанный стрелкой 3 обратный тепловой переброс электрона в зону проводимости. Этомт процесс препятствует рекомбинации электрона и дырки. Таким образом, интенсивность процесса рекомбинации определяется соотношением вероятностей процессов, указанных стрелками 2 и 3.
Если локальные уровни располагаются близко к дну зоны проводимости или к потолку валентной зоны (рис. 8б), то есть являются мелкими, то вероятность протекания через них рекомбинации так же мала, как и вероятность межзонной рекомбинации. Поэтому наличие мелких локальных уровней приводит лишь к энергичному обмену электронами между ними и зоной проводимости (или валентной зоной) и не дает вклада в процесс рекомбинации. Дефекты или примеси, приводящие к появлению таких локальных уровней, называют ловушками захвата или центрами прилипания.
Если же локальный уровень глубокий, то вероятность обратного переброса (например, электрона в зону проводимости) незначительна, преобладает процесс захвата дырки, то есть происходит интенсивный процесс рекомбинации.
Дефекты или примеси, приводящие к появлению глубоких локальных уровней, на которых протекает процесс рекомбинации свободных электронов и дырок, называют рекомбинационными ловушками или центрами рекомбинации.
Высокая интенсивность процесса рекомбинации на рекомбинационных ловушках объясняется тем, что при этом механизме избыточная энергия передается кристаллической решетке в два этапа (двумя примерно равными порциями), то есть на каждом этапе в реакции участвует меньшее число фононов, чем при межзонной рекомбинации. Немаловажное значение имеет также тот факт, что вероятность встречи дырки с неподвижным электроном, локализованным на дефекте, значительно выше вероятности встречи её с подвижным электроном.
У примесных акцепторных полупроводников, имеющих значительную концентрацию дырок в валентной зоне, первым этапом рекомбинации является переход дырки из валентной зоны на локальный рекомбинационный уровень, а вторым этапом – захват электрона зоны проводимости и его рекомбинация с дыркой. Обратный тепловой переброс дырки в валентную зону препятствует процессу рекомбинации.
Отметим, что интенсивность протекания рекомбинации через рекомбинационные ловушки зависит от степени легирования полупроводника. В собственном полупроводнике она минимальна и увеличивается как по мере добавления донорных, так и по мере добавления акцепторных примесей.
Дата добавления: 2016-12-16; просмотров: 1987;











