Рассмотрим основные технологические этапы производства n-МОП СБИС на примере создания логического вентиля И-НЕ с двумя входами.
Принципиальная схема вентиля (инвертора) приведена на рисунке.
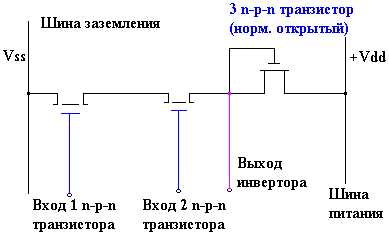
Схема состоит из последовательно соединенных двух транзисторов, работающих в режиме обогащения (нормально закрытых) и одного транзистора, работающего в режиме обеднения (нормально открытый). Все транзисторы располагаются между шиной источника питания Vdd и заземляющей шиной Vss. Затворы первых двух транзисторов служат входами схемы, а затвор третьего транзистора, соединенный с истоком второго, является выходом инвертора.
Нормально открытый транзистор служит источником тока для двух остальных. Выходное напряжение имеет низкое значение (логический нуль) только в том случае, когда оба первых транзистора открыты, т.е. на их затворы подан высокий потенциал - логическая единица.
Подложка.
В качестве подложки выбирают кремний p- типа проводимости легированный бором КДБ (100) с концентрацией примеси 1015 - 1016см-3. Выбор такой концентрации обусловлен несколькими причинами. С одной стороны уменьшение содержания примеси приводит к снижению чувствительности порогового напряжения к напряжению смещения на подложке и уменьшению емкости p-n переходов, приводя к увеличению быстродействия транзистора. С другой стороны возрастает концентрация неосновных носителей, вызывающих рост тока утечки через обратно смещенный p-n переход, что может привести к соприкосновению областей пространственного заряда стока и истока транзистора (прокол). Одним из вариантов решения этого противоречия является выращивание слаболегированных эпитаксиальных кремниевых слоев на сильнолегированной подложке, имеющей малую концентрацию неосновных носителей.
Ориентация кремниевой подложки (100) имеет преимущество по сравнению с (111), заключающееся с более высокой подвижности электронов, обусловленной низкой плотностью поверхностных состояний на границе кремний-диэлектрик.
Этапы технологического процесса.
Этап.
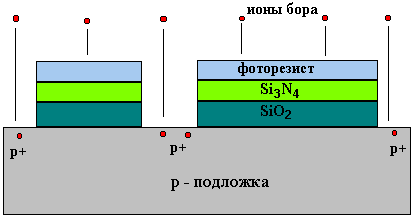
Ионная имплантация бора для создания изоляции между транзисторами с помощью p-n переходов.
На поверхность кремниевой подложки наносятся промежуточный слой термической двуокиси кремния и слой нитрида кремния, играющий роль маски при последующем локальном окислении кремния. Далее с помощью процесса литографии на поверхности вытравливаются окна, в которые осуществляется ионная имплантация бора. Иногда имплантацию осуществляют через слой окисла для уменьшения концентрации примеси в подложке и глубины ее проникновения.
Этап.

На этом этапе проводятся следующие технологические операции:
- локальное окисление кремния (ЛОКОС процесс)
- формирование подзатворного окисла (после удаления промежуточных слоев двуокиси и нитрида кремния)
- имплантация бора для регулировки порогового напряжения нормально закрытых транзисторов
- формирование окна под скрытый контакт.
Этап.

На данном этапе проводится ионная имплантация мышьяка для формирования канала нормально открытого транзистора. Использование мышьяка вместо фосфора обусловлено меньшей его глубиной в полупроводниковую подложку.
Этап.

Проводится нанесение поликристаллического кремния с его последующим легированием мышьяком. Поликремний выполняет роль будущих затворов, предотвращает p- каналы от дальнейшей перекомпенсации акцепторной примеси мышьяком и служит материалом для последующего соединения стока и затвора нормально открытого транзистора. На этом этапе достигается самосовмещение стоков, истоков и затворов.
Этап.
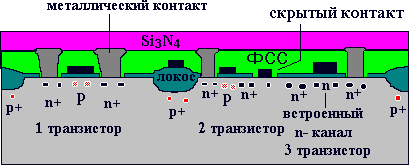
Заключительный этап формирования схемы. На нем осуществляются:
- литография под металлизацию к стокам и истокам транзисторов
- нанесение фосфорсиликатного стекла (ФСС). ФСС предотвращает диффузию ионов натрия, сглаживает рельеф поверхности, производит дополнительную активацию примеси.
- формируется пассивирующий диэлектрический слой (окисел или плазмохимический нитрид кремния).
ЛОКОС процесс
Допустим, что мы имеем два близко расположенных n- канальных транзистора с общим затвором (см. рис. 1).
 Направление проводимости активных транзисторов перпендикулярно поликремниевому затвору. Под затвором между соседними транзисторами возникает паразитный транзистор.Если его пороговое напряжение слишком низкое, то между близкорасположенными n+ областями может образоваться инверсионный слой, который соединит соседние активные транзисторы. Во избежание этого необходимо повысить пороговое напряжение паразитного транзистора. Для чего между активными транзисторами создается толстый слой окисла и/или увеличивается степень легирования подложки.
Направление проводимости активных транзисторов перпендикулярно поликремниевому затвору. Под затвором между соседними транзисторами возникает паразитный транзистор.Если его пороговое напряжение слишком низкое, то между близкорасположенными n+ областями может образоваться инверсионный слой, который соединит соседние активные транзисторы. Во избежание этого необходимо повысить пороговое напряжение паразитного транзистора. Для чего между активными транзисторами создается толстый слой окисла и/или увеличивается степень легирования подложки.
Указанный выше диэлектрический слой формируется по технологии локального окисления кремния (ЛОКОС процесс). Данная технология имеет преимущества по сравнению с обычным способом выращивания толстого слоя двуокиси кремния над всей поверхностью подложки с последующим вскрытием окон для создания активных транзисторов.
 Эти преимущества заключаются в следующем: во-первых - рельеф поверхности более гладкий, т. к. часть изолирующего окисла располагается под поверхностью подложки (см. рис. 2), во-вторых - область, ограничивающая распространение канала, самосовмещается с активными областями транзисторов.
Эти преимущества заключаются в следующем: во-первых - рельеф поверхности более гладкий, т. к. часть изолирующего окисла располагается под поверхностью подложки (см. рис. 2), во-вторых - область, ограничивающая распространение канала, самосовмещается с активными областями транзисторов.
Заметим, что в качестве промежуточного слоя, используемого в качестве маски при локальном окислении, выступает нитрид кремния.
Этапы ЛОКОС процесса:
- травление маски нитрида и промежуточного окисла, а также имплантация примеси для создания областей, ограничивающих распространение канала,
- локальное окисление кремния,
- удаление пленок оксинитрида, нитрида и промежуточного слоя двуокиси кремния,
- выращивание подзатворного диэлектрика.
Дата добавления: 2020-11-18; просмотров: 603;











