ЭЛЕКТРИЧЕСКИЕ ПЕРЕХОДЫ
Электрический переход в полупроводнике — это граничный слой между двумя областями, физические характеристики которых существенно различаются.
Переходы между двумя областями полупроводника с различным типом электропроводности, называют электронно-дырочными или р-n-переходами.
Переходы между двумя областями с одним типом электропроводности (n- или р-типа), отличающиеся концентрацией примесей и соответственно значением удельной проводимости, называют электронно-электронными (n+-n -переход) или дырочно-дырочными (p+-p-переход). Причем знак плюс в обозначении одного из слоев показывает, что концентрация носителей заряда одного типа в этом слое значительно выше, чем во втором, и поэтому слой имеет меньшее удельное электрическое сопротивление.
Переходы между двумя полупроводниковыми материалами, имеющими различную ширину запрещенной зоны, называют гетеропереходами.
Если одна из областей, образующих переход, является металлом, то такой переход называют контактом металл — полупроводник.
Электрические переходы нельзя создать путем механического контакта двух областей с разными физическими свойствами, хотя при рассмотрении физических процессов такая абстракция обычно используется. Это объясняется тем, что поверхности кристаллов обычно загрязнены окислами и атомами других веществ. Существенную роль играет воздушный зазор, устранить который при механическом контакте практически невозможно.
Для уяснения процессов, в результате которых между областями с различными физическими свойствами возникают слои со свойствами, отличающимися от свойств каждой из областей, участвующих в контакте, рассмотрим процессы, происходящие при технологическом соединении разнородных материалов.
Контакт металл — полупроводник. Пусть уровень Ферми в металле  , который всегда расположен в зоне проводимости, лежит выше уровня Ферми полупроводника р-типа
, который всегда расположен в зоне проводимости, лежит выше уровня Ферми полупроводника р-типа  (рис. 1.5, а, б). Так как энергия электронов металла больше энергии носителей заряда полупроводника, то часть электронов перейдет из металла в полупроводник. Переход будет продолжаться до тех пор, пока уровни Ферми вблизи контакта не выровняются (в равновесной системе уровень Ферми должен быть единым). В полупроводнике вблизи контакта окажется избыточный заряд электронов
(рис. 1.5, а, б). Так как энергия электронов металла больше энергии носителей заряда полупроводника, то часть электронов перейдет из металла в полупроводник. Переход будет продолжаться до тех пор, пока уровни Ферми вблизи контакта не выровняются (в равновесной системе уровень Ферми должен быть единым). В полупроводнике вблизи контакта окажется избыточный заряд электронов  , которые начнут рекомбинировать с дырками. Концентрация
, которые начнут рекомбинировать с дырками. Концентрация
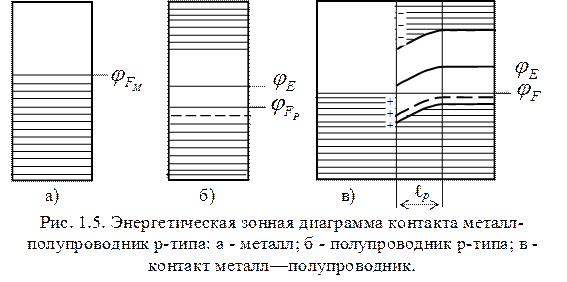
последних вблизи контакта уменьшится, так как произведение концентраций носителей заряда в равновесном состоянии при данной температуре - величина постоянная. Уменьшение концентрации дырок приведет к нарушению электронейтральности на этом участке. Отрицательно заряженные ионы акцепторной примеси будут не скомпенсированы зарядами дырок и, следовательно, в полупроводнике вблизи места контакта образуется слой неподвижных отрицательно заряженных ионов акцепторной примеси. С уходом электронов из металла тонкий слой, прилегающий к месту контакта, зарядится положительно. В результате у границ контакта возникнут объемные заряды, и появится контактная разность потенциалов. Образовавшееся электрическое поле препятствует дальнейшему движению электронов из металла в полупроводник и способствует переходу электронов из полупроводника р-типа (неосновные носители заряда) в металл.
В равновесной системе наблюдается динамическое равновесие встречно движущихся основных и неосновных носителей заряда. Результирующий ток через переход равен нулю. Так как концентрация основных носителей заряда (дырок) в приконтактном слое полупроводника понижена по сравнению с их концентрацией в его объеме, то этот слой имеет повышенное удельное сопротивление, которое будет определять сопротивление всей системы. Уменьшение или увеличение концентрации носителей заряда характеризуется изменением положения уровня Ферми относительно соответствующих зон. При уменьшении концентрации дырок и увеличении концентрации электронов энергетическое расстояние между потолком валентной зоны и уровнем Ферми увеличивается, а между дном зоны проводимости и уровнем Ферми уменьшается. Поэтому энергетические уровни на узком приконтактном участке, толщина которого характеризуется так называемой дебаевской длиной  , искривлены (рис. 1.5,в):
, искривлены (рис. 1.5,в):  см.
см.
Если к системе подключить внешнее напряжение, причем плюс - к полупроводнику, а минус - к металлу, то возникнет дополнительное электрическое поле, снижающее внутреннее электрическое поле в переходе. Сопротивление приконтактного высокоомного слоя уменьшается и через переход потечет ток, обусловленный переходом электронов из металла в полупроводник. Увеличение приложенного напряжения приводит к увеличению тока. При смене полярности приложенного напряжения (плюс - к металлу, минус - к полупроводнику) внешнее электрическое поле суммируется с внутренним полем и приконтактный слой еще сильнее обедняется дырками. Сопротивление перехода увеличивается. Так как электрическое поле не препятствует движению электронов полупроводника р-типа, последние будут проходить через переход, вызывая ток в цепи. Этот ток мал в связи с низкой концентрацией неосновных носителей заряда.
Таким образом, переход между металлом и полупроводником обладает вентильными свойствами. Его называют барьером Шоттки.
Аналогичные процессы имеют место при контакте металла с полупроводником n-типа, у которого уровень Ферми выше, чем у металла (рис. 1.6). Электроны из полупроводника переходят в металл, искривляя вверх энергетические уровни и обедняя поверхностный слой основными носителями заряда. Это приводит к нарушению электронейтральности на данном участке и образованию областей, состоящих из нескомпенсированных положительно заряженных ионов донорной примеси. Возникают контактная разность потенциалов и переход, обладающий вентильными свойствами.
В зависимости от положения уровня Ферми в металле при контакте его с полупроводником в последнем может образоваться слой, имеющий даже противоположный тип электропроводности (инверсный слой). Действительно, если взять металл, у которого уровень Ферми ниже середины запрещенной зоны  , и полупроводник n-типа и соединить их вместе, то энергетические уровни изогнутся так сильно, что вблизи валентной зоны уровень Ферми будет находиться на расстоянии, меньшем 0,5
, и полупроводник n-типа и соединить их вместе, то энергетические уровни изогнутся так сильно, что вблизи валентной зоны уровень Ферми будет находиться на расстоянии, меньшем 0,5  .
.
Такое расположение уровня Ферми относительно потолка валентной зоны характеризует электропроводность р-типа. Следовательно, в полупроводнике n-типа образовался слой с электропроводностью р-типа, причем электропроводность одного типа плавно переходит в электропроводность другого типа. Это явление объясняется тем, что электронов в зоне проводимости полупроводника недостаточно для получения равновесной системы (выравнивания уровней Ферми) и часть электронов из валентной зоны переходит в металл, в результате чего и появляются дырки.

Определенный интерес представляет случай контакта металл-полупроводник, когда уровень Ферми металла ниже соответствующего уровня полупроводника р-типа, т. е.  и выше уровня Ферми полупроводника n-типа, т. е.
и выше уровня Ферми полупроводника n-типа, т. е.  .
.
При этом граничные слои будут не обеднены, а обогащены основными носителями и удельное сопротивление граничных слоев окажется значительно меньше, чем соответствующее сопротивление вдали от границы. Такие переходы являются основой омического контакта.
Действительно, при соединении металла с полупроводником р-типа, у которого  , электроны полупроводника перейдут в металл, в результате чего приповерхностный слой окажется обогащенным основными носителями заряда - дырками. Удельное сопротивление приконтактной области станет меньше, чем в объеме полупроводника. Аналогично, приконтактный слой полупроводника n-типа при
, электроны полупроводника перейдут в металл, в результате чего приповерхностный слой окажется обогащенным основными носителями заряда - дырками. Удельное сопротивление приконтактной области станет меньше, чем в объеме полупроводника. Аналогично, приконтактный слой полупроводника n-типа при  будет обогащен электронами за счет их перехода из металла, где уровень Ферми выше. Ввиду малого значения сопротивлений зон, прилегающих к контакту, они не оказывают существенного влияния на общее сопротивление системы. Подключение напряжения прямой или обратной полярности изменяет лишь степень обогащения приконтактных областей основными носителями заряда, практически не меняя общего сопротивления системы. На основе таких переходов металл-полупроводник выполняются выводы от областей полупроводника.
будет обогащен электронами за счет их перехода из металла, где уровень Ферми выше. Ввиду малого значения сопротивлений зон, прилегающих к контакту, они не оказывают существенного влияния на общее сопротивление системы. Подключение напряжения прямой или обратной полярности изменяет лишь степень обогащения приконтактных областей основными носителями заряда, практически не меняя общего сопротивления системы. На основе таких переходов металл-полупроводник выполняются выводы от областей полупроводника.
Контакт двух полупроводников р- и n-типов. Рассмотрим переход между двумя областями полупроводника, имеющими различный тип электропроводности. Концентрации основных носителей заряда в этих областях могут быть равны или существенно различаться.
Электронно-дырочный переход, у которого  , называют симметричным р-n-переходом.
, называют симметричным р-n-переходом.
Если концентрации основных носителей заряда в областях различны (  или
или  ) и отличаются в 100—1000 раз, то такие р-n-переходы называют несимметричными.
) и отличаются в 100—1000 раз, то такие р-n-переходы называют несимметричными.
Несимметричные р-n-переходы распространены гораздо шире, чем симметричные, поэтому в дальнейшем будем рассматривать только их.
В зависимости от характера распределения примесей, обеспечивающих требуемый тип электропроводности, в областях различают два типа переходов: резкий (ступенчатый) и плавный. В резком переходе концентрации примесей на границе раздела областей изменяются на расстоянии, соизмеримом с диффузионной длиной; в плавном переходе - на расстоянии, значительно большем диффузионной длины.
Резкость границы играет существенную роль, так как в плавном р-n-переходе трудно получить те вентильные свойства, которые необходимы для работы диодов и транзисторов.
Свойства несимметричного р-n-перехода. Пусть концентрация дырок в области полупроводника с электропроводностью р-типа, т. е. в области р, намного выше концентрации электронов в области n (рис. 1.7, а), т. е. слой р более низкоомный.
Поскольку концентрация дырок в области р выше, чем в области n, то часть дырок в результате диффузии перейдет в область n. В области n вблизи границы окажутся избыточные дырки, которые будут рекомбинировать с электронами. Соответственно в этой зоне уменьшится концентрация свободных электронов, и образуются области нескомпенсированных положительных зарядов донорных атомов. В области р уход дырок из граничного слоя способствует образованию областей с нескомпенсированными отрицательными зарядами акцепторных атомов (рис. 1.7, в).
Подобным же образом происходит диффузионное перемещение электронов из слоя n в слой р. Однако в связи с малой концентрацией электронов по сравнению с концентрацией дырок перемещением основных носителей заряда высокоомной области в первом приближении пренебрегают. Перемещение происходит до тех пор, пока уровни Ферми обоих слоев не уравняются.
 Область образовавшихся неподвижных пространственных зарядов (ионов) и есть область р-n-перехода. В ней имеет место пониженная концентрация основных носителей заряда и, следовательно, повышенное сопротивление, которое определяет электрическое сопротивление всей системы.
Область образовавшихся неподвижных пространственных зарядов (ионов) и есть область р-n-перехода. В ней имеет место пониженная концентрация основных носителей заряда и, следовательно, повышенное сопротивление, которое определяет электрическое сопротивление всей системы.
В зонах, прилегающих к месту контакта двух разнородных областей, нарушается условие электронейтральности. В области р остается нескомпенсированный заряд отрицательно заряженных акцепторных примесей, а в области n - положительно заряженных доноров (рис. 1.7, б, в). Но за пределами р-n-перехода все заряды взаимно компенсируют друг друга и полупроводник в целом остается электрически нейтральным.
Электрическое поле, возникающее между разноименными ионами, препятствует перемещению основных носителей заряда. Поэтому поток дырок из области р в область n и электронов из n в р уменьшается по мере роста напряженности электрического поля. Однако это поле не препятствует движению через переход неосновных носителей, имеющихся в р- и n-областях. Эти носители заряда собственной электропроводности, имеющие энергию теплового происхождения, генерируются в объеме полупроводника и, диффундируя к электрическому переходу, захватываются электрическим полем. Они перебрасываются в область с противоположной электропроводностью.
Переход неосновных носителей приводит к уменьшению объемного заряда и электрического поля в переходе. Как следствие, имеет место дополнительный диффузионный переход основных носителей, в результате чего электрическое поле принимает исходное значение. При равенстве потоков основных и неосновных носителей заряда и соответственно токов наступает динамическое равновесие.
Таким образом, через р-n-переход в равновесном состоянии (без приложения внешнего потенциала) движутся два встречно направленных потока зарядов, находящихся в динамическом равновесии и взаимно компенсирующих друг друга. Суммарная плотность тока, определяемая выражением (1.11), будет равна нулю.
Ионы в р-n-переходе создают разность потенциалов  которую называют потенциальным барьером или контактной разностью потенциалов. Производная от нее, взятая по геометрической координате дает значение напряженности электрического поля в переходе
которую называют потенциальным барьером или контактной разностью потенциалов. Производная от нее, взятая по геометрической координате дает значение напряженности электрического поля в переходе

Значение контактной разности потенциалов определяется положениями уровней Ферми в областях n и р

и в первом приближении для рассмотренного полупроводника ее находят из выражения
 ,
,
где  — концентрации основных носителей заряда в равновесном состоянии в областях n и р.
— концентрации основных носителей заряда в равновесном состоянии в областях n и р.
Величину  иногда называют диффузионным потенциалом, поскольку эта разность потенциалов, во-первых, образуется в результате диффузии носителей через переход и, во-вторых, противодействует диффузионным потокам носителей.
иногда называют диффузионным потенциалом, поскольку эта разность потенциалов, во-первых, образуется в результате диффузии носителей через переход и, во-вторых, противодействует диффузионным потокам носителей.
Учитывая, что в равновесном полупроводнике при данной температуре
 выражение для контактной разности потенциалов можно записать в виде
выражение для контактной разности потенциалов можно записать в виде
 , (1.15.а)
, (1.15.а)
 . (1.15.б)
. (1.15.б)
Так, если у германия 
 , то
, то  . Значение контактной разности потенциалов у германиевых полупроводниковых приборов при комнатной температуре обычно не превышает 0,4 В; в кремниевых приборах
. Значение контактной разности потенциалов у германиевых полупроводниковых приборов при комнатной температуре обычно не превышает 0,4 В; в кремниевых приборах  может достигать 0,7—0,8 В.
может достигать 0,7—0,8 В.
Ширина несимметричного ступенчатого р-n-перехода может быть определена из выражения

где  - относительная диэлектрическая проницаемость полупроводника;
- относительная диэлектрическая проницаемость полупроводника;  - диэлектрическая постоянная воздуха.
- диэлектрическая постоянная воздуха.
Переход p-n смещен в прямом направлении. Если к р-n-переходу приложить напряжение  плюсом к области р, а минусом — к области n, то это напряжение будет почти полностью падать на р-n-переходе, сопротивление которого во много раз выше сопротивлений областей р и n. В р-n-переходе появится дополнительное внешнее электрическое поле, уменьшающее внутреннее поле p-n-перехода. Потенциальный барьер уменьшится и станет равным
плюсом к области р, а минусом — к области n, то это напряжение будет почти полностью падать на р-n-переходе, сопротивление которого во много раз выше сопротивлений областей р и n. В р-n-переходе появится дополнительное внешнее электрическое поле, уменьшающее внутреннее поле p-n-перехода. Потенциальный барьер уменьшится и станет равным  . Соответственно уменьшится ширина p-n-перехода
. Соответственно уменьшится ширина p-n-перехода  и его сопротивление.
и его сопротивление.
В цепи потечет электрический ток. Однако до тех пор, пока  обедненный носителями заряда р-n-переход имеет высокое сопротивление, и ток имеет малое значение. Этот ток вызван дополнительным диффузионным движением носителей заряда, перемещение которых стало возможным в связи с уменьшением потенциального барьера.
обедненный носителями заряда р-n-переход имеет высокое сопротивление, и ток имеет малое значение. Этот ток вызван дополнительным диффузионным движением носителей заряда, перемещение которых стало возможным в связи с уменьшением потенциального барьера.
При  толщина p-n-перехода стремится к нулю и при дальнейшем увеличении напряжения
толщина p-n-перехода стремится к нулю и при дальнейшем увеличении напряжения  переход как область, обедненная носителями заряда, вообще отсутствует. В результате компенсации внешним напряжением потенциального барьера электроны и дырки, являющиеся основными носителями заряда в областях р и n, начинают свободно диффундировать в области с противоположным типом электропроводности. Следовательно, существовавший в равновесном состоянии баланс токов диффузии и дрейфа нарушается и вследствие снижения потенциального барьера диффузия основных носителей заряда увеличивается. Через переход потечет ток, который носит название прямого тока.
переход как область, обедненная носителями заряда, вообще отсутствует. В результате компенсации внешним напряжением потенциального барьера электроны и дырки, являющиеся основными носителями заряда в областях р и n, начинают свободно диффундировать в области с противоположным типом электропроводности. Следовательно, существовавший в равновесном состоянии баланс токов диффузии и дрейфа нарушается и вследствие снижения потенциального барьера диффузия основных носителей заряда увеличивается. Через переход потечет ток, который носит название прямого тока.
Введение («нагнетание») носителей заряда через электронно-дырочный переход в область полупроводника, где они являются неосновными носителями за счет снижения потенциального барьера, называется инжекцией.
Если р-n-переход является несимметричным и концентрация дырок в области р во много раз выше концентрации электронов в области n, то диффузионный поток дырок будет во много раз превышать соответствующий поток электронов и последним можно пренебречь. В этом случае будет иметь место односторонняя инжекция носителей заряда.
В несимметричном р-n-переходе концентрации основных носителей различаются на несколько порядков (108 - 104). Поэтому концентрация инжектируемых неосновных носителей гораздо больше в высокоомном слое, чем в низкоомном, т. е. инжекция имеет односторонний характер. Неосновные носители заряда инжектируются в основном из низкоомного слоя в высокоомный слой.
Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером; слой, в который инжектируются не основные для него носители, — базой.
Изменение высоты потенциального барьера сопровождается, вообще говоря, изменением всех четырех граничных концентраций. Однако поскольку концентрации основных носителей значительно больше, чем неосновных, можно считать, что меняются только последние. Поэтому заменим в правых частях формул (1.15) концентрации  на
на  и
и  на
на  ,а в левых частях — величину
,а в левых частях — величину  на
на  . После этого, подставляя значения
. После этого, подставляя значения  из (1.15), нетрудно установить связь между граничными концентрациями неосновных носителей в равновесном и неравновесном состояниях перехода:
из (1.15), нетрудно установить связь между граничными концентрациями неосновных носителей в равновесном и неравновесном состояниях перехода:
 ;
;  (1.16)
(1.16)
Из (1.16) следует, что концентрация неосновных носителей заряда на границе р-n-перехода увеличивается по экспоненциальному закону в зависимости от напряжения, приложенного к нему.
Дополнительные неосновные носители заряда в течение времени  компенсируются основными носителями заряда, которые приходят из объема полупроводника. В результате на границе р-n-перехода появляется избыточный заряд основных носителей заряда и выполняется условие
компенсируются основными носителями заряда, которые приходят из объема полупроводника. В результате на границе р-n-перехода появляется избыточный заряд основных носителей заряда и выполняется условие  ;
;  . Полупроводник опять становится электронейтральным.
. Полупроводник опять становится электронейтральным.
Такое перераспределение основных носителей заряда приводит к появлению электрического тока во внешней цепи, так как по ней поступают носители заряда взамен ушедших к р-n-переходу и исчезнувших в результате рекомбинации.
Неосновные носители заряда, оказавшиеся вследствие инжекции на границе р-n-перехода, перемещаются внутрь области с противоположным типом электропроводности. Причиной этого явления являются диффузия и дрейф. Если напряженность электрического поля в полупроводнике невелика, основной причиной движения является градиент концентрации. Под его влиянием неосновные носители заряда (в рассматриваемом случае дырки) движутся внутрь полупроводника, а основные (электроны) — в сторону инжектирующей поверхности, где идет интенсивная рекомбинация.
При диффузии неосновных носителей заряда внутрь полупроводника концентрация их непрерывно убывает из-за рекомбинаций. Если размеры p- и n-областей превышают диффузионные длины  (массивный полупроводник), то концентрации неосновных носителей заряда при удалении от перехода определяются выражениями
(массивный полупроводник), то концентрации неосновных носителей заряда при удалении от перехода определяются выражениями
 ,
,  , (1.17)
, (1.17)
где x - расстояние от точки, где избыточная концентрация равна  или
или  .
.
Таким образом, если в массивном полупроводнике в какой-то точке концентрация неосновных носителей заряда равна  , то на расстоянии x в глубине полупроводника она уменьшится в
, то на расстоянии x в глубине полупроводника она уменьшится в  раз.
раз.
Распределение неосновных носителей заряда в массивном полупроводнике показано на рис. 1.8, а. На расстоянии  концентрация неосновных носителей заряда стремится к
концентрация неосновных носителей заряда стремится к  и
и  .
.  Следовательно, вблизи р-n-перехода ток в системе обусловлен в основном диффузионным движением инжектированных носителей заряда. Вдали от р-n-перехода, где диффузионная составляющая тока стремится к нулю, последний имеет дрейфовый характер и основные носители заряда движутся в электрическом поле, созданном внешним напряжением на участке областей р и n, имеющих омическое сопротивление (рис. 1.8, б). Если толщины W областей n и p достаточно малы, так что выполняется условие
Следовательно, вблизи р-n-перехода ток в системе обусловлен в основном диффузионным движением инжектированных носителей заряда. Вдали от р-n-перехода, где диффузионная составляющая тока стремится к нулю, последний имеет дрейфовый характер и основные носители заряда движутся в электрическом поле, созданном внешним напряжением на участке областей р и n, имеющих омическое сопротивление (рис. 1.8, б). Если толщины W областей n и p достаточно малы, так что выполняется условие  , то можно считать, что концентрация неосновных носителей заряда внутри полупроводника изменяется по закону, близкому к линейному:
, то можно считать, что концентрация неосновных носителей заряда внутри полупроводника изменяется по закону, близкому к линейному:

 . (1.18)
. (1.18)
В установившемся режиме избыточные неосновные носители заряда, накопленные в области с противоположным типом электропроводности, несут заряд Q, значение которого пропорционально их концентрации, а, следовательно, току через систему и постоянной времени жизни неосновных носителей заряда  :
:  .
.
Поэтому любое изменение тока сопровождается изменением заряда, накопленного с обеих сторон р-n-перехода. При односторонней инжекции заряд в основном накапливается в высокоомной базе.
 В равновесном состоянии через р-n-переход протекает ток, имеющий две составляющие, одна из которых обусловлена диффузией основных носителей заряда в область, где они являются неосновными, вторая - дрейфом неосновных носителей заряда теплового происхождения
В равновесном состоянии через р-n-переход протекает ток, имеющий две составляющие, одна из которых обусловлена диффузией основных носителей заряда в область, где они являются неосновными, вторая - дрейфом неосновных носителей заряда теплового происхождения  . При приложении к р-n-переходу прямого напряжения это равновесие нарушается. Ток диффузии основных носителей заряда
. При приложении к р-n-переходу прямого напряжения это равновесие нарушается. Ток диффузии основных носителей заряда  за счет снижения потенциального барьера увеличивается в
за счет снижения потенциального барьера увеличивается в  раз и является функцией приложенного напряжения:
раз и является функцией приложенного напряжения:

 - ток, обусловленный дрейфом неосновных носителей заряда через р-n-переход, находящийся в равновесном состоянии.
- ток, обусловленный дрейфом неосновных носителей заряда через р-n-переход, находящийся в равновесном состоянии.
Вторая составляющая тока при приложении внешнего напряжения остается практически без изменения. Это обусловлено тем, что создающие ток электроны и дырки генерируются вблизи p-n-перехода на расстоянии, меньшем диффузионной длины  . Те заряды, которые рождаются на большем расстоянии, в основном рекомбинируют, не дойдя до перехода. Изменение ширины перехода для носителей заряда этого происхождения не играет существенной роли; они как генерировались в пределах толщины, определяемой диффузионной длиной, так и будут генерироваться. Соответственно ток, обусловленный движением этих носителей заряда, останется без изменения, т. е. таким же, как и в равновесном состоянии
. Те заряды, которые рождаются на большем расстоянии, в основном рекомбинируют, не дойдя до перехода. Изменение ширины перехода для носителей заряда этого происхождения не играет существенной роли; они как генерировались в пределах толщины, определяемой диффузионной длиной, так и будут генерироваться. Соответственно ток, обусловленный движением этих носителей заряда, останется без изменения, т. е. таким же, как и в равновесном состоянии  . Следовательно, результирующий ток через р-n-переход при приложении прямого напряжения
. Следовательно, результирующий ток через р-n-переход при приложении прямого напряжения
 . (1.19)
. (1.19)
В неравновесной системе постоянство уровня Ферми нарушается. Поэтому при анализе используют понятие «квазиуровень Ферми», которым оперируют так же, как уровнем Ферми.
 Зонная энергетическая диаграмма полупроводника при включении прямого напряжения показана на рис. 1.9, а. Как видно из диаграммы, квазиуровни Ферми неизменны во всей области p и n, а также во всем р-n-переходе. Пунктиром условно показаны квазиуровни Ферми для неосновных носителей заряда в каждой из областей. За пределами р-n-перехода на некотором расстоянии от него они совпадают с квазиуровнями для основных носителей заряда. Изменение ширины р-n-перехода и распределение потенциалов вблизи р-n-перехода представлено на рис. 1.9, б, в.
Зонная энергетическая диаграмма полупроводника при включении прямого напряжения показана на рис. 1.9, а. Как видно из диаграммы, квазиуровни Ферми неизменны во всей области p и n, а также во всем р-n-переходе. Пунктиром условно показаны квазиуровни Ферми для неосновных носителей заряда в каждой из областей. За пределами р-n-перехода на некотором расстоянии от него они совпадают с квазиуровнями для основных носителей заряда. Изменение ширины р-n-перехода и распределение потенциалов вблизи р-n-перехода представлено на рис. 1.9, б, в.
Переход p-n, смещенный в обратном направлении. Если к электронно-дырочному переходу приложено обратное напряжение, полярность которого совпадает с направлением контактной разности потенциалов: плюс - к n-области, минус - к р-области, то общий потенциальный барьер (рис. 1.10, а, в) повышается. Движение основных носителей через р-n-переход уменьшится и при некотором значении  совсем прекратится. Другими словами, в этом случае электроны и дырки начнут двигаться от р-n-перехода и дефицит свободных носителей заряда в р-n-переходе увеличится (рис. 1.10, б).
совсем прекратится. Другими словами, в этом случае электроны и дырки начнут двигаться от р-n-перехода и дефицит свободных носителей заряда в р-n-переходе увеличится (рис. 1.10, б).
При этом ток будет обусловлен движением неосновных носителей, которые, попав в поле электронно-дырочного перехода, будут им захватываться и переноситься через р-n-переход.
Процесс «отсоса» неосновных носителей заряда (при обратном включении напряжения) называется экстракцией.
Уход неосновных носителей заряда приведет к тому, что концентрация их у границ р-n-перехода снизится до нуля. Неосновные носители заряда вследствие диффузии начнут двигаться к границе p-n-перехода, компенсируя убыль зарядов и создавая электрический ток. При малых значениях обратного напряжения кроме этого тока через переход движутся основные носители заряда, вызывая противоположно направленный ток

Результирующий ток р-n-перехода при обратном включении
 (1.20)
(1.20)
Таким образом, тепловой ток, вызванный неосновными носителями заряда, и в этом случае остается неизменным, а ток, вызванный диффузией основных носителей заряда, уменьшается по экспоненциальному закону. При напряжении  , равном нескольким
, равном нескольким  (
(  = 25мВ при T = 300 К), током основных носителей заряда можно пренебречь. Значение обратного тока не будет зависеть от обратного напряжения, приложенного к р-n-переходу. Поэтому тепловой ток
= 25мВ при T = 300 К), током основных носителей заряда можно пренебречь. Значение обратного тока не будет зависеть от обратного напряжения, приложенного к р-n-переходу. Поэтому тепловой ток  и в этом случае называют обратным током насыщения или просто обратным током. Это объясняется тем, что все неосновные носители заряда, генерируемые в объеме, ограниченном диффузионной длиной и площадью p-n-перехода, участвуют в движении через р-n-переход. Энергетическая диаграмма р-n-перехода, смещенного в обратном направлении, показана на рис. 1.10, а. По расположению квазиуровней Ферми для неосновных носителей заряда видно, что их концентрация на границах р-n-перехода мала, а в объеме полупроводника совпадает с равновесной.
и в этом случае называют обратным током насыщения или просто обратным током. Это объясняется тем, что все неосновные носители заряда, генерируемые в объеме, ограниченном диффузионной длиной и площадью p-n-перехода, участвуют в движении через р-n-переход. Энергетическая диаграмма р-n-перехода, смещенного в обратном направлении, показана на рис. 1.10, а. По расположению квазиуровней Ферми для неосновных носителей заряда видно, что их концентрация на границах р-n-перехода мала, а в объеме полупроводника совпадает с равновесной.
Идеализированная вольт-амперная характеристика (ВАХ) диода описывается выражением
 ,
,
где  - тепловой ток,
- тепловой ток,  – площадь перехода.
– площадь перехода.
Ток  , определяющий «масштаб» характеристики, называется тепловым током. Термин «тепловой» отражает сильную температурную зависимость тока
, определяющий «масштаб» характеристики, называется тепловым током. Термин «тепловой» отражает сильную температурную зависимость тока  , а также тот факт, что он равен нулю при абсолютном нуле температуры. Другим распространенным термином является «обратный ток насыщения», происхождение которого связано с тем, что при отрицательном напряжении
, а также тот факт, что он равен нулю при абсолютном нуле температуры. Другим распространенным термином является «обратный ток насыщения», происхождение которого связано с тем, что при отрицательном напряжении  обратный ток идеализированного диода равен
обратный ток идеализированного диода равен  и не зависит от напряжения.
и не зависит от напряжения.
Итак, идеализированный р-n-переход обладает вентильными свойствами. При приложении к нему напряжения, смещающего р-n-переход в прямом направлении, протекает ток, который при увеличении напряжения увеличивается по экспоненциальному закону. Если приложить напряжение, смещающее р-n-переход в обратном направлении, то сопротивление его возрастет. В цепи протекает малый тепловой ток, который не зависит от приложенного напряжения и увеличивается по экспоненциальному закону при увеличении температуры.
Переходы  типов. Кроме р-n-переходов встречаются и другие типы переходов. Это связано с наличием в некоторых полупроводниках областей, концентрации носителей заряда в которых существенно отличаются. Можно, например, получить полупроводник, в одной области которого электропроводность собственная (i), а в другой - примесная (р или n). Переход между этими двумя областями носит название р-i- или n-i-перехода. Если в одном из слоев концентрация основных носителей заряда намного выше (n+, р+), чем в другой области с однотипной электропроводностью, то возникают n+ - n- или р+ - р - переходы. При контакте собственного и примесного полупроводников (
типов. Кроме р-n-переходов встречаются и другие типы переходов. Это связано с наличием в некоторых полупроводниках областей, концентрации носителей заряда в которых существенно отличаются. Можно, например, получить полупроводник, в одной области которого электропроводность собственная (i), а в другой - примесная (р или n). Переход между этими двумя областями носит название р-i- или n-i-перехода. Если в одном из слоев концентрация основных носителей заряда намного выше (n+, р+), чем в другой области с однотипной электропроводностью, то возникают n+ - n- или р+ - р - переходы. При контакте собственного и примесного полупроводников (  и
и  ) из-за разности концентраций носителей заряда возникает диффузия дырок в собственный полупроводник i-типа и электронов в полупроводник р-типа. Появляется разность потенциалов, образованная областью с нескомпенсированными отрицательно заряженными ионами акцепторных примесей и дырками в полупроводнике с собственной электропроводностью. Однако эта разность потенциалов значительно меньше, чем в р-n-переходе, и слой, обедненный носителями заряда, простирается большей частью в область собственного полупроводника.
) из-за разности концентраций носителей заряда возникает диффузия дырок в собственный полупроводник i-типа и электронов в полупроводник р-типа. Появляется разность потенциалов, образованная областью с нескомпенсированными отрицательно заряженными ионами акцепторных примесей и дырками в полупроводнике с собственной электропроводностью. Однако эта разность потенциалов значительно меньше, чем в р-n-переходе, и слой, обедненный носителями заряда, простирается большей частью в область собственного полупроводника.
Наличие высокоомной области в полупроводнике с собственной относительно малой электропроводностью приводит к тому, что на переходе падает только часть приложенного напряжения, и вентильные свойства у р-i- и n-i-переходов выражены значительно слабее, чем у р-n-переходов. При приложении к нему обратного напряжения обратный ток оказывается больше, чем в р-n-переходе. При прямом смещении р-i- и n-i-переходов прямой ток меньше, чем в р-n-переходе, и незначительно зависит от приложенного напряжения.
На основе p-i и n-i-переходов создают полупроводниковые приборы, допускающие подключение высоких обратных напряжений. В обычном р-n-переходе подключение высокого напряжения может создать в нем настолько высокую напряженность электрического поля, что наступит электрический пробой последнего. Если области р и n разделить высокоомным слоем с собственной электропроводностью, то напряженность поля в переходе существенно снизится при том же значении потенциального барьера. Такой р-i-n-переход будет иметь как бы ступенчатое изменение контактной разности потенциалов и концентрации примесей.
Аналогичная картина получится при контакте двух полупроводников с электропроводностью одного типа, имеющих разную концентрацию примесей. Высота потенциального барьера при этом будет ниже, чем в р-i-переходе, так как разность в положениях уровней Ферми  и
и  будет меньше, чем
будет меньше, чем  и
и  . Эти переходы имеют некоторую асимметрию электропроводности, но практически не обладают вентильными свойствами. Соответственно в них практически отсутствует инжекция неосновных носителей заряда в высокоомную область.
. Эти переходы имеют некоторую асимметрию электропроводности, но практически не обладают вентильными свойствами. Соответственно в них практически отсутствует инжекция неосновных носителей заряда в высокоомную область.
Дата добавления: 2020-10-14; просмотров: 595;











