Транзисторы технологии кремний-на-изоляторе»
6.1. Мотивация КНИ
Технология «кремний-на-изоляторе» (КНИ) рассматривается как естественная преемница объемной технологии (рис. 6.1). Считается, что последовательное развитие технологии КНИ должно привести к достижению предельных характеристик кремниевых КМОП схем.
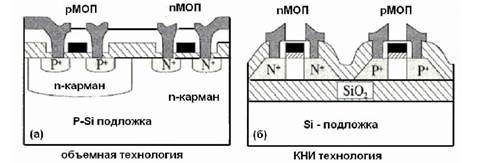
|
Рис. 6.1. Сравнение объемной (а) и КНИ технологии (б)
Исторически МОП транзисторы, изготовленные по технологии «кремний-на-изоляторе» (КНИ МОПТ, международный термин «Silicon-On- Insulator», SOI MOSFET), появились достаточно давно как элементы схем специального применения. Первые КНИ транзисторы имели структуру «кремний-на-сапфире», и их главным достоинством считалось отсутствие радиационно-индуцированных токов в p-n переходах стока и истока. До начала 90-х гг. XX в. КНИ технологии не рассматривались как серьезная альтернатива коммерческой объемной технологии, главным образом, из-за своей дороговизны. Со временем выяснилось, что КНИ МОПТ имеют существенные функциональные преимущества перед транзисторами обычных объемных технологий с неизолированной подложкой.
В настоящее время КНИ структуры активно проникают в коммерческие технологии. Предполагается, что этот процесс будет идти еще быстрее по мере повышения степени интеграции и, в конце концов, КНИ станет доминирующей коммерческой технологией.
Активная область КНИ МОП транзистора, именуемая базой или «телом» (международный термин body), представляет собой тонкую кремниевую пленку между контактами стока и истока, изолированную со всех сторон слоями окислов (см. рис.6.1). Скрытый или «захороненный» окисел (международный термин buried oxide, BOX), в КНИ структурах изолирует активную область прибора от подложки, а вертикальная изоляция (как правило, STI) делает невозможными токи утечки и тиристорный эффект между двумя соседними приборами.
6.2. Преимущества КНИ МОПТ
Транзисторы, изготовленные по технологии КНИ, обладают рядом важных преимуществ над транзисторами объемных технологий с аналогичной проектной нормой.
1. Область стока/истока расположена прямо над скрытым окислом, поэтому изоляция скрытым окислом имеет существенно меньшую емкость, чем изоляция ^«-переходом в объемных транзисторах, что объясняется большей толщиной скрытого окисла и меньшей диэлектрической проницаемостью окисла по сравнению с кремнием. Это дает уменьшение паразитных емкостей (на 30...50%) и соответствующее увеличение быстродействия из-за уменьшения времени задержки.
2. По той же причине, из-за уменьшения паразитной емкости, уменьшается динамическое энергопотребление (приблизительно на 30% при той же тактовой частоте и напряжении питания).
3. Улучшается электростатическое качество транзисторов за счет подавления геометрических короткоканальных эффектов. Повышается (на ~ 15%) плотность интеграции за счет уменьшения расстояния между транзисторами.
4. В КНИ схемах отсутствуют эффекты влияния общей подложки на пороговые напряжения, как это имеет место в схемах объемной КМОП технологии.
5. КНИ транзисторы могут иметь очень малое (близкое к минимальному) значение подпорогового размаха (^-фактор ~ 60мВ/декаду при комнатных температурах), что позволяет снизить пороговое напряжение до 0,3В, не увеличивая статические токи утечки. Соответственно, это позволяет уменьшать напряжения питания и динамическое энергопотребление.
6. Из-за высокой степени изоляции перекрываются пути для развития паразитного тиристорного эффекта (эффекта «защелки»), часто имеющего место в n-p-n-p структурах объемных КМОП технологий.
7. Боковая изоляция (например, изоляция типа «птичий клюв» (LOCOS), мелкими канавками (STI)) дает возможность более компактного расположения элементов и более простой технологии изготовления, поскольку нет необходимости в карманах и глубоких канавках, как это имеет место в объемной технологии.
8. Отсутствуют ионизационные токи в p-n переходах при внешних импульсных ионизационных воздействиях. Поэтому КНИ МОПТ чрезвычайно устойчивы к воздействию импульсной радиации.
6.3. Различные конфигурации КНИ МОПТ
Толщина кремниевой базы КНИ МОПТ может быть различной. Различают КНИ структуры с толстым слоем кремния (dS > 1мкм), которые используются в мощных приборах, и тонкопленочные структуры (dS < 0,2...0,3мкм), используемые в интегральных схемах высокой степени интеграции.
Среди тонкопленочных МОПТ выделяют приборы двух типов: полностью обедненные (ПО) и частично обедненные (ЧО). Подобная классификация основана на сравнении толщины кремниевой базы dS и толщины слоя обеднения xd. Толщина слоя кремния полностью обедненной КНИ МОПТ структуры (международный термин fully depleted SOI, FD SOI MOSFET) обычно не превосходит 50 нм с типичным значением ~ 30 нм. В частично обедненных (ЧО) КНИ структурах (partially depleted SOI, PD SOI) dS > 50 нм с типичными значениями ~ 150...200 нм. Естественным условием полного обеднения является то, что толщина обедненной области больше толщины базы xd > dS. Ясно, что выполнение этого условия зависит от уровня легирования базы. Однако в короткоканальных транзисторах условие полного обеднения зависит еще и от длины канала. Это связано с тем, что боковые обедненные области ^«-переходов сток-подложка и исток-подложка увеличивают обеднение базы, существенно облегчая этот процесс. Это эквивалентно уменьшению эффективного легирования базы, которое позволяет обедненной области распространяться глубже. Чтобы эта глубина соответствовала толщине пленки, требуется увеличить концентрацию примеси в базе.
Критерием, по которому можно различать полностью и частично обедненные КНИ транзисторы, является сравнение максимальной толщины обедненной области в районе истока [ xd (0) = xd (y = 0,ps = 2pF)] и в районе стока
[ (xd (L) = xd (y = L,pS = 2pF + VDS)] с толщиной слоя кремния внутренней подложки
dS. При выполнении условий xd (L) < dS и xd (L) > xd (0) > dS имеем соответственно частично (PD) и полностью обедненные (FD) случаи. В промежуточном случае, когда xd(L) > dS > xd(0), говорят о тaк называемом
динамическом обеднении.
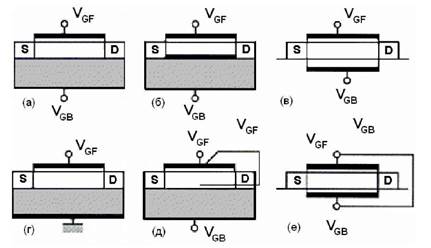 Рис. 6.2. Схематические структуры возможных конструкций КНИ МОПТ: (a) полностью обеденные, (б) транзистор с сильнолегированным дельта-слоем (pulsed doping) в кремниевой пленке, (в) с полевой обкладкой (field plate), (г) с заземленной основой (ground plane, GP), (д) динамический порог, (е) транзистор с двойным затвором.
Рис. 6.2. Схематические структуры возможных конструкций КНИ МОПТ: (a) полностью обеденные, (б) транзистор с сильнолегированным дельта-слоем (pulsed doping) в кремниевой пленке, (в) с полевой обкладкой (field plate), (г) с заземленной основой (ground plane, GP), (д) динамический порог, (е) транзистор с двойным затвором.
|
Существуют различные варианты конфигураций КНИ МОП транзисторов (рис. 6.2), включающие в себя возможность управления напряжением как с верхнего затвора (front gate), так и со стороны подложки (нижнего затвора, back gate).
Для улучшения электростатики и повышения электростатической целостности прибора в структуру прибора можно внедрять сильнолегированные высоко проводящие слои. Они могут быть расположены непосредственно над скрытым окислом либо под ним и играть роль дополнительного управляющего затвора.
6.4. Частично обедненные КНИ МОПТ
В настоящее время наиболее широко распространены КНИ транзисторы с частичным обеднением (ЧО КНИ МОПТ) (рис. 6.3).
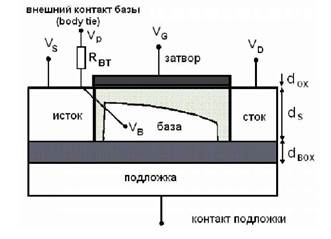
|
Рис. 6.3. Сечение частично обедненного КНИ МОПТ
Это означает, что толщина обедненного слоя xd < dS оказывается меньше толщины кремниевой базы (тела). В этом смысле частично обедненный КНИ МОПТ очень похож на транзистор, изготовленный по объемной технологии, что обеспечивает преемственность и эволюционность технологии.
Главной особенностью, оп качественное отличие КНИ технологий, является изолированность кремниевой базы от контакта подложки, характерная для большинства коммерческих ЧО КНИ технологий. Эта особенность обусловливает то, что потенциал внутренней подложки в КНИ ЧО МОПТ не фиксирован и является плавающим, что может приводить к многочисленным, часто нежелательным эффектам плавающей базы (floating body effects, FBE). Эти эффекты обусловлены зарядом, приходящим и уходящим из базы за счет различных, часто случайных и неконтролируемых механизмов, таких как ионизация пролетающей одиночной частицей, ударная ионизация в сильном электрическом поле вблизи стока, эффекты GIDL, туннелирование через тонкий подзатворный окисел.
База частично обедненного КНИ МОПТ емкостным образом связана со всеми выводами транзистора, что означает увеличение (уменьшение) потенциала базы при увеличении (уменьшении) потенциалов каждого из электродов. Чаще всего база оказывается в прямосмещенном относительно истока режиме, что обусловливает уменьшение эффективного порогового напряжения.
Вследствие FBE текущее значение потенциала базы становится функцией предыдущего электрического состояния прибора. На схемном уровне это приводит к переходным эффектам различного рода и нежелательному разбросу времен распространения сигнала в цепях в зависимости от электрической «предыстории» конкретной цепи. Эффекты предыстории зависят от многих параметров, таких как времена нарастания и спада входного сигнала, нагрузочной емкости, деталей конфигурации и т.п. Разброс времен задержки в одном транзисторе из-за эффектов электрической предыстории может составлять до 8 %.
Эффекты плавающего тела приводят также к нестационарным нестабильностям и гистерезисам выходных и передаточных ВАХ частично обедненных КНИ МОПТ. Для борьбы с нежелательными эффектами плавающей базы иногда используют дополнительный контакт базы, который, как правило, соединяет базу с контактом истока (body tie) и фиксирует ее потенциал. Такая процедура усложняет процесс изготовления и увеличивает эффективные геометрические размеры транзистора.
В частично обедненных КНИ МОПТ, как и в КМОПТ объемных технологий, наблюдаются кинк-эффект и паразитный биполярный эффект.
6.5. Полностью обедненные КНИ МОПТ
В КНИ МОПТ полностью обедненного типа обедненная область занимает всю толщину кремниевого тела и имеет фиксированный заряд. Электростатика таких транзисторов такова, что основные носители (дырки), инжектированные в базу, сразу прижимаются электрическим полем к рп- переходу истока, локально открывают его и быстро рекомбинируют с электронами, поступающими из истока. Поэтому в полностью обедненных приборах практически не происходит накопление основных носителей в базе, и эффекты плавающего потенциала по сравнению с частично обедненными транзисторами практически отсутствуют.
Контакт подложки в полностью обедненном КНИ транзисторе можно рассматривать как своеобразный нижний затвор (back gate, BG), который можно использовать для юстировки порогового напряжения основного канала от верхнего затвора (front gate, FG) (рис. 6.4). Это объясняется тем, что полное обеднение означает отсутствие квазинейтральной области в базе КНИ транзистора. Поэтому в полностью обедненном КНИ транзисторе силовые электрические линии от верхнего затвора могут достигать нижнего затвора. Поверхностные потенциалы на двух границах раздела оказываются, таким образом, электрически
Рис. 6.4. Схематичная структура МОП транзистора КНИ структуры с заземленной подложкой.
связанными друг с другом. Это приводит к тому, что результаты измерения при изменении напряжения на верхнем затворе зависят от напряжения на нижнем затворе. Модели транзисторов с полным обеднением должны учитывать электростатическую связь двух затворов.
Прикладывая напряжение на верхний затвор (VGF) либо на нижний затвор (VGb), инверсионный слой в КНИ транзисторе можно получить как на границе раздела кремния с тонким подзатворным окислом, так и на границе раздела с толстым скрытым окислом.
Так же, как и в МОПТ объемной технологии, пороговое напряжение в полностью обедненных КНИ МОПТ может управляться напряжением на нижнем затворе (подложке). Напряжение на нижний затвор подается относительно заземленного истока, причем, в отличие от объемного МОПТ, диэлектрическая изоляция позволяет любую полярность напряжения. Например, прикладывая положительное смещение на нижний затвор VGB, мы создаем на нижней границе режим инверсии и образуем нижний канал, что как легко понять из соображений электронейтральности, уменьшает пороговое напряжение для верхнего транзистора VTF . Напротив, аккумуляция основных носителей в базе на нижней границе раздела приводит к увеличению порогового напряжения VTF .
В полностью обедненных КНИ МОПТ ограничены возможности управлять пороговым напряжением с помощью легирования подложки (мала толщина подложки, нет возможности использовать ретроградное или 8 - легирование) и поэтому в них желательно иметь металлические затворы с возможностью контролируемого изменения работы выхода.
6.6. Ультратонкие КНИ МОПТ
Уменьшение толщины кремниевого тела КНИ МОПТ (конечно, речь здесь идет только о полностью обедненных приборах) приводит к уменьшению подпорогового размаха (S-фактора) и соответственно, к уменьшению подпороговых токов утечки вследствие уменьшения емкости обедненного слоя (рис. 6.5).
С другой стороны, подвижность носителей в канале с уменьшением толщины кремневой пленки заметно падает. Это объясняется тем, что в очень тонких базах толщина кремниевой пленки становится сопоставимой с
Рис. 6.5. Подпороговые токи утечки для ультратонких КНИ МОПТ с разной толщиной базы
толщиной инверсионного слоя (порядка нескольких нанометров), то есть по существу в базе происходит объемная инверсия. Это означает, что на транспорт носителей в канале начинает влиять дополнительный механизм рассеяния на шероховатостях границы раздела со скрытым окислом. Другим источником деградации подвижности в канале КНИ транзисторов с ультратонкими базами является технологическое загрязнение кремниевой пленки неконтролируемыми примесями при изготовлении. Более того, для транзисторов с малым объемом активной области даже случайные флуктуации количества атомов легирующей примеси в базе могут приводить к недопустимому разбросу индивидуальных значений порогового напряжения и проводимости, а также уменьшению подвижности в отдельном транзисторе. По этим причинам база полностью обедненного КНИ транзистора в идеале должна быть вообще не легирована примесями, что технологически является трудновыполнимой задачей.
6.7. Сравнение полностью и частично обедненных КНИ МОПТ

|
Традиционно считается, что наиболее перспективными являются КНИ структуры с полным обеднением. Такая технология обеспечивает наилучшие характеристики приборов (отсутствие эффектов плавающего тела, более крутой подпороговый наклон, минимизация короткоканальных эффектов и паразитных емкостей) и считается наиболее приемлемой в диапазоне длин канала менее 100 нм. Тем не менее, полностью обедненные КНИ МОПТ существенно менее технологичны и более трудны для изготовления.
Например, пороговое напряжение ПО КНИ МОПТ очень чувствительно к толщине кремниевой базы, а поддержание постоянства толщины базы является трудной технологической задачей.
Преимущество полностью обедненных приборов над частично обедненными в части электростатического качества и отсутствия короткоканальных эффектов также не столь бесспорно. Например, из-за отсутствия квазинейтральной области в полностью обедненных КНИ МОПТ существует электростатическая связь стока с затвором через скрытый окисел
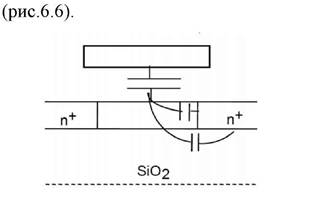
|
| Рис.6.6.Электрическая связь стока с затвором через скрытый окисел в ПО КНИ МОПТ |
Это обстоятельство ухудшает электростатическое качество МОПТ полностью обедненного типа и усиливает короткоканальные эффекты.
В настоящее время развитие технологий частичного и полного обеднения идет параллельными курсами. Фирма IBM поддерживает технологии частичного обеднения, фирма Intel развивает технологии с полным обеднением. ЧО КНИ МОПТ в настоящее время используются для изготовления высокопроизводительных микропроцессоров. ПО КНИ МОПТ имеют неоспоримые преимущества при масштабировании.
Преимущества и недостатки ПО и ЧО КНИ МОПТ сведены в таблицу
6.1.
Таблица 6.1 Преимущества и недостатки частично и полностью
обедненных КНИ МОПТ
|
6.8. Масштабирование КНИ МОПТ
6.8.1 Короткоканальные эффекты
В объемных МОПТ уменьшение коротканальных эффектов требует формирования тонких переходов сток/исток-подложка и увеличения концентрации примеси в подложке, которое вызывает уменьшение подвижности и рост паразитных емкостей. Преимущество КНИ МОПТ заключается в том, что масштабированием прибора можно полностью управлять изменением толщины пленки.
DIBL -эффект и влияние стока на распределение электрического поля под затвором присутствуют как в объемных, так и в КНИ МОПТ. Однако в КНИ МОПТ они лучше контролируются уменьшением толщины пленки.
Главный короткоканальный эффект в КНИ заключается в проникновении электрического поля от стока в скрытый окисел и подложку (рис. 6.6). Проникающее поле приводит к увеличению поверхностного потенциала на границе пленки со скрытым окислом точно так же, как действовало бы обратное смещение на нижнем затворе - индуцированное стоком виртуальное смещение подложки (DIVSB - drain-induced virtual substrate biasing). Так как имеется электрическая связь между верхним и нижним поверхностными потенциалами, свойства верхнего канала изменяются. В частности, пороговое напряжение уменьшается при увеличении потенциала стока как при DIBL, хотя DIVSB - совершенно другой механизм.
 Толщина пленки ^,нм
Толщина пленки ^,нм
|
Рис. 6.7 иллюстрирует стратегию масштабирования КНИ. Из сравнения уменьшения порогового напряжения AVT для легированной и нелегированной пленок можно заключить, что толстая нелегированная пленка очевидно непригодна. Но для 15 нм толщины пленки величина AVT становится приемлемой, и влияние легирования исчезает. Это означает, что нелегированный и ультратонкий КНИ МОПТ исключительно устойчив к короткоканальным эффектам. Кроме того, его преимуществами является высокая подвижность носителей и почти идеальный подпороговый наклон.
Рис. 6.7 Уменьшение порогового напряжения,
вызываемое эффектами DIVSB и DIBL для пленок различной толщины и концентрации примеси (длина канала L = 0,1 мкм).
Другой способ противостоять проникновению поля в окисел и подложку состоит в модификации архитектуры транзистора: более тонкий скрытый окисел с меньшей диэлектрической проницаемостью, структура с двойным затвором или создание высоколегированной области или металлического слоя ниже окисла.
Рассмотрение электростатики при масштабировании показывает, что минимальная длина канала пропорциональна толщине пленки: Lmm « 4dS. Из
этого правила следует, что для надлежащим образом масштабированного КНИ МОПТ с длиной канала 10 нм требуется пленка тоньше 3 нм. Сообщалось в литературе о моделировании транзистора с приемлемыми характеристиками с длиной канала 2,5 нм на пленке толщиной 1 нм. Практически уже изготовлены лабораторные образцы КНИ МОПТ с длиной канала 6 нм.
6.8.2 Эффекты узкого канала
На краях затвора (боковой стенки) создается паразитный канал, так как затвор по-разному контролирует главный канал (центральная часть) и края. Влияние боковой стенки канала более выражено в узких приборах. Если пороговое напряжение меньше на краях, VT падает при уменьшении ширины затвора (обратный узкоканальный эффект). Заметим, что паразитная проводимость обычно подавляется более сильным легированием краев для локального увеличения порогового напряжения, однако для ультратонких пленок такое решение неприменимо.
В зависимости от используемой изоляции (STI, LOCOS) боковая стенка может иметь другую кристаллическую ориентацию, дополнительные дефекты и переменную толщину. В целом, при уменьшении ширины канала деградируют подвижность и S-фактор, в то время как короткоканальные эффекты мало изменяются.
Эффект плавающей подложки (FBE) стремится к нулю в узких КНИ МОПТ. Причины этого: а - деградация (уменьшение) времени жизни вблизи боковой стенки; б - диффузия примеси в изолирующий окисел, которая приводит к уменьшению потенциального барьера сток- подложка; в - локальное утоньшение пленки на краях.
В экстремально узких приборах квантовые ограничения приводят к заметному увеличению порогового напряжения при ширине канала менее 10 нм.
Толщина пленки
Толщина пленки определяет способность КНИ МОПТ противостоять короткоканальным эффектам. Толщина пленки может достигать толщины нескольких монослоев кремния. В ультратонких приборах эффект электрической связи затворов усиливается.
На рис. 6.8 представлены зависимости пороговых напряжений для верхнего и нижнего затворов от напряжения на противоположном затворе.
Точка пересечения кривых на рис.6.8 определяет уникальную связь между нижним и верхним затворами, при которой оба канала инвертируются одновременно. Эти значения напряжений можно использовать для получения идеальной сбалансированной работы даже при использовании асимметричного МОПТ, так как при этом компенсируется разница в толщине верхнего и скрытого окислов:
| d |
| ox 2 |
V - V =
уG2 rT2

|
| d |
| ox1 |
| Рис.6.8. Зависимость порогового напряжения верхнего (нижнего) канала от напряжения на нижнем (верхнем) затворе для КНИ МОПТ с пленкой 47 нм толщины (L = 10мкм, W = 10мкм). Пунктирная линия показывает суперпозицию двух кривых в ультратонком транзисторе. |
(VG1 VT1 ) .
Для ультратонких пленок (<10нм) две кривые на рис.6.8 имеют тенденцию совпасть. Это означает, что для произвольного напряжения на нижнем затворе VG 2 в нижнем канале достигается пороговое напряжение VT 2, как только верхний затвор смещается до напряжения VG1 = VT1: то есть как только один канал достигает сильной инверсии, второй канал также
переходит в инверсию (суперсвязь). Пленка ведет себя как 86 квазипрямоугольный тоннель, потенциал внутри пленки следует сигналу, приложенному к любому из затворов.
Объемная инверсия
При одновременной активации верхнего и нижнего каналов возникает объемная инверсия: инверсионный заряд целиком заполняет тело тонкой пленки, а его максимум локализуется внутри пленки (рис.6.9). Так как теперь неосновные носители (электроны) движутся в основном вдали от поверхностей раздела, подвижность возрастает.
 О 12 3
Depth in silicon (nm)
О 12 3
Depth in silicon (nm)
|
Объемная инверсия может возникать и в однозатворных транзисторах с ультратонкими пленками. В многозатворных приборах она является основным механизмом, обеспечивая увеличение тока стока и выходного сопротивления и ослабляя влияние дефектов на границах раздела (ловушки, фиксированный заряд, шероховатости поверхности) и уменьшая 1f шум.
Рис.6.9 Распределение электронов в 3нм пленке КНИ МОПТ в режиме объемной инверсии.
6.9. Технологии многозатворных МОПТ
Технология КНИ является естественным шагом для перехода от чисто планарного принципа интеграции к объемной (3D) интеграции. Одна из главных целей объемной интеграции - подавление геометрических короткоканальных эффектов - реализуется в технологиях многозатворных МОПТ. На рис. 6.10 изображены несколько перспективных многозатворных конфигураций МОПТ.
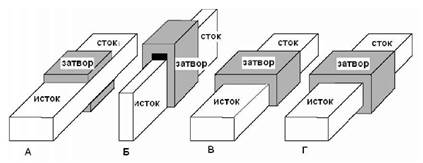 Рис. 6.10. Структуры КНИ многозатворных (multiple gate) транзисторов: (А) планарный транзистор с двойным затвором (double-gate -DG); (Б) FinFET; (В) тройной (П-затвор); (Г) круговой затвор
Рис. 6.10. Структуры КНИ многозатворных (multiple gate) транзисторов: (А) планарный транзистор с двойным затвором (double-gate -DG); (Б) FinFET; (В) тройной (П-затвор); (Г) круговой затвор
|
Особенностью таких структур является высокое электростатическое качество и высокая степень управляемости зарядом в канале. Идеальным в этом смысле является транзистор с круговым затвором, он же является наиболее сложным технологически. Транзисторы с тройным (П-образным или Q-образным) затвором и так называемый FinFET (от английского слова fin - рыбий плавник) вполне совместимы с уже существующей технологией изготовления и уже частично реализованы в 45 нм технологии Intel (2007).
Транзистор с горизонтальным двойным затвором (DG) является самым
перспективным в смысле компромисса между электростатическим качеством,
а также степенью интеграции и сложностью изготовления. В нем может
реализовываться не только режим работы с двумя каналами, но и режим
объемной инверсии. У него больше ток, подпороговый наклон близок к
60мВ/декаду, носители, текущие в середине пленки, испытывают меньшее
рассеяние. Поэтому подвижность и радиационная стойкость улучшаются, а
низкочастотный шум уменьшается. Короткоканальные эффекты (DIBL,
DIVSB, прокол) сокращаются, следовательно, минимальная длина канала у
DG транзисторов меньше, чем у однозатворных (SG -single gate) приборов.
Численное моделирование, включающее квантоворазмерные эффекты,
туннелирование зона-зона и прямое туннелирование исток-сток, дает
приемлемые характеристики даже для DG транзисторов с длиной канала
2...8 нм. При этом рекомендуемое отношение толщины пленки к длине 88
канала для DG транзисторов составляет 1/2, в противоположность SG транзисторам (1/4). DG транзистор реализуется на основе традиционной планарной технологии, однако существуют значительные трудности с совмещением верхнего и нижнего затворов.
Зададимся вопросом: всякие ли альтернативные структуры к планарным объемным структурам МОПТ могут использоваться для масштабирования КМОПТ в суб-10нм область длин затвора? Чтобы ответить на этот вопрос, полезно рассмотреть требования (перечисленные в порядке их важности), предъявляемые к «совершенному» МОПТ:
1. Невосприимчивость к случайным флуктуациям примеси (random dopant fluctuation, RDF).
2. Электростатическое качество выше, чем у планарных объемных МОПТ.
3. Относительная простота изготовления.
4. Возможность динамической регулировки порогового напряжения.
5. Эффективность топологического размещения элементов такая же или лучше, чем у планарных объемных МОПТ.
Для удовлетворении первого требования концентрация примеси в канале должна быть низкой. Для выполнении второго требования необходимы многозатворные транзисторы. Для реализации третьего требования необходимо избегать суб-5нм толщины канала или высокого аспектового отношения топологических элементов (например, «плавников» с отношением высоты к ширине больше 3). Чтобы исполнить четвертое требование, необходим нижний затвор ^G MOSFET) или непосредственный контакт к базе. Хотя пятое требование не является критическим, оно благоприятствует транзисторным структурам, которые обеспечивают большую ширину канала на шаг металлизации. Из всех транзисторов с тонкой базой только планарные ВG MOSFET (с соответствующим смещением нижнего затвора) могут удовлетворить всем этим требованиям. Практическое изготовление ВG MOSFET определяется стоимостью КНИ подложек с очень тонким (<10нм) и однородным скрытым слоем.
Другой путь продолжения масштабирования КМОПТ заключается в эволюции традиционного планарного объемного МОПТ в многозатворную структуру - трехзатворный объемный МОПТ (TG bulk MOSFET). Этого можно достигнуть сегментированием области канала на параллельные полоски равной ширины и «обертывания» электрода затвора вокруг верхней части каждой полоски, как показано на рис. 6.11.
 Рис. 6.11.Схематическая диаграмма, иллюстрирующая трехзатворный объемный w-канальный МОПТ (TG bulk MOSFET)
Рис. 6.11.Схематическая диаграмма, иллюстрирующая трехзатворный объемный w-канальный МОПТ (TG bulk MOSFET)
|
На практике такая рифленая структура затвора может быть достигнута путем создания канавок в изоляции в промежутках между полосками до формирования затвора, как это делается при создании finFET. Для подавления подпороговых утечек и ослабления вариации порогового напряжения вследствие RDF должно использоваться суперступенчатое ретроградное легирование, локализованное в базе под полосками затвора. Так как затвор окружает канал, величина заряда ОПЗ под затвором на единицу ширины канала меньше, чем в планарном приборе, так что вариации порогового напряжения вследствие RDF уменьшаются.
Использование TG bulk MOSFET позволяет достичь более высокого электростатического качества, чем у TG SOI MOSFET, так как исключается проникновение электрического поля сквозь скрытый окисел.
Важно заметить, что изготовление TG bulk MOSFET обеспечивает более низкое паразитное сопротивление стока и истока (RSD), чем у MOSFET с тонкой базой, так как не требуется ни ультратонкая (UTB) пленка кремния, ни очень узкий плавник. По сравнению с планарными объемными MOSFET обеспечивается большая площадь поверхности стока и истока относительно 90 поверхности канала и, следовательно, меньшее RSD без значительного увеличения паразитной ёмкости затвора (вследствие того, что VSTI изоляция в промежутках между полосками значительно толще, чем толщина подзатворного окисла). Это является значительным преимуществом TG bulk MOSFET, так как паразитные сопротивление и емкость все больше и больше ограничивают параметры транзистора. Исключение UTB пленки кремния или очень узких плавников также очень полезно для подавления вариаций токов в открытом и закрытом состояниях вследствие эффектов RDF.
Таким образом, преимуществами многозатворных МОПТ являются:
• подавление геометрических короткоканальных эффектов;
• малый статический ток утечки и динамическое потребление;
• высокое отношение токов в открытом и закрытом состояниях ION / IOFF;
• совместимость с существующими технологиями изготовления;
• потенциально очень высокая степень интеграции (менее 10 нм).
Тем не менее, следует подчеркнуть, что многозатворные непланарные (3D) технологии являются технологиями скорее будущего, чем настоящего.
| <== предыдущая лекция | | | следующая лекция ==> |
| Основные архитектурно-конструктивное решение. | | | История развития химических методов анализа в криминалистике |
Дата добавления: 2016-05-30; просмотров: 7182;











