Остальные энергетические уровни и зоны должны соответственно изогнуться, т. е. в гетеропереходе возникают диффузионное поле и контактная разность потенциалов.
При этом энергетический потолок верхней свободной зоны должен быть непрерывным. Энергетический уровень потолка верхней свободной зоны является энергетическим уровнем потолка зоны проводимости, т. к. свободные энергетические зоны перекрывают друг друга.
Ширина энергетических зон различных полупроводников различна. Поэтому на границе раздела двух полупроводников получается обычно разрыв дна проводимости. Разрыв дна зоны проводимости определяется различием энергий сродства к электрону двух контактирующих полупроводников
(энергия сродства к электрону – разница энергий потолка верхней свободной зоны и дна проводимости).
В результате разрывов дна зоны проводимости и потолка валентной зоны высота потенциальных барьеров для электронов и дырок в гетеропереходе оказывается различной. Это является особенностью гетеропереходов, обусловливающей специфические свойства гетеропереходов в отличие p-n-переходов, которые формируются в монокристалле одного полупроводника.
Если вблизи границы раздела двух полупроводников, образующих гетеропереход, возникают обедненные основными носителями слои, то основная часть внешнего напряжения, приложенного к структуре с гетеропереходом, будет падать на обедненных слоях.
Высота потенциального барьера для основных носителей заряда будет изменяться: уменьшается при полярности внешнего напряжения, противоположной полярности контактной разности потенциалов, и увеличивается при совпадении полярностей внешнего напряжения и контактной разности потенциалов. Таким образом, гетеропереходы могут обладать выпрямляющим свойством.
Из-за различия по высоте потенциальных барьеров для электронов (ПБЭ) и дырок (ПБД) прямой ток через гетеропереход связан в основном с движением носителей заряда только одного знака. Поэтому гетеропереходы могут быть как инжектирующими неосновные носителя заряда (рис. 7.13, а), так и неинжектирущими (рис. 7.13, б). Инжекция неосновных носителей заряда происходит всегда из широкозонного в узкозонный полупроводник. В гетеропереходах, образованных полупроводниками одного типа электропроводности, выпрямление происходит без инжекции неосновных носителей заряда.
7.13.Структура металл-диэлектрик-полупроводник. Вольт-фарадные характеристики.
Металл - диэлектрик - полупроводник - структура, образованная пластиной полупроводника П, слоем диэлектрика Д на одной из её поверхностей и металлич. электродом (затвором M, рис. 7.14).
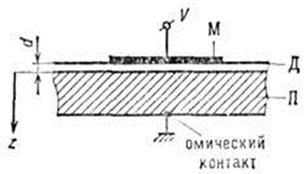
Рис 7.14
При подаче на МДП-с. напряжения V в полупроводнике вблизи границы с диэлектриком возникает электрическое поле. Оно перераспределяет заряды в полупроводнике, изменяя концентрацию носителей заряда вблизи поверхности, и, следовательно, изменяет электропроводность приповерхностного слоя полупроводниковой пластины. Свойства МДП-с. впервые исследовали амер. физики У. Шокли (W. Shockley) и Дж. Л. Пирсон (G. L. Pearson).
Энергетич. диаграмма МДП-структуры изображена на рис.7.15 с полупроводником n-типа. . Заштрихованы состояния, занимаемые электронами при T= 0 K; F - работа выхода металла;  - энергия электрона в вакууме;
- энергия электрона в вакууме;  - потолок валентной зоны;
- потолок валентной зоны;  - дно зоны проводимости;
- дно зоны проводимости;  - уровень Ферми;
- уровень Ферми;  - ширина запрещённой зоны полупроводника
- ширина запрещённой зоны полупроводника
При  зоны не изогнуты. Если
зоны не изогнуты. Если  , то возникает изгиб зон; здесь возможны три случая. Если
, то возникает изгиб зон; здесь возможны три случая. Если  то изгиб зон "вверх" (рис. 7.15,а) приводит к увеличению числа дырок у поверхности полупроводника, т. к. их концентрация
то изгиб зон "вверх" (рис. 7.15,а) приводит к увеличению числа дырок у поверхности полупроводника, т. к. их концентрация  (T - температуpa). Вблизи поверхности полупроводника формируется слой, обогащённый осн. носителями (см. Контактные явления в полупроводниках). При
(T - температуpa). Вблизи поверхности полупроводника формируется слой, обогащённый осн. носителями (см. Контактные явления в полупроводниках). При  зоны изгибаются "вниз" (рис. 7.15, б )и в приповерхностной области уменьшается число основных носителей (обеднённый слой). При дальнейшем увеличении положит, напряжения зоны изгибаются столь сильно, что середина запрещённой зоны вблизи поверхности опускается ниже
зоны изгибаются "вниз" (рис. 7.15, б )и в приповерхностной области уменьшается число основных носителей (обеднённый слой). При дальнейшем увеличении положит, напряжения зоны изгибаются столь сильно, что середина запрещённой зоны вблизи поверхности опускается ниже  (рис. 7.15, в). С этого момента концентрация электронов превышает концентрацию дырок
(рис. 7.15, в). С этого момента концентрация электронов превышает концентрацию дырок 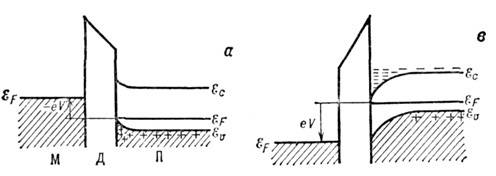

Рис. 7.15. Энергетическая диаграмма МДП-структуры на основе полупроводника n-типа при V< 0 (а), V> 0 (б), V >0 и  ( в).
( в).
Слой пространственного заряда в МДП-структуре.Характеристикой изгиба зон служит электростатпч. потенциал  , который изменяется от 0 в объёме полупроводника до значения
, который изменяется от 0 в объёме полупроводника до значения  на его поверхности
на его поверхности  . При высоких температурах и слабой инверсии концентрация электронов и дырок в слое экспоненциально зависит от
. При высоких температурах и слабой инверсии концентрация электронов и дырок в слое экспоненциально зависит от  :
:
 (7.18)
(7.18)
где  - равновесные концентрации электронов и дырок в объёме полупроводника. При сильной инверсии и понижении температуры в инверсионном слое возникает вырождение газа электронов (или дырок).
- равновесные концентрации электронов и дырок в объёме полупроводника. При сильной инверсии и понижении температуры в инверсионном слое возникает вырождение газа электронов (или дырок).
Ёмкость МДП-структуры. Из условия электронейтральности МДП-с. следует, что заряд на металлическом затворе Q равен сумме заряда в инверсионном слое  и заряда ионизованных акцепторов и доноров в обеднённом слое полупроводника
и заряда ионизованных акцепторов и доноров в обеднённом слое полупроводника
 (7.19)
(7.19)
Здесь W - толщина обеднённого слоя, Na и N' д - концентрации соответственно акцепторов и доноров в объёме полупроводника, е- элементарный заряд.
Полное напряжение V, приложенное к МДП-с., распределяется между слоем диэлектрика и слоем пространственного заряда в полупроводнике; МДП-с. можно рассматривать как последовательное соединение 2 конденсаторов. Дифференциальная ёмкость на единицу площади  определяется соотношением
определяется соотношением

где  -ёмкость диэлектрика,
-ёмкость диэлектрика,  - дифференциальная ёмкость полупроводника.
- дифференциальная ёмкость полупроводника.
Дата добавления: 2017-01-26; просмотров: 1518;











