И ВОЛОКОННЫЕ ЛАЗЕРЫ
ПОЛУПРОВОДНИКОВЫЕ
Полупроводниковый лазер отличается тем, что в полупроводниковой среде нет смысла говорить о переходах между энергетическими уровнями отдельных частиц (атомов, молекул, ионов), как это имеет место в других активных средах. Инверсия здесь создается на переходах между состояниями в энергетических зонах полупроводникового кристалла. Эти зоны возникают из-за расщепления уровней энергии валентных электронов атомов, составляющих кристаллическую решетку, в сильном периодическом по пространству поле собственных атомов кристалла.
Поскольку на фоне движения электронов перемещение ядер атомов, составляющих кристаллическую решетку, является малым параметром, уравнение Шредингера для электронов в решетке можно решать в приближении Борна-Оппенгеймера, которое допускает факторизацию волновой функции:
 |
 (9.1)
(9.1)
Здесь волновая функция ядер Φz определяется усредненным движением электронов, а волновая функция электронов Ψe зависит от мгновенного положения ядер. Точность, с которой определяется энергия электрона в приближении Борна-Оппенгеймера, не хуже  , где m и M ― масса электрона и ядра соответственно. Легко видеть, что для ядер тех элементов, которые чаще всего составляют кристаллическую решетку полупроводника (галлий, германий, алюминий, мышьяк) это отношение достаточно мало, чтобы не принимать во внимание поправки к значениям энергии, вызываемые откло
, где m и M ― масса электрона и ядра соответственно. Легко видеть, что для ядер тех элементов, которые чаще всего составляют кристаллическую решетку полупроводника (галлий, германий, алюминий, мышьяк) это отношение достаточно мало, чтобы не принимать во внимание поправки к значениям энергии, вызываемые откло
 |
нениями от приближения Борна-Оппенгеймера.
 |
Движение электрона в кристалле зависит, вообще говоря, от состояния движения всех остальных электронов, но, поскольку оно само влияет на это состояние, можно заменить заведомо не решаемое уравнение Шредингера для системы взаимодействующих электронов системой уравнений для одного электрона, движущегося в самосогласованном поле (приближение Хартри-Фока) [1].
 |
Такое рассмотрение позволяет представить себе электроны в кристалле как идеальный газ. Но импульс такого «квазисвободного электрона» не совпадает с импульсом электрона, движущегося в вакууме, поскольку потенциальная энергия в кристалле является периодической функцией координат, или обладает трансляционной симметрией. Решение уравнения Шредингера в одноэлектронном приближении для такого случая представляет собой волну Блоха:
 (9.2)
(9.2)
где k ― волновой вектор, φk(r) ― периодическая функция координат:
 , (9.3)
, (9.3)
 |
 ― постоянный вектор трансляции.
― постоянный вектор трансляции.
При наличии трансляционной симметрии нельзя говорить о сохранении импульса электрона. Приходится вводить отличную от импульса  физическую величину (квазиимпульс
физическую величину (квазиимпульс  ), сохранение которой означает коммутацию ее оператора с гамильтонианом
), сохранение которой означает коммутацию ее оператора с гамильтонианом  . Это, кроме всего прочего, значит, что энергия, являющаяся функцией волнового вектора, является также и функцией квазиимпульса, поскольку собственные функции коммутирующих операторов совпадают:
. Это, кроме всего прочего, значит, что энергия, являющаяся функцией волнового вектора, является также и функцией квазиимпульса, поскольку собственные функции коммутирующих операторов совпадают:
 (9.4)
(9.4)
Согласно принципу соответствия, импульс и квазиимпульс должны быть тождественны при U→const. Оператор квазиимпульса можно записать в виде [1]:
 ,
,
где φk(r) ― амплитуда волны Блоха (9.3).
Поскольку энергия является функцией квазиимпульса и волнового вектора, уравнение
Е( )=const
)=const
определяет в пространстве квазиимпульсов поверхность, экстремумы которой определяются трансляционной симметрией решетки.
В кристалле нет смысла говорить о принадлежности электронов отдельному ядру (узлу решетки), движение их возможно только в пределах разрешенных энергетических зон.
В наивысшей разрешенной зоне (зоне проводимости) движение электронов можно рассматривать как поступательное, а всю совокупность электронов, энергия которых соответствует зоне проводимости — как электронный газ. Полупроводник, как известно, характеризуется тем, что в зоне проводимости электронов сравнительно мало, из-за наличия промежутка между зоной проводимости и нижележащей валентной зоной, называемого запрещенной зоной (DEg). Если в металлах при нормальных (комнатных ) температурах DEg << kбT, то каждый атом решетки потерял не менее одного электрона, и концентрация электронов слабо зависит от температуры (второй электрон вырывать из атома можно только при высоких температурах). В полупроводниках же наличие запрещенной зоны DEg ³ kбT приводит, во-первых, к тому, что далеко не каждый атом теряет электрон, а во-вторых, к сильной зависимости концентрации электронов проводимости от температуры.
Но проводимоcть полупроводников определяется не только электронами в зоне проводимоcти, а еще и дырками в валентной зоне. Каждый переход электрона через запрещенную зону DEg сопровождается появлением дырки. В состоянии термодинамического равновесия, тем самым, полупроводник не проявляет особо интересных свойств, если не считать сильной зависимости проводимости от температуры. Если же с помощью некоторого внешнего фактора (накачки) создать избыточные по отношению к равновесным носители заряда (электроны или дырки или те и другие вместе), то возвращение к равновесию, то есть рекомбинация носителей, может происходить излучательным путем: энергия, затраченная ранее на генерацию пары дырка-электрон, излучается в виде фотона (см. рисунок 9.1):
|
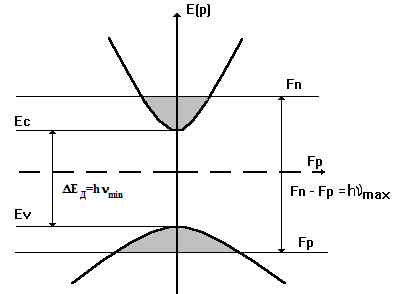
Наиболее благоприятны условия для излучательных переходов зона-зона в прямозонных полупроводниках, т.е. таких, которые характеризуются совпадением максимума потенциальной кривой Е(  ) для дырок и минимума Е(
) для дырок и минимума Е(  ) для электронов, т.е. экстремумы энергии в разрешенных зонах достигаются при одном и том же значении квазиимпульса.
) для электронов, т.е. экстремумы энергии в разрешенных зонах достигаются при одном и том же значении квазиимпульса.
Большая вероятность излучательных переходов в прямозонных полупроводниках наряду с обычной для твердотельных активных сред высокой концентрацией активных частиц (в данном случае центров рекомбинации) позволяет получать исключительно высокие коэффициенты усиления — до 104 см-1. Для сравнения: в газовых лазерах на смеси неона с гелием большим считается усиление 20 см-1, достигаемое при определенных условиях на переходе 3s2 – 3p4 Ne (l = 3,3913 мкм).
Рассмотрим несколько подробнее основной механизм излучательной рекомбинации [2]. В условиях термодинамического равновесия концентрация электронов в зоне проводимости и дырок в валентной зоне описывается распределением Ферми:
f(E) = ( exp [(E - F) / kбT + 1] ) –1 (9.5)
Здесь F — энергия Ферми, имеющая смысл границы между в основном заполненными и в основном пустыми электронными состояниями. Уровень Ферми F в равновесном состоянии и при отсутствии примесей располагается посредине запрещенной зоны (см. рис. 9.1).
При излучательной рекомбинации полное число актов излучения пропорционально произведению концентраций электронов n и дырок p. При небольших концентрациях этот канал рекомбинации не играет заметной роли. Однако при больших концентрациях (более 1017 см-3) он начинает преобладать.
Выделим в спектре электронных состояний два уровня с энергией Е2 в зоне проводимости и Е1 в валентной зоне. Скорость излучательной рекомбинации на переходе Е2 ® Е1, имеющая смысл коэффициента Эйнштейна для спонтанного излучения, может быть представлена в виде:
A = A0 f(E2)[1 – f(E1)] (9.6)
где A0 — коэффициент пропорциональности. Соответственно, коэффициент Эйнштейна для вынужденного излучения представим в виде:
В = В2 f(E2)[1 – f(E1)] – В1 f(E1)[1 – f(E2)] (9.7)
Сообразно смыслу А и В равновесное число фотонов в некоторой излучательной моде  подчиняется соотношению:
подчиняется соотношению:
–  = A/B (9.8)
= A/B (9.8)
Знак минус означает, что рождение фотона соответствует гибели электронно-дырочной пары. Но фотоны подчиняются статистике Бозе-Эйнштейна:
 = 2(exp [hn / kбТ] – 1)-1 (9.9)
= 2(exp [hn / kбТ] – 1)-1 (9.9)
Подставляя (9.9) в (9.8) с учетом (9.6) и (9.7) , получим:
exp [hn/kбТ] – 1 = 2 [В2/ A0]( [B1/ B2] exp [E2 – E1/kбT] – 1 ) (9.10)
Поскольку мы считаем, что фотоны с энергией hn являются результатом прямозонной излучательной рекомбинации с уровня Е2 на уровень Е1, можно положить hn = E2 – E1 . Тогда (9.10) превращается в тождество, если только В2=В1 – А0 /2. Это значит, что:
В = А0 /2 [f(E2) – f(E1)] (9.11)
Из (9.11) видно, что для создания инверсии (В>0) необходимо, чтобы f(E2) > f(E1), что возможно только при нарушении термодинамического равновесия.
Но что это означает? Это означает, что появление носителей в зонах должно быть обусловлено обязательно отличным от теплового способом, то есть носители должны быть принципиально неравновесными (избыточными). Акт, приводящий к появлению избыточных носителей в разрешенных зонах, называется инжекцией. Время жизни инжектированных носителей, или время установления термодинамического равновесия после акта инжекции, составляет 10-8 – 10-9 с. Это время иначе называют временем межзонной термализации. В течение времени, малого по сравнению со временем межзонной термализации, можно рассматривать электронный и дырочный газы по отдельности в квазиравновесных состояниях и вводить для каждого из них свой уровень Ферми (квазиуровни Ферми Fn и Fp). Правомерность такого рассмотрения оправдана тем, что инжектированные носители в зонах очень быстро (за время порядка 10-13 сек) приходят в квазиравновесное состояние (внутризонная термализация) с распределением типа Ферми [3].
Используя обозначения квазиуровней Ферми Fn и Fp, можно записать (9.11) в виде (см. рисунок 9.1):
Fn – Fp >DEg (9.12)
Условие (9.12) означает, что накачка, создающая неравновесные носители, должна быть достаточно сильной для того, чтобы квазиуровни Ферми оказались внутри соответствующих разрешенных зон. Иначе говоря, для получения инверсии необходимо вырождение электронно-дырочного газа. При этом, очевидно, все уровни с энергиями Е1>Fр в валентной зоне и Е2<Fn в зоне проводимости заселены. Это значит, что фотоны с энергиями в интервале
DЕg < hn <Fn – Fp (9.13)

определяют ширину полосы усиления.
Квантовый выход излучательной рекомбинации (т.е. процент превращения в фотоны неравновесных электронно-дырочных пар) может быть сделан близким к 1. Поэтому среди всех типов активных сред полупроводниковые среды дают наивысший КПД.
Наиболее распространенным способом инжекции носителей является пропускание тока через p-n переход полупроводникового диода. Вблизи p-n перехода зонная структура сильно искажена (см. рисунок 9.2а). Это искажение зонной структуры, сопровождающее установление равновесия в области p-n перехода, тем сильнее, чем выше концентрация примесей.
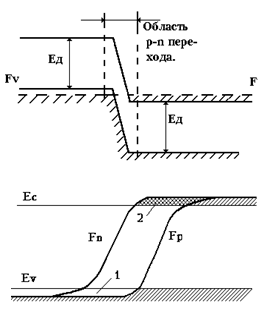
а).
б).
Рис. 9.2. Зонная структура сильно легированного полупроводника
вблизи p-n перехода в равновесии (а) и при инжекции (б).
При пропускании значительного тока через p-n переход в прямом направлении зонная структура несколько «выпрямляется», и вблизи p-n перехода образуется квазинейтральная область повышенной проводимости (рисунок 9.2б). Если U — приложенное к p-n переходу напряжение, то расстояние, на которое раздвигаются квазиуровни Ферми, равно
Fn – Fp » eU (9.14)
Появление областей 1 и 2, «переполненных» неравновесными носителями, и обуславливает инверсную заселенность, дающую всплеск излучательной рекомбинации, причем с преобладанием вынужденного излучения (тем большего, чем больше доля неравновесных носителей среди всех рекомбинирующих). На границах перехода при инжекции концентрация носителей меняется в ~ 104 раз.
Итак, условия для создания инверсии населенностей можно сформулировать так:
1. Большая концентрация примесей, приводящая к тому, что уровень Ферми оказывается в разрешенной зоне.
2. Наличие p-n перехода, сильно искажающего зонную структуру.
3. Возможность пропускания большого тока инжекции через p-n переход так, чтобы по всему p-n переходу осуществлялось, по возможности, одинаковое «спрямление» зон с соответствующим «раздвиганием» квазиуровней Ферми.
Лазерное излучение при инжекции носителей через p-n переход получено во многих полупроводниковых материалах. Наиболее распространены лазеры на арсениде галлия. Устройство излучающего элемента такого лазера схематически показано на рисунке 9.3 [2].
 |
Лазерный диод представляет собой срез монокристалла GaAs с поперечными и продольными размерами порядка 0,1 – 1 мм. Образец вырезан из сильнолегированного материала n-типа (донорные примеси Se, Te). После диффузии или имплантации p-типа (акцепторные примеси Zn, Cd) верхняя часть образца приобретает проводимость p-типа, и на расстоянии 10 – 100 мкм от поверхности образуется планарный слой p-n перехода. Толщина активной зоны p-n перехода составляет 1 – 10 мкм. При пропускании тока перпендикулярно плоскости p-n перехода в тонком слое p-n перехода возникает инверсия. Боковые грани кристалла образуют резонатор, и в плоскости p-n перехода начинается генерация.
 |
Поскольку коэффициент усиления активной среды велик, нет необходимости добиваться высоких коэффициентов отражения от граней кристалла. Практически достаточно ~ 30%. Иногда одну из боковых граней специально скашивают под углом Брюстера, чтобы уменьшить отражение. Характерная форма пятна излучения (поперечное распределение интенсивности) повторяет форму области инверсии и похожа на размытый отрезок прямой. Типичные угловые размеры диаграммы излучения составляют единицы градусов в плоскости p-n перехода и десятки градусов в перпендикулярной ей плоскости. КПД полупроводникового лазера можно оценить по формуле:
h » hвнутр ´ (DЕg/Еd) (9.15)
где hвнутр — квантовый выход излучательной рекомбинации, DЕg — ширина запрещенной зоны (в вольтах), Еd — падение напряжения на p-n переходе.
При hвнутр » 1 можно выбором характеристик материала и охлаждением p-n перехода добиться КПД порядка 80% (при низких температурах). Однако, несмотря на такие гигантские значения КПД, выходная мощность полупроводниковых лазеров описанного типа, особенно в непрерывном режиме, невелика и не превышает, как правило, нескольких мВт, т.е. не больше, чем у Ne-He лазеров, работающих даже не в многомодовом, а в одномодовом режиме. Несколько лучше положение в импульсном режиме, где пиковая мощность может достигать нескольких кВт, но средняя мощность при этом все равно измеряется милливаттами.
Главный барьер, ограничивающий выходную мощность полупроводниковых лазеров, — это сложность обеспечения пространственной однородности накачки. При увеличении размеров активной области p-n перехода обязательно возникает неравномерность плотности тока по сечению, а это, в свою очередь, из-за резкой температурной зависимости тока, дает сильный разброс интенсивности излучения по пространству. Вместе с тем, возникает неравномерный разогрев области p-n перехода, приводящий к искажениям распределения концентраций неравновесных носителей, а то и просто разрушению зонной структуры, необходимой для создания инверсии. Наряду с температурными явлениями, весьма возможен и оптический пробой кристалла (поскольку размеры области составляют микроны, при излучаемых мощностях порядка 103 Вт на участках кристалла размером ~ 10-1 мкм уже возможен оптический пробой) [3].
Существенно улучшить свойства полупроводниковых лазеров удалось при переходе от гомогенных полупроводниковых структур к гетерогенным (разнородным).
Гетеропереходом называется такой p-n переход, у которого монокристаллический слой одного полупроводника наращивается на монокристаллической подложке другого полупроводника (в отличие от гомоперехода, где используется один и тот же полупроводник). Чтобы при этом не нарушалась монокристалличность всего образца, необходимо тщательно подбирать контактирующие материалы. Используется чаще всего контакт (твердый раствор) GaAs и AlAs. Эту пару отличает то, что постоянные кристаллической решетки этих материалов, составляющие 0,565 нм для GaAs и 0,566 нм для AlAs, очень близки, благодаря чему соединения типа AlxGa1-xAs могут иметь высокую кристаллическую однородность независимо от величины х. Иначе, замещение Ga на Al в полупроводнике может происходить без образования дефектов кристаллической решетки. При этом ширина запрещенной зоны DЕg растет с увеличением х в формуле соединения. Таким образом, выращивая кристалл, изменяя долю содержания Al и Ga, можно формировать структуры с гетеропереходами переходами n-n, p-p и p-n типов с соответствующими изменениями ширины запрещенной зоны.
На рисунке 9.5 представлена картина энергетических зон для двустороннего гетероперехода при инжекции [6].
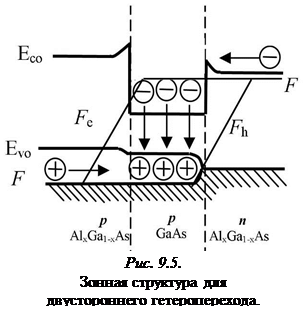 Благодаря меньшей ширине запрещенной зоны в слое GaAs, где находится активный слой, инжектированные носители оказываются в потенциальной яме и потенциальные барьеры препятствуют выходу области рекомбинации носителей из активной зоны. Происходит «электронное ограничение», являющееся причиной появление сверхинжекции, выражающееся в том, что концентрация носителей в активной области оказывается больше концентрации их в прилегающих областях. В гетероструктурах, даже если квазиуровень Ферми из-за низкой концентрации носителей (слабое легирование) оказывается вне зоны проводимости, в активной зоне может оказаться внутри нее. Но уменьшение степени легирования позволяет уменьшить концентрацию дефектов в полупроводнике, то есть повысить его однородность.
Благодаря меньшей ширине запрещенной зоны в слое GaAs, где находится активный слой, инжектированные носители оказываются в потенциальной яме и потенциальные барьеры препятствуют выходу области рекомбинации носителей из активной зоны. Происходит «электронное ограничение», являющееся причиной появление сверхинжекции, выражающееся в том, что концентрация носителей в активной области оказывается больше концентрации их в прилегающих областях. В гетероструктурах, даже если квазиуровень Ферми из-за низкой концентрации носителей (слабое легирование) оказывается вне зоны проводимости, в активной зоне может оказаться внутри нее. Но уменьшение степени легирования позволяет уменьшить концентрацию дефектов в полупроводнике, то есть повысить его однородность.
Более того, поскольку показатель преломления в чистом GaAs меньше, чем при добавлении Al, такая структура является эффективным световодом, существует «оптическое ограничение», препятствующее выходу излучения за пределы активной области.
Перечислим основные преимущества гетеролазера.
Во-первых, активная область значительно более резко выделена в пространстве, поскольку отсутствует диффузионное растекание инжектируемых носителей.
Во-вторых, показатель преломления AlxGa1-xAs существенно меньше, чем GaAs, поэтому присутствует эффект оптического волновода: излучение концентрируется в активной области и не проникает в поглощающую область.
В-третьих, теплопроводность подложки (металл) велика по сравнению с гомопереходом (сапфир), поэтому обеспечен хороший теплоотвод.
В итоге у гетеролазера примерно в 100 раз снижается пороговая плотность тока при комнатной температуре, что позволяет снимать с одного излучателя уже не милливатты, а ватты средней мощности. При нынешнем уровне технологии с полоски шириной 100 мкм достигается мощность 10 Вт.
 |
Миниатюрность излучающих элементов позволяет создавать матричные конструкции полупроводниковых лазеров, где может содержаться до нескольких сотен излучающих элементов. Выходная мощность при этом достигает уже сотен Ватт, что позволяет рассматривать и хирургическое применение полупроводниковых лазеров.
Малогабаритность, экономичность и безопасность полупроводниковых лазеров делает их, безусловно, более предпочтительными на практике, чем газовые. Вопрос сводится к выбору длины волны. Длина волны излучения полупроводниковых лазеров определяется, как это следует из нашего рассмотрения, шириной запрещенной зоны DЕg. Для арсенида галлия DЕg = 1,5 эВ, откуда l » 844 нм. Поскольку на зонную структуру влияют многие факторы — наличие примесей, давление, температура, внешние электромагнитные поля и т.д., длину волны излучения полупроводниковых лазеров можно менять в широких пределах. На сегодня практически перекрыт весь видимый и, особенно, ближний ИК диапазоны.
Исследование механизмов лазерного низкоинтенсивного воздействия на биоткани человека в последние годы привели к обнаружению целого ряда длин волн в ближнем ИК, соответствующих максимумам биостимуляции, а также к выбору режимов импульсно-периодичеcкого воздействия, более предпочтительных для лечения определенных видов заболеваний, чем непрерывный режим. Все это дало мощный толчок разработкам терапевтических лазерных аппаратов на базе полупроводниковых лазеров. Ими почти вытеснены с рынка медицинской лазерной аппаратуры терапевтические аппараты на базе He-Ne лазеров [4].
Новым и, безусловно, «прорывным» направлением в медицинской лазерной технике являются полупроводниковые лазерные волоконно-диодные модули. Чтобы изложить основные принципы их конструирования, вернемся к структуре излучающего элемента полупроводникового лазера (рисунок 9.6).
Расходимость излучения в плоскости, перпендикулярной плоскости p-n перехода (по «быстрой оси»), соответствует одномодовому случаю и составляет достаточно большую величину (до десятков градусов).
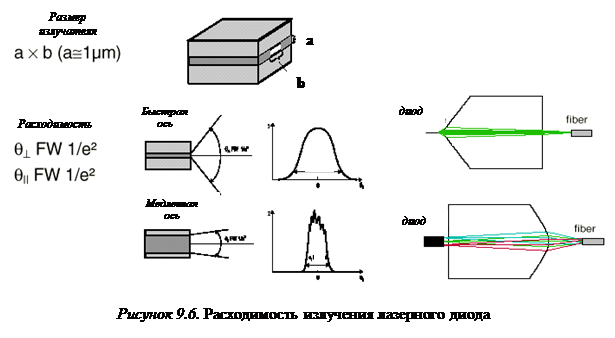 |
Размер активного элемента в перпендикулярном направлении, в плоскости перехода, выбирается из компромисса между желанием увеличить мощность излучения и возможностью его фокусировки. Излучение в этом направлении (по «медленной оси») многомодовое, и его расходимость практически не зависит от размера апертуры.
Величина мощности излучения, генерируемого лазерным диодом, ограничивается допустимой величиной тока, который можно пропустить через переход и оптической прочностью полупроводника. При размере по «медленной оси» 0,1 мм с одного современного лазерного диода можно получить лазерное излучение мощностью около 4 Вт. Эта величина достаточна для прецизионных операций на малых объемах биоткани.
Для обеспечения осесимметричной фокусировки излучения лазерного диода необходимо использовать оптический элемент с разной оптической силой по быстрой и медленной осям (рисунок 9.7). Дальнейшее наращивание выходной мощности возможно путем суммирования интенсивности излучения отдельных лазерных диодов, разнесенных пространственно или выращенных в едином полупроводниковом кристалле в виде одномерной или двумерной решетки. При этом вновь встает проблема сведения суммарной мощности в одно пятно с малыми размером и числовой апертурой. Суммирование может быть осуществлено либо пространственно с использованием дискретных оптических элементов (призм и зеркал), либо с использованием диодов с волоконным выводом излучения, а суммирование производить в волоконно-оптических сумматорах. В волоконной технике лазерный диод с волоконным выводом излучения называют «пигтелированным» — от английского pig tail («поросячий хвост»).
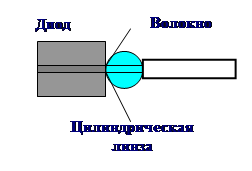
Рисунок 9.7.
Схема введения излучения диодного лазера в волоконный световод
С практической точки зрения системы с пространственным суммированием излучения требуют более сложной юстировки и больше подвержены влиянию пыли, влаги и механических воздействий В частности, НТО «ИРЭ-Полюс» серийно производит мощные высокоэффективные 970-нм лазерные диоды модули PLD (Pig-tailed Laser Diode — лазерный диод с волоконным выходом) с шириной излучающей области 100 мкм. Излучение лазерного диода с помощью микрообъектива вводится в 110 мкм кварц-кварцевое многомодовое волокно. Все элементы смонтированы в компактном герметичном корпусе (рисунок 9.8.).
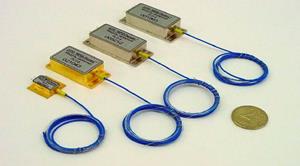
Рисунок 9.8. Внешний вид PLD-модулей НТО «ИРЭ-Полюс».
Изделия характеризуются высокой выходной мощностью в сочетании с малыми габаритными размерами и весом. Модули серии PLD обладают уникально высокой надежностью и превосходят по ресурсу существующие аналоги в десятки и сотни раз. Надежность модулей обеспечивается высоким уровнем технологии производства и чрезвычайно жесткой процедурой тестирования на всех этапах сборки каждого изделия.
Однако PLD-модули — это, при всех их достоинствах, всего лишь переходный этап от полупроводниковых к волоконным лазерам, использующим в качестве активной среды активированное оптическое волокно.
Первые лазеры, в которых в качестве активной среды использовалось активированное оптическое волокно, появились практически одновременно с другими лазерами: в 1961 г. [7]. При этом использовалась накачка от дуговой лампы. Дальнейшее развитие этого направления задержалось из-за крайне низкой эффективности ламповой накачки. Новый импульс волоконные лазеры получили в 1973 г., было предложено использовать для накачки волокна лазерное излучение, вводимое в торец волоконного световода [8]. При этом сразу выявились преимущества волоконных лазеров.
Это, прежде всего – высокая эффективность использования излучения накачки. Она обусловлена с одной стороны хорошим поглощением излучения накачки даже при малой концентрации активных центров за счет большой длины поглощающей среды (до нескольких десятков метров), и полного пространственного совпадения накачиваемого объема и объема, в котором происходит генерация. Поскольку технология позволяет получать волокна с низкими потерями, удается получать практически предельную эффективность, определяемую квантовым выходом.
Вторым преимуществом является малый объем активной среды, который позволяет получать крайне низкие пороги генерации, а также использовать энергетические схемы, не реализуемые в обычных активных генерациях, например непрерывную генерацию по трехуровневой схеме ионов Er, Tm, Ho.
Третьим преимуществом является возможность получения даже на слабых переходах практически любых коэффициентов усиления. Ограничением здесь выступает сверхизлучение – усиленное за счет индуцированных переходов спонтанное излучение, которое многими авторами трактуется как возможность создания «лазеров без резонатора». Вопрос, можно ли такой «сверхизлучатель» именовать лазером, или же считать лазером следует только генератор в радиофизическом смысле слова, т.е. с обязательным наличием положительной обратной связи и выполнением условий самовозбуждения (баланса амплитуд и фаз), до сих пор остается открытым.
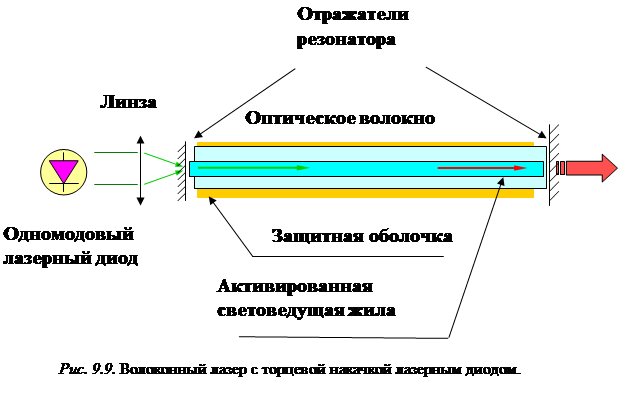 |
Несмотря на перечисленные достоинства, в течение долгого времени волоконные лазеры оставались предметом чисто научного интереса: отсутствовали эффективные источники накачки. Положение изменилось в середине 80-х годов минувшего века, когда появились мощные лазерные диоды, надежно работающие при комнатных температурах. К этому же времени была отработана технология получения оптического кварцевого волокна с уровнем потерь меньше 1 децибела на километр. В 1985 г. R.J. Mears с сотр. [9] использовали для накачки лазера на активированном волокне одномодовый лазерный диод (рисунок 9.9).
С этого момента начался бурный рост числа работ, посвященных волоконным лазерам, как эффективным источникам для волоконных линий связи. Было разработано большое количество волоконных элементов (разветвители, мультиплексоры, брэгговские решетки, зеркала, поляризаторы и т.д.). Это позволило отказаться от традиционных оптических дискретных элементов и конструировать волоконные системы в виде интегральных устройств, не нуждающихся в настройках и юстировках, а, значит, не боящихся их нарушений. Поскольку свет в таких устройствах распространяется внутри волокна, куда нет доступа пыли и влаге, они отличаются устойчивостью к воздействиям окружающей среды.
Следующий шаг – переход к многооболочечным световодам (Double Clad), позволяющим использовать для торцевой накачки более мощные многомодовые лазерные диоды (рисунок 9.10).
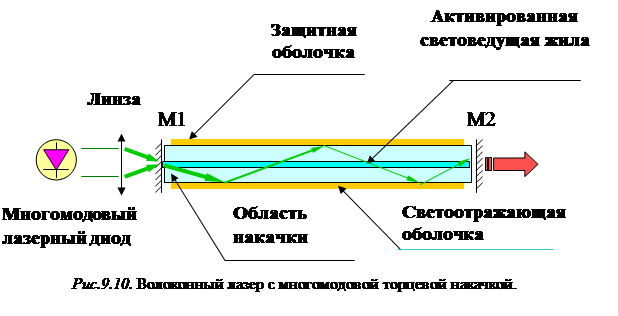
В таких световодах вокруг активированной одномодовой сердцевины формируется второй многомодовый световод из кварца с более низким показателем преломления, в который и производится накачка. При этом процесс накачки похож на накачку твердотельного лазера от полостной лампы: излучение, отражаясь от стенок многомодового световода, постепенно поглощается в активной среде центральной жилы. Благодаря большой длине световода эффективность приближается к 100%. В таком лазере удается с высокой эффективностью преобразовать излучение мощного лазерного диода с плохими пространственными характеристиками в одномодовое излучение волоконного лазера.
Волоконные лазеры оказались идеальными для телекоммуникационных целей, вопрос же создания на их основе мощных лазерных систем даже не рассматривался в силу их миниатюрности и изящности. В течение почти 30 лет (с 1961 г по 1989 г) волоконные лазеры развивались сравнительно медленно. К концу этого периода в них использовались волокна с двойной оболочкой, позволяющие осуществлять торцевую накачку от многомодовых полупроводниковых лазеров, были разработаны технологии формирования внутри волокна брэгговских отражающих решеток, которые можно использовать в качестве отражателей резонатора. Завершением этого периода развития можно считать 1989 г., когда компания Polaroid продемонстрировала волоконный лазер с длиной волны 1,06 мкм и выходной мощностью 100 мВт.
Но уже в марте следующего 1990 г. на ASSL В.П. Гапонцевым и И.Э. Самарцевым [10] был представлен лазер на Er-активированном волокне с длиной волны 1,54 мкм и выходной мощностью 2 Вт. Резкое увеличение выходной мощности более чем на порядок позволяло говорить о создании мощного (по меркам того времени) волоконного лазера. Годом позднее была опубликована работа тех же авторов [11], в которой сообщалось о лазере с выходной мощностью 3,9 Вт, и были сформулированы предпосылки, позволившие сделать вывод о том, что на основе волоконных лазеров могут быть созданы устройства с уровнями выходной мощности в десятки и сотни Ватт непрерывного излучения.
Именно:
1. Фантастическая лучевая прочность кварцевого волокна, достигающая нескольких десятков ГВт на квадратный сантиметр. Лучевая прочность АИГ:Nd составляет величину порядка 1 МВт/см2.
2. Уже упоминавшиеся высокие уровни коэффициента усиления за один проход активной среды, позволяющие работать с малыми порогами накачки и большими коэффициентами вывода излучения. При этом отношение выходной мощности к мощности в резонаторе достигает 0,85…0,95.
3.
 |
Поскольку эффективность охлаждения определяется соотношением объема, в котором выделяется тепло к поверхности, с которой оно снимается, в тонких волокнах создаются прекрасные условия для охлаждения.
Действительно, решая уравнение теплопроводности
 (9.16)
(9.16)
где W(R) – распределение тепловыделения,
λ – коэффициент теплопроводности, в предположении равномерного тепловыделения W(R)=W, можно получить выражение для разницы между температурами в центре цилиндрического стержня Тц и на его поверхности Тп.
 (9.17)
(9.17)
где R1 –диаметр волокна.
В таблице 9.1 приведены сравнительные оценки из [36] для разных типов лазеров.
Таблица 9.1
| D, мм | L, см | λ, Вт∙см-1∙С-1 | Тц -Тп,°С | РΣ, Вт | Тип охл. | |
| АИГ лампа | 0,1 | Жидк. | ||||
| АИГ 0,81 мкм | 0,1 | 0,8 | Жидк. | |||
| Волокно 0,81 мкм | 0,1 | 0,01 | 0,0001 | Возд. | ||
| Волокно 0,81 мкм | 0,3 | 0,01 | 0,002 | Возд. |
Из таблицы наглядно видны преимущества волоконных лазеров, в частности, достаточность воздушного охлаждения. При этом следует учесть, что всегда есть возможность повысить эффективность охлаждения, увеличив длину волокна, поскольку это не влечет снижения эффективности лазера.
Желание использовать плавленый кварц в качестве матрицы активных элементов обычных твердотельных лазеров, обусловленное его хорошими термомеханическими характеристиками, упиралось в нерастворимости в нем ионов активатора. Проводя аналогию с жидкостями, при сколь-нибудь значимых концентрациях активаторов – редкоземельных ионов (РЗИ), вместо раствора получается «эмульсия». Активатор формирует кластеры, которые ведут к появлению сильного рэлеевского рассеяния на неоднородностях, следствием чего является увеличение потерь в активных элементах, делающее их неработоспособными. Чтобы увеличить растворимость РЗИ в матрицу добавляют окислы, в частности алюминия (Al2O3) и фосфора (Р2О5). Для введения заметных концентраций количество добавок таково, что вместо плавленого кварца получаются стекла, имеющие плохие термооптические и термомеханические свойства.
Для того, чтобы разрешить противоречие между требованиями сохранения термо-механических свойств кварцевого волокна, достаточной концентрации активатора и низкого уровня потерь на рассеяния, группа В.П. Гапонцева воспользовалась тем, что эффект рэлеевского рассеяния сильно (для сферических частиц – пропорционально 6 степени диаметра) зависит от размера рассеивающих частиц. Для этого было необходимо добиться уменьшения размеров кластеров, формируемых активными центрами.
При изготовлении активного волокна в зоне заготовки, из которой формируется активированная РЗИ жила, добавляется небольшое количество Р2О5. Использование фосфатированного кварцевого волокна сводит практически к нулю деградацию световода за счет образования центров окраски вследствие ап-конверсии при высоких уровнях мощности излучения.
В результате в заготовке формируются кластеры, состоящие фактически из сильно активированного фосфатного стекла, в которых концентрируются РЗИ. Типичные средние концентрации активатора невысоки и составляют 104 ppm.
Следует отметить, что для активации волокна требуется ничтожно малое количество активатора, что снижает их себестоимость.
С заготовками проводится специальный процесс вытяжки световода с коэффициентом перетяжки, соста
| <== предыдущая лекция | | | следующая лекция ==> |
| Ионные газовые лазеры. | | | Введение в программирование под Windows |
Дата добавления: 2017-01-26; просмотров: 2404;











