Определение электронных приборов. Классификация электронных приборов 2 глава
|
Nd – на рис. 2.4, б и акцепторов Na по вертикали – рис. 2.4, в.
Поверхность, на которой Na =Nd, называется металлургической границей  . Эффективная концентрация примеси на ней равна нулю.
. Эффективная концентрация примеси на ней равна нулю.
|
p-n-переходы, в которых концентрация примесей в эмиттере значительно больше, чем в другой области – базе. В симметричных p‑n‑переходах концентрация акцепторов в p‑области равна концентрации доноров в n‑области.
2.5. Электронно-дырочный переход в равновесном состоянии
Равновесие соответствует нулевому внешнему напряжению на переходе. Поскольку концентрация электронов в n-области значительно больше, чем в p‑области, а концентрация дырок в p‑области больше, чем в n‑области, то на границе раздела полупроводников возникает градиент концентрации подвижных носителей заряда (дырок и электронов):  ,
,  .
.
Вследствие этого заряды будут диффундировать из области с большей концентрацией в область с меньшей концентрацией, что приведёт к появлению диффузионного тока электронов и дырок, плотность которых равна:
 , (2.29)
, (2.29)
 . (2.30)
. (2.30)
На границе p- и n-областей создаётся слой, обеднённый подвижными носителями. В приконтактной области n-типа появляется нескомпенсированный заряд положительных ионов, а в дырочной области – нескомпенсированный заряд отрицательных ионов примесей. Таким образом, электронный полупроводник заряжается положительно, а дырочный – отрицательно.
Между областями полупроводника с различными типами электропроводности возникает электрическое поле напряжённостью Е. Образовавшийся двойной слой электрических зарядов называется запирающим, он обеднён основными носителями и имеет вследствие этого низкую электропроводность. Вектор напряженности поля направлен так, что он препятствует диффузионному движению основных носителей и ускоряет неосновные носители. Этому полю соответствует контактная разность потенциалов  , связанная с взаимной диффузией носителей. За пределами p-n-перехода полупроводниковые области остаются нейтральными.
, связанная с взаимной диффузией носителей. За пределами p-n-перехода полупроводниковые области остаются нейтральными.
Движение неосновных носителей образует дрейфовый ток, направленный навстречу диффузионному току.
Итак, в условиях равновесия встречные дрейфовый и диффузионный токи должны быть равны, т.е.
 . (2.31)
. (2.31)
Определим выражение контактной разности потенциалов, для чего воспользуемся соотношением (2.31), подставив выражения дрейфового и диффузионного токов:
 ,
, 
 или
или  .
.
Используя соотношения Эйнштейна, запишем  ;
;
тогда  . (2.32)
. (2.32)
Постоянную интегрирования С найдём, используя граничные условия: потенциал в р-области  , концентрация дырок
, концентрация дырок  ; в n-области потенциал
; в n-области потенциал  и
и  . Тогда выражение для контактной разности потенциалов
. Тогда выражение для контактной разности потенциалов  в p-n-переходе
в p-n-переходе
 . (2.33)
. (2.33)
Если принять  и
и  для германиевого p-n-перехода, то
для германиевого p-n-перехода, то  .
.
Распределение зарядов и поля в р‑n‑переходе

|
 и резкое изменение типа проводимости на границе p- и n-областей (рис. 2.5, а-д).
и резкое изменение типа проводимости на границе p- и n-областей (рис. 2.5, а-д).
Используя выражение (2.32) и полагая  при
при  , найдём концентрацию дырок в переходе:
, найдём концентрацию дырок в переходе:
|
 . (2.34)
. (2.34)
Аналогично можно получить выражение для концентрации электронов:
 . (2.35)
. (2.35)
|

 . (2.36)
. (2.36)
|
 при х>0; (2.37)
при х>0; (2.37)
|
 при х<0, (2.38)
при х<0, (2.38)
где  – толщина р-n-перехода;
– толщина р-n-перехода;
 – диэлектрическая проницаемость полупроводника.
– диэлектрическая проницаемость полупроводника.
Электрическое поле в переходе линейно возрастает от нуля на границе перехода до максимального значения в середине перехода, т.е. при х=0.
 . (2.39)
. (2.39)
Толщину симметричного перехода определим, воспользовавшись соотношением
 . (2.40)
. (2.40)
Подставляя выражение (2.39), получим
 . (2.41)
. (2.41)
 Если концентрация примеси в p- и
Если концентрация примеси в p- и
n-областях различна, то и глубина проникновения перехода в p-и n-области будет неодинакова (рис. 2.6), т.к. нескомпенсированный заряд в обеих частях должен быть одинаковым  .
.
Большую толщину переход имеет в областях с меньшей концентрацией примеси.
Суммарная толщина перехода в этом случае определится так:
 . (2.42)
. (2.42)
На рис. 2.7, а, б показана энергетическая диаграмма p-n-структуры. Так как величина энергии уровня Ферми должна быть одинаковой по всей структуре, уровень Ферми располагается на одной высоте.
В области p-n-перехода энергетические уровни (см. рис. 2.7, б) имеют наклон, что свидетельствует о наличии градиента потенциала, а следовательно, и электрического поля, выталкивающего подвижные заряды из перехода.
Разность минимальных значений энергии в зонах проводимости p- и
n-областей определяется контактной разностью потенциалов. Чтобы перейти в валентную зону n-области, дырки должны совершить работу, равную  .
.
|
|

2.6. Электронно-дырочный переход в неравновесном состоянии
Если к p-n-переходу подключить источник напряжения, равновесное состояние нарушится, и в цепи будет протекать ток. Различают прямое и обратное включения p-n-перехода.
Прямое включение. Пусть внешнее напряжение приложено плюсом к p‑области, а минусом – к n-области (рис. 2.8, а, б).
При этом оно противоположно по знаку контактной разности потенциалов. Так как концентрация подвижных носителей в p-n-переходе значительно ниже, чем в p- и n-областях, сопротивление p-n-перехода значительно выше сопротивления p- и n-областей. Можно считать, что приложенное напряжение полностью падает на переходе. Основные носители будут двигаться к контакту,
|
 сокращая дефицит носителей в
сокращая дефицит носителей в p-n-переходе и уменьшать сопротивление и толщину p-n-перехода. Результирующее поле в p-n-
|
 . Поток основных носителей через контакт увеличится. Ток, протекающий через переход, в данном случае называется прямым, а напряжение, приложенное к перехо-
. Поток основных носителей через контакт увеличится. Ток, протекающий через переход, в данном случае называется прямым, а напряжение, приложенное к перехо-ду – прямым напряжением. При
 потенциальный барьер для основных носителей исчезает, и ток ограничивается обычным омическим сопротивлением объема полупроводника.
потенциальный барьер для основных носителей исчезает, и ток ограничивается обычным омическим сопротивлением объема полупроводника.
Диффузия дырок через переход приводит к увеличению концентрации дырок за переходом. Возникающий при этом градиент концентрации дырок обусловливает диффузионное проникновение их в глубь n-области, где они являются неосновными носителями. Это явление называется инжекцией (впрыскиванием). Инжекция дырок не нарушает электрической нейтральности в n-области, т.к. она сопровождается поступлением из внешней цепи такого же количества электронов.
Толщина перехода в этом случае
|

 . (2.43)
. (2.43)
Диффузионная составляющая будет превышать дрейфовую составляющую. В результате
 . (2.44)
. (2.44)
|
n-области, а минусом к – p-области, то оно совпадает по знаку с контактной разностью потенциалов (рис. 2.9, а, б). В этом случае напряжение на переходе возрастает, и высота потенциального барьера становится выше, чем при отсутствии напряжения
 . Толщина перехода возрастает
. Толщина перехода возрастает
 . (2.45)
. (2.45)
Результирующая напряженность электрического поля в переходе будет выше, что приведет к увеличению дрейфового тока:
 ;
;  . (2.46)
. (2.46)
Направление результирующего тока противоположно направлению прямого тока, поэтому он называется обратным током, а напряжение, вызывающее обратный ток, называется обратным напряжением. Поле в переходе является ускоряющим лишь для неосновных носителей. Под действием этого поля концентрация неосновных носителей на границе перехода снижается и появляется градиент концентрации носителей заряда. Это явление называется экстракцией носителей. Значение тока экстракции определяется числом неосновных носителей заряда, возникающих в полупроводнике в единицу времени на расстоянии, которое они могут пройти за время жизни. Это расстояние называется диффузионной длиной электронов и дырок. Концентрация неосновных носителей на расстоянии диффузионной длины убывает в  раз.
раз.
 ,
,  , (2.47)
, (2.47)
где  – коэффициенты диффузии электронов и дырок;
– коэффициенты диффузии электронов и дырок;
τn, τp – время жизни электронов и дырок;
 – диффузионная длина электронов и дырок.
– диффузионная длина электронов и дырок.
Так как число неосновных носителей мало, ток экстракции через переход намного меньше прямого тока. Он практически не зависит от приложенного напряжения и является током насыщения.
Таким образом, p-n-переход обладает несимметричной проводимостью: проводимость в прямом направлении значительно превышает проводимость p‑n‑перехода в обратном направлении, что нашло широкое применение при изготовлении полупроводниковых приборов.
2.7. Вольт-амперная характеристика p-n‑перехода
Вольт-амперная характеристика p-n-перехода представляет собой зависимость тока через p-n-переход от величины и полярности приложенного напряжения.
При выводе вольт-амперной характеристики можно предположить, что токи неосновных носителей заряда через переход с изменением полярности и величины приложенного напряжения не изменяются. Токи основных носителей меняются существенно и при приложении обратного напряжения резко уменьшаются.
Токи основных носителей можно рассматривать как токи эмиссии зарядов через контактный слой, скачок потенциальной энергии на котором равен работе выхода электрона. При этом предположении токи основных носителей с увеличением обратного напряжения будут уменьшаться по экспоненциальному закону.
Плотность тока основных носителей можно записать так:
 ;
;  . (2.48)
. (2.48)
Если прикладывать прямое напряжение, высота барьера уменьшается и токи основных носителей будут экспоненциально возрастать. Плотность полного тока через переход будет равна
 ,
,
где  .
.
Полный ток можно записать  , где
, где  – площадь p-n-перехода.
– площадь p-n-перехода.
Тогда  , (2.49)
, (2.49)
где  — обратный ток, называемый тепловым током, или током насыщения:
— обратный ток, называемый тепловым током, или током насыщения:  . (2.50)
. (2.50)
 По своей физической природе он представляет собой ток экстракции, следовательно, величина его очень мала. Вольт-амперная характеристика, соответствующая этому выражению, показана на рис. 2.10.
По своей физической природе он представляет собой ток экстракции, следовательно, величина его очень мала. Вольт-амперная характеристика, соответствующая этому выражению, показана на рис. 2.10.
При  величина
величина  , поэтому при относительно небольшом прямом напряжении ток через переход резко возрастает. При подаче обратного напряжения ток, изменив направление, быстро достигает значения
, поэтому при относительно небольшом прямом напряжении ток через переход резко возрастает. При подаче обратного напряжения ток, изменив направление, быстро достигает значения  , а далее остается постоянным независимо от величины приложенного напряжения.
, а далее остается постоянным независимо от величины приложенного напряжения.
Реальная характеристика p-n-перехода отличается от теоретической (рис. 2.11). Эти различия обусловлены термогенерацией носителей в запирающем слое перехода, падением напряжения на сопротивлениях областей полупроводника, а также явлением пробоя при обратном напряжении.

2.8. Пробой p-n-перехода
Ток генерации будет расти при увеличении обратного напряжения, т.к. количество генерируемых носителей пропорционально объему запирающего слоя, который зависит от ширины p-n-перехода. Поэтому на реальной характеристике при увеличении обратного напряжения наблюдается небольшой рост обратного тока. Когда обратное напряжение достигает некоторого критического значения – резко возрастает обратный ток. Это явление называют пробоем p‑n‑перехода. Различают два вида пробоя: электрический и тепловой. В обоих случаях резкий рост тока связан с увеличением числа носителей через переход.
Если за время свободного пробега электрон успевает набрать достаточную энергию, возникает ударная ионизация атомов электронами, для чего необходима определенная напряженность электрического поля. В германиевом переходе она составляет  .
.
В результате ударной ионизации начинается лавинное размножение носителей заряда. Коэффициент размножения  носителей заряда можно определить из выражения
носителей заряда можно определить из выражения
 . (2.51)
. (2.51)
Величина напряжения пробоя  зависит от рода материала, удельного сопротивления
зависит от рода материала, удельного сопротивления  и типа перехода:
и типа перехода:
 . (2.52)
. (2.52)
Значения постоянных  и
и  указаны в табл. 2.3:
указаны в табл. 2.3:
Таблица 2.3
| Материал и тип перехода | 
| 
| 
|
| германиевый p-n-переход | 0,6 | ||
| кремниевый p-n-переход | 0,65 | 3,5 |
При значительных напряжённостях электрического поля (порядка  ) возможен туннельный пробой, обусловленный прямым переходом электронов из валентной зоны в зону проводимости смежной области, происходящий без изменения энергии электрона (туннельный эффект).
) возможен туннельный пробой, обусловленный прямым переходом электронов из валентной зоны в зону проводимости смежной области, происходящий без изменения энергии электрона (туннельный эффект).
Тепловой пробой возникает вследствие перегрева перехода проходящим через него током при недостаточном теплоотводе. В режиме постоянного тока мощность, подводимая к переходу  , равна
, равна
 . (2.53)
. (2.53)
Эта мощность идет на разогрев перехода, в результате чего температура перехода  возрастает. Выделяющееся в переходе тепло рассеивается в основном за счет теплопроводности, поэтому отводимая от перехода мощность
возрастает. Выделяющееся в переходе тепло рассеивается в основном за счет теплопроводности, поэтому отводимая от перехода мощность  пропорциональна разности температур перехода
пропорциональна разности температур перехода  и окружающей среды
и окружающей среды  :
:
 , (2.54)
, (2.54)
где  – общее тепловое сопротивление,
– общее тепловое сопротивление,
здесь:  , (2.55)
, (2.55)
 – толщина перехода,
– толщина перехода,  – коэффициент теплопроводности полупроводника,
– коэффициент теплопроводности полупроводника,  – площадь перехода.
– площадь перехода.
В установившемся режиме
 . (2.56)
. (2.56)
Из выражения (2.56) найдём, что
 . (2.57)
. (2.57)
Вольт-амперная характеристика p-n-перехода в режиме теплового пробоя соответствует кривой Б на рис. 2.11. Уравнение вольт-амперной характеристики в области прямых токов можно записать в виде
 , (2.58)
, (2.58)
где  – электрическое сопротивление базы, электродов и выводов.
– электрическое сопротивление базы, электродов и выводов.
2.9. Емкости p-n-перехода
P-n-переход обладает емкостными свойствами, т.е. способностью накапливать и отдавать заряд при увеличении или уменьшении приложенного напряжения. Накопление заряда происходит в переходе и в p- и n-областях полупроводника. Различают барьерную  и диффузионную
и диффузионную  емкости:
емкости:
 . (2.59)
. (2.59)
С учетом (2.37)
 . (2.60)
. (2.60)
Зависимость барьерной емкости от приложенного напряжения можно записать как
 , (2.61)
, (2.61)
где  – начальное значение барьерной емкости при
– начальное значение барьерной емкости при  .
.
При переходе в область прямых напряжений возрастает не только барьерная емкость, но и диффузионная, обусловленная накоплением неравновесных зарядов в p- и n-областях,
 , (2.62)
, (2.62)
где  – прямой ток, протекающий через переход,
– прямой ток, протекающий через переход,
τ – время жизни инжектированных неравновесных носителей.
2.10. Полупроводниковые диоды
 Полупроводниковым диодом называется электропреобразовательный прибор, содержащий один или несколько переходов и два вывода для подключения к внешней цепи. В диодах применяются электронно-дырочный переход, контакт металл-полупроводник, гетеропереход. Одна из областей p‑n‑структуры, называемая эмиттером, имеет большую концентрацию основных носителей заряда, чем другая, называемая базой.
Полупроводниковым диодом называется электропреобразовательный прибор, содержащий один или несколько переходов и два вывода для подключения к внешней цепи. В диодах применяются электронно-дырочный переход, контакт металл-полупроводник, гетеропереход. Одна из областей p‑n‑структуры, называемая эмиттером, имеет большую концентрацию основных носителей заряда, чем другая, называемая базой.
На рис. 2.12 показано устройство планарно-эпитаксиального диода. Базу изготавливают путём наращивания на подложке 4 из низкоомного кремния тонкого слоя 3 высокоомного полупроводника, повторяющего структуры подложки. Этот слой, называемый эпитаксиальным, покрывают плотной защитной плёнкой 2 двуокиси кремния  толщиной до
толщиной до
1 мкм. В пленке протравливается окно, через которое путем диффузии бора или алюминия создается p‑n‑переход 1, вывод которого на поверхность защищен пленкой окисла.
По типу p-n-перехода различают плоскостные и точечные диоды. Плоскостным считается p-n-переход, линейные размеры которого, определяющие его площадь, значительно больше его толщины, в противном случае диод относят к точечным.
В зависимости от области применения диоды делят на выпрямительные, стабилитроны, варикапы, импульсные, туннельные, фото-, излучательные и др. По типу исходного материала различают кремниевые, германиевые, селеновые, арсенид-галлиевые диоды и др.
По методу изготовления перехода: сплавные, диффузионные, эпитаксиальные, диоды Шотки и др.
Тип диодов определяется системой обозначения полупроводниковых приборов (ОСТ 11.336.038-77).
Свойства полупроводниковых диодов оценивают общими и специальными параметрами. Первые характеризуют любой полупроводниковый диод, вторые только отдельные типы диодов.
2.11. Общие параметры диодов
К общим параметрам диодов относят допустимую температуру перехода, допустимую мощность, рассеиваемую диодом, допустимые прямой ток и обратное напряжение.
Для исключения теплового пробоя температура p-n-перехода должна быть меньше допустимой температуры перехода  .
.
Для германиевых диодов эта температура составляет  , для кремниевых
, для кремниевых  . При допустимой температуре перехода на диоде выделяется допустимая рассеиваемая мощность:
. При допустимой температуре перехода на диоде выделяется допустимая рассеиваемая мощность:
 . (2.63)
. (2.63)
Режим необходимо выбирать из условия  . Прямой ток, при котором температура p-n-перехода достигает значения
. Прямой ток, при котором температура p-n-перехода достигает значения  , называется допустимым прямым током
, называется допустимым прямым током  . Допустимое обратное напряжение обычно
. Допустимое обратное напряжение обычно  .
.
Кроме перечисленных, общими для всех диодов считаются прямое  и обратное
и обратное  сопротивления постоянному току:
сопротивления постоянному току:

 , (2.64)
, (2.64)
а также прямое  и обратное
и обратное  дифференциальные сопротивления (сопротивления переменному току):
дифференциальные сопротивления (сопротивления переменному току):

 . (2.65)
. (2.65)
Эти параметры определяются по вольт-амперной характеристике диода.
Пользуясь уравнением вольт-амперной характеристики, можем рассчитать дифференциальное сопротивление диода в заданной точке:

 , или
, или  (2.66)
(2.66)
 при Т=300 К;
при Т=300 К;  . (2.67)
. (2.67)
Сопротивление постоянному току R0 определяется отношением напряжения к току в заданной точке вольт-амперной характеристики.
Обычно R0>Rдиф. Пример расчёта Rдиф и R0 показан на рис. 2.13.
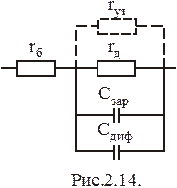 При анализе различных устройств, содержащих полупроводниковые приборы, можно использовать модель, состоящую из резисторов и конденсаторов.
При анализе различных устройств, содержащих полупроводниковые приборы, можно использовать модель, состоящую из резисторов и конденсаторов.
Принципиальная схема этой модели носит название схемы замещения, или эквивалентной схемы.
На рис. 2.14 представлена схема замещения полупроводникового диода.
Дата добавления: 2020-10-14; просмотров: 134;










