Определение электронных приборов. Классификация электронных приборов 7 глава
3.20. Работа транзистора в импульсном режиме
В ряде областей техники, например, в радиолокации, телевидении, ЭВМ и других применяют устройства на транзисторах, работающих в импульсном режиме. Их действие значительно отличается от работы схем в непрерывном режиме. Во-первых, в них происходят резкие и кратковременные изменения напряжения или тока, а транзистор работает в нелинейных областях характеристик.
 Имея малое сопротивление во включенном состоянии и большое сопротивление в выключенном, транзистор достаточно полно удовлетворяет требованиям, предъявляемым к ключевым элементам.
Имея малое сопротивление во включенном состоянии и большое сопротивление в выключенном, транзистор достаточно полно удовлетворяет требованиям, предъявляемым к ключевым элементам.
Транзистор в качестве ключа можно рассмотреть на примере включения в схему с ОЭ (рис. 3.35).

Во входной цепи включен источник смещения  , создающий обратное напряжение на эмиттерном переходе, источник управляющих импульсов
, создающий обратное напряжение на эмиттерном переходе, источник управляющих импульсов  и ограничительный резистор
и ограничительный резистор  . В выходную цепь включается источник питания
. В выходную цепь включается источник питания  и нагрузка
и нагрузка  .
.
Когда нет импульса на входе, транзистор находится в режиме отсечки. В цепях коллектора и базы проходят обратные токи.
При подаче во входную цепь импульса прямого тока транзистор открывается и в цепи коллектора возникает ток.
 Напряжение коллекторного перехода
Напряжение коллекторного перехода  оказывается прямым, т.к. отрицательное напряжение базы имеет большую величину, чем напряжение коллектора. Транзистор, вследствие этого, переходит в режим насыщения.
оказывается прямым, т.к. отрицательное напряжение базы имеет большую величину, чем напряжение коллектора. Транзистор, вследствие этого, переходит в режим насыщения.
В данном случае активный режим существует кратковременно и соответствует времени перехода рабочей точки из режима отсечки в режим насыщения.
Скорость переключения транзистора из режима отсечки в режим насыщения определяется процессами накопления и рассасывания неравновесных зарядов в базе и коллекторе, а также в эмиттерном и коллекторном переходах.
Графики напряжений и токов, а также заряда в транзисторе при переключении показаны на рис. 3.36, а - г. Величина прямого тока  определяется в основном сопротивлением ограничительного резистора
определяется в основном сопротивлением ограничительного резистора  .
.
После переключения эмиттерного перехода на обратное ток перехода имеет большую величину, ограниченную сопротивлением  , т.к. обратное сопротивление эмиттерного перехода в первый момент после переключения очень мало вследствие насыщения базы неравновесными носителями заряда. По мере рассасывания заряда обратное сопротивление эмиттерного перехода возрастает, и ток базы стремится к установившемуся значению
, т.к. обратное сопротивление эмиттерного перехода в первый момент после переключения очень мало вследствие насыщения базы неравновесными носителями заряда. По мере рассасывания заряда обратное сопротивление эмиттерного перехода возрастает, и ток базы стремится к установившемуся значению  .
.
Импульс выходного тока  появляется с задержкой
появляется с задержкой  , которая определяется в основном скоростью нарастания напряжения эмиттерного перехода, зависящей от емкости перехода и прямого тока базы, т.е. скоростью разряда эмиттерного перехода. Коллекторный ток постепенно нарастает, достигая установившегося значения за время
, которая определяется в основном скоростью нарастания напряжения эмиттерного перехода, зависящей от емкости перехода и прямого тока базы, т.е. скоростью разряда эмиттерного перехода. Коллекторный ток постепенно нарастает, достигая установившегося значения за время  , определяемого скоростью накопления неравновесного заряда в базе и скоростью разряда ёмкости коллектора.
, определяемого скоростью накопления неравновесного заряда в базе и скоростью разряда ёмкости коллектора.
Полное время включения транзистора состоит из времени задержки и нарастания:  и может составлять величину от нескольких наносекунд до нескольких микросекунд.
и может составлять величину от нескольких наносекунд до нескольких микросекунд.
При подаче в цепь базы запирающего тока коллекторный ток прекращается не сразу. На протяжении времени рассасывания  он сохраняет свою величину, т.к. концентрация носителей заряда в базе и у коллекторного перехода ещё остаётся равновесной и коллекторный переход оказывается открытым. После ухода дырок из базы и рекомбинации ток коллектора начинает спадать, достигая за время спада
он сохраняет свою величину, т.к. концентрация носителей заряда в базе и у коллекторного перехода ещё остаётся равновесной и коллекторный переход оказывается открытым. После ухода дырок из базы и рекомбинации ток коллектора начинает спадать, достигая за время спада  установившегося значения
установившегося значения  .
.
Время выключения транзистора будет определяться временем рассасывания и спада  .
.
Конструктивно-технологические меры, обеспечивающие высокое быстродействие ключевых транзисторов, практически такие же, как и для усилительных транзисторов, имеющих высокую предельную частоту усиления.
Кроме этого, удачным методом повышения быстродействия транзистора, работающего в качестве ключа, является шунтирование коллекторного перехода диодом Шотки, в котором отсутствует инжекция неосновных носителей заряда и их накопление при прямом смещении. Структура такого транзистора и его эквивалентная схема приведены на рис. 3.37 а, б. Наибольшее распространение такие транзисторы получили в интегральных микросхемах.
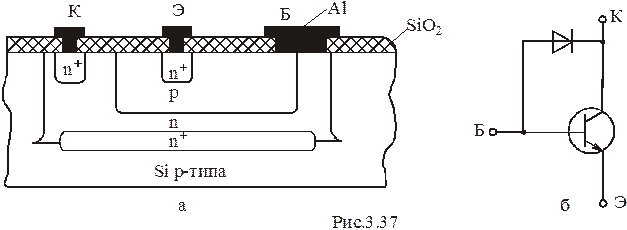
3.21. Классификация транзисторов по мощности и частоте
В зависимости от максимально допустимой мощности рассеяния биполярные транзисторы можно подразделить на транзисторы малой мощности (  ), средней мощности (
), средней мощности (  ) и большой мощности (
) и большой мощности (  ); в зависимости от предельной частоты коэффициента передачи тока – на транзисторы низкой частоты (
); в зависимости от предельной частоты коэффициента передачи тока – на транзисторы низкой частоты (  ), средней частоты (
), средней частоты (  ), высокой частоты (
), высокой частоты (  ) и сверхвысокой частоты
) и сверхвысокой частоты  .
.
В настоящее время основным полупроводниковым материалом для транзисторов служит кремний. Германиевые транзисторы, ранее широко применявшиеся в схемах, вытесняются кремниевыми, имеющими лучшие параметры: большую максимальную рабочую температуру, мощность, коэффициент передачи тока и граничную частоту. По конструктивным особенностям и технологии изготовления транзисторы делят на эпитаксиально-планарные, планарные, диффузионные, сплавные. Для большинства дискретных транзисторов характерна эпитаксиально-планарная структура.
3.22. Методы формирования транзисторных структур и конструкции
транзисторов различного назначения
Основным методом формирования транзисторных структур современных транзисторов является планарная технология. Одним из преимуществ планарной технологии является её универсальность, позволяющая на одном и том же оборудовании организовать производство различных по параметрам транзисторов. При планарной технологии можно создавать транзисторы с хорошими частотными свойствами. Это обусловлено тем, что в данном случае можно проводить селективную диффузию, т.е. вводить примеси в небольшие ограниченные области, строго контролируя глубину диффузии. В результате возможно изготовление транзисторов с толщиной базы в доли микрометра и размерами выпрямляющих переходов в единицы микрометров.
Для уменьшения объёмного сопротивления коллекторной области транзистора формирование транзисторной структуры производят в тонком эпитаксиальном слое с относительно малой концентрацией примесей, нанесенной на низкоомную подложку с электропроводностью того же типа (рис. 3.38).
 Коллекторная область состоит из высокоомной тонкой части эпитаксиального слоя 1 и низкоомной подложки 2. Коллекторный переход, расположенный в высокоомном эпитаксиальном слое, имеет небольшую барьерную ёмкость и высокое пробивное напряжение. Такие транзисторы носят название эпитаксиально-планарных и составляют основную часть транзисторов массового производства.
Коллекторная область состоит из высокоомной тонкой части эпитаксиального слоя 1 и низкоомной подложки 2. Коллекторный переход, расположенный в высокоомном эпитаксиальном слое, имеет небольшую барьерную ёмкость и высокое пробивное напряжение. Такие транзисторы носят название эпитаксиально-планарных и составляют основную часть транзисторов массового производства.
Кремниевые низкочастотные маломощные транзисторы изготавливаются чаще всего по эпитаксиально-планарной технологии. Планарные транзисторы создают в подложке n-типа без эпитаксиального слоя.
Германиевые транзисторы, обычно p-n-p-типа, изготавливаются по сплавной технологии или диффузионно-сплавной технологии.
Диффузионно-сплавные транзисторы в отличие от сплавных являются дрейфовыми и имеют значительно меньшую (1-2 мкм) толщину базы.
Низкочастотные транзисторы имеют достаточно большие емкости переходов (10-100 пФ) и время рассасывания (около 1 мкс). Обратные токи кремниевых транзисторов не превышают 1 мкА, для германиевых – 100 мкА при  .
.
Высокочастотные маломощные транзисторы имеют в основном кремниевые эпитаксиально-планарные и планарные структуры и отличаются меньшими площадями переходов, толщинами базы и коллектора, а также временем жизни неосновных носителей. Поэтому для них характерны большие граничные частоты, меньшие ёмкости переходов (менее 10 пФ), время рассасывания (доли микросекунды) и постоянные времени цепи обратной связи (около 1нс).
Сверхвысокочастотные транзисторы имеют ряд важных структурных и конструктивных особенностей. Для повышения граничной частоты необходимо уменьшать время пролета носителей от эмиттерного перехода до коллекторного.
С этой целью используются кремниевые n-p-n-структуры, у которых подвижность электронов в 3 раза выше, чем подвижность дырок. Современные технологические методы позволяют получить реальную толщину базы 0,1-0,3 мкм.
Для снижения ёмкости эмиттерного перехода уменьшают ширину полоскового эмиттера (менее 1 мкм), однако при этом снижается и максимально допустимый ток транзистора.
С целью уменьшения сопротивления базы  применяют дополнительное легирование пассивной области базы.
применяют дополнительное легирование пассивной области базы.
Барьерные емкости переходов СВЧ-транзисторов очень малы (десятые доли пикофарады), поэтому на предельную частоту влияют паразитные емкости и индуктивности выводов. Конструкции корпусов должны обеспечивать малые значения этих параметров. Для этих целей используются корпуса транзисторов с плоскими выводами либо бескорпусные транзисторы.
Таким образом, СВЧ-транзисторы характеризуются низким рабочим напряжением и током, меньшими значениями отдаваемой высокочастотной мощности, а также допустимой рассеиваемой мощности. Анализ экспериментальных данных показал, что при заданном уровне технологии  . При современном уровне технологии
. При современном уровне технологии  . Предельная частота при отдаваемой мощности около 1 Вт составляет 10 ГГц.
. Предельная частота при отдаваемой мощности около 1 Вт составляет 10 ГГц.
 Мощные транзисторы отличаются большими напряжениями и токами коллектора, что и определяет особенности их структуры. Для достижения большого рабочего тока применяются многоэмиттерные структуры
Мощные транзисторы отличаются большими напряжениями и токами коллектора, что и определяет особенности их структуры. Для достижения большого рабочего тока применяются многоэмиттерные структуры
(рис. 3.39), содержащие большое число узких эмиттерных полосок, между которыми расположены выводы базы. Все эмиттеры расположены внутри одной базовой области, а их выводы объединяются общим эмиттерным выводом. Для повышения рабочих напряжений в мощном транзисторе увеличивают напряжение лавинного пробоя. С целью обеспечения хорошего теплоотвода кристалл мощного транзистора устанавливается на массивное металлическое основание корпуса, имеющее специальный радиатор.
Современные мощные транзисторы имеют предельный ток коллектора до 250 мА и рассеиваемую мощность до 600 Вт.
4. ПОЛЕВЫЕ ТРАНЗИСТОРЫ
4.1. Общие сведения о полевых транзисторах
Полевым транзистором называется полупроводниковый прибор, в котором электрический ток создается основными носителями заряда под действием продольного электрического поля, а управление током осуществляется поперечным электрическим полем управляющего электрода. Область полупроводника, по которой осуществляется дрейфовое движение основных носителей, называется каналом.
Электрод, от которого носители уходят в канал, называется истоком, а электрод, принимающий носители в конце канала – стоком. Исток и сток имеют одинаковый тип электропроводности (n или p). Управляющее поперечное поле создается с помощью электрода, называемого затвором.
Затвор должен быть изолирован от канала. В зависимости от способа изоляции различают:
– транзисторы с управляющим p-n-переходом, в котором изоляция затвора от канала осуществляется обедненным слоем p-n-перехода;
– транзисторы с изолированным затвором (изоляция затвора от канала осуществляется диэлектриком).
В качестве управляющего перехода используется p-n-переход или контакт металл-полупроводник (барьер Шотки).
Полевые транзисторы с изолированным затвором сокращенно называют МДП-транзисторами (М- металл, Д- диэлектрик, П- полупроводник).
МДП-транзисторы подразделяются на транзисторы со встроенным каналом и с индуцированным каналом. В МДП-транзисторах со встроенным каналом на стадии изготовления технологически создается (встраивается) проводящий канал путем введения соответствующей примеси.
Во втором случае канал индуцируется (возникает) только при подаче на изолированный затвор напряжения определенной полярности и величины.
В МДП-транзисторе со встроенным каналом и в транзисторе с управляющим переходом при нулевом напряжении на затворе существует канал и в нем протекает начальный ток при подаче напряжения между истоком и стоком.
Такие транзисторы называют МДП-транзисторами обедненного типа, т.к. управление током будет заключаться в уменьшении тока (обеднении канала). МДП-транзисторы с индуцированным каналом называют транзистором обогащенного типа, т.к. канал в нем появляется при подаче напряжения на затвор.
Условное графическое обозначение полевых транзисторов на схемах приведено на рис. 4.1.
| Наименование | Обозначение |
| Полевой транзистор с управляющим переходом с n-каналом и р-каналом | 
|
| Полевой транзистор с изолированным затвором обогащенного типа с n- каналом и р-каналом | 
|
| Полевой транзистор с изолированным затвором обедненного типа с n- каналом и p- каналом | 
|
Рис. 4.1
4.2. Полевой транзистор с управляющим p-n-переходом
Устройство и схема полевого транзистора с управляющим p-n-переходом показаны на рис. 4.2, а, б.
|
|
 Рис. 4.2
Рис. 4.2
На подложке из кремния р-типа создаётся тонкий слой полупроводника
n-типа, выполняющий функции канала, сопротивление которого регулируется электрическим полем. Нижний p-n-переход (канал-подложка) служит для установки начальной толщины канала. Прикладывая к затвору обратное напряжение  , можно изменять ширину верхнего p-n-перехода. При этом изменяется толщина канала, а следовательно, и его электропроводность. Изменяется величина тока стока
, можно изменять ширину верхнего p-n-перехода. При этом изменяется толщина канала, а следовательно, и его электропроводность. Изменяется величина тока стока  , протекающего по каналу под воздействием приложенного напряжения
, протекающего по каналу под воздействием приложенного напряжения  . При некотором обратном напряжении затвора можно добиться полного перекрытия канала. Это напряжение называется напряжением отсечки.
. При некотором обратном напряжении затвора можно добиться полного перекрытия канала. Это напряжение называется напряжением отсечки.
Если напряжение стока  равно нулю, толщина канала по всей его длине постоянна и равна
равно нулю, толщина канала по всей его длине постоянна и равна
 , (4.1)
, (4.1)
где  - толщина p-n-перехода, h-расстояние между металлургическими границами n-слоя (рис. 4.3),
- толщина p-n-перехода, h-расстояние между металлургическими границами n-слоя (рис. 4.3),  - концентрация донорной примеси в канале, y- толщина канала.
- концентрация донорной примеси в канале, y- толщина канала.

Рис. 4.3
Из (4.1) найдем  , полагая y=0.
, полагая y=0.
 . (4.2)
. (4.2)
Толщина канала  . (4.3)
. (4.3)
Начальная толщина канала при  равна
равна  .(4.4)
.(4.4)
Сопротивление канала при этом будет минимальным  ,
,
где  - удельное сопротивление канала,
- удельное сопротивление канала,
 и
и  – соответственно длина и ширина канала (рис. 4.2, б).
– соответственно длина и ширина канала (рис. 4.2, б).
С ростом напряжения на затворе сопротивление канала увеличивается:
 . (4.5)
. (4.5)
Если  , и транзистор закрывается.
, и транзистор закрывается.
Этот режим является режимом омического сопротивления, когда напряжение  близко к нулю.
близко к нулю.
При подаче на сток положительного напряжения сток – исток  в канале возникает ток стока
в канале возникает ток стока  , вследствие чего вдоль канала появляется падение напряжения. Величина падения напряжения зависит от координаты х, т.е. от расстояния до истока. Совместное воздействие напряжения
, вследствие чего вдоль канала появляется падение напряжения. Величина падения напряжения зависит от координаты х, т.е. от расстояния до истока. Совместное воздействие напряжения  и напряжения затвора
и напряжения затвора  изменяет ширину канала, которая становится переменной. Ширина канала будет минимальна у стока и максимальна у истока.
изменяет ширину канала, которая становится переменной. Ширина канала будет минимальна у стока и максимальна у истока.

Рис. 4.4
Подставляя в выражение (4.3) вместо  значения
значения  , получим напряжение стока
, получим напряжение стока  , называемое напряжением насыщения:
, называемое напряжением насыщения:
 , (4.6)
, (4.6)
при котором происходит перекрытие канала.
Через канал проходит максимальный ток стока  . (4.7)
. (4.7)
Транзистор работает в режиме насыщения. В отличие от режима отсечки при  перекрытие канала
перекрытие канала  вблизи стока не приводит к отсечке тока, а происходит отсечка его приращения
вблизи стока не приводит к отсечке тока, а происходит отсечка его приращения  . На этом участке перекрытия канала падает весь избыток напряжения
. На этом участке перекрытия канала падает весь избыток напряжения  , а напряжение на проводящей части канала остается равным
, а напряжение на проводящей части канала остается равным  .
.
На перекрытом участке ток протекает за счет экстракции носителей из канала в обедненную область, где под действием напряжения  экстрагируемые носители попадают на сток.
экстрагируемые носители попадают на сток.
Конфигурации канала при разных напряжениях стока и распределение напряжения вдоль канала приведены на рис. 4.4, а – д.
4.3. Статические характеристики полевого транзистора
с управляющим p-n-переходом
Полевые транзисторы могут включаться по схеме с общим истоком (ОИ), общим стоком (ОС) и общим затвором (ОЗ) (рис. 4.5, а, б, в).
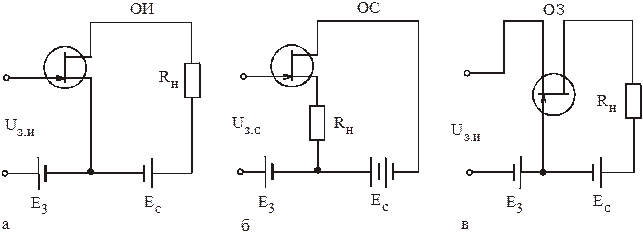
Рис. 4.5
Они имеют большие выходные и входные сопротивления, поэтому статические характеристики удобнее исследовать с помощью источников напряжения в качестве источников питания. Важнейшими характеристиками полевого транзистора являются выходные и передаточные (сток-затворные). Основной схемой включения полевого транзистора с управляющим p-n-переходом как усилителя колебаний является схема с общим истоком (рис. 4.5, а).
Выходные (стоковые) характеристики представляют зависимость тока стока от напряжения на стоке при различных постоянных напряжениях на затворе:  при
при  (рис. 4.6, а).
(рис. 4.6, а).

Рис. 4.6
На выходных характеристиках различают два участка: почти линейный участок при  и пологий участок при
и пологий участок при  , соответствующий режиму насыщения. Характеристики выходят из начала координат под углом, соответствующим начальному сопротивлению канала.
, соответствующий режиму насыщения. Характеристики выходят из начала координат под углом, соответствующим начальному сопротивлению канала.
При повышении напряжения стока  ток стока возрастает, но одновременно при этом увеличивается толщина канала по всей длине, увеличивается его сопротивление, и характеристики переходят в пологую часть.
ток стока возрастает, но одновременно при этом увеличивается толщина канала по всей длине, увеличивается его сопротивление, и характеристики переходят в пологую часть.
При напряжении насыщения  происходит перекрытие канала из-за увеличения толщины p-n-перехода затвора. Ток стока при дальнейшем увеличении напряжения стока почти не растет. Следует учитывать условность понятия «перекрытие» канала, т.к. само перекрытие канала является следствием увеличения тока стока. Можно считать, что в результате увеличения напряжения на стоке автоматически устанавливается некоторое малое сечение канала со стороны стока.
происходит перекрытие канала из-за увеличения толщины p-n-перехода затвора. Ток стока при дальнейшем увеличении напряжения стока почти не растет. Следует учитывать условность понятия «перекрытие» канала, т.к. само перекрытие канала является следствием увеличения тока стока. Можно считать, что в результате увеличения напряжения на стоке автоматически устанавливается некоторое малое сечение канала со стороны стока.
В канале устанавливается максимальный ток стока  . При дальнейшем увеличении напряжения стока сверх напряжения насыщения участок перекрытия канала увеличивается, и весь избыток напряжения падает на этом участке.
. При дальнейшем увеличении напряжения стока сверх напряжения насыщения участок перекрытия канала увеличивается, и весь избыток напряжения падает на этом участке.
Если на затвор подается обратное напряжение  , то перекрытие наступает при меньшем напряжении стока.
, то перекрытие наступает при меньшем напряжении стока.
Ток стока на участке насыщения можно описать уравнением Шокли, предложившим этот прибор:
 . (4.8)
. (4.8)
Передаточные (сток-затворные) характеристики определяют зависимость  при
при  (рис. 4.6, б).
(рис. 4.6, б).
При напряжении затвора равном нулю сечение канала максимально и ток стока имеет максимальную величину. Увеличение обратного напряжения на затворе сопровождается расширением p-n-перехода и сужением канала. Сопротивление канала возрастает, и ток стока уменьшается.
При некотором напряжении затвора, равном напряжению отсечки, канал полностью перекрывается, и ток стока практически уменьшается до нуля.
Передаточную характеристику полевого транзистора в режиме насыщения можно описать уравнением
 . (4.9)
. (4.9)
4.4. Полевой транзистор с управляющим переходом
типа металл – полупроводник
С момента своего появления в 1970 г. полевой транзистор на арсениде галлия (GaAs) занял важное место в полупроводниковой СВЧ-электронике. Основным преимуществом приборов на GaAs является более высокая скорость электронов, обеспечивающая большее быстродействие, и хорошие изолирующие свойства, позволившие уменьшить паразитные емкости и упростить процесс изготовления.
Они могут иметь затвор с управляющим p-n-переходом или на основе барьера Шотки (контакта металл-полупроводник). Во многих случаях эти приборы изготавливают непосредственно ионным внедрением примеси в полуизолирующую подложку из GaAs. Изолирующие свойства связаны с большей шириной запрещенной зоны (1,42 эВ) по сравнению с кремнием. Схематичное изображение полевого транзистора с барьером Шотки (ПТШ) на основе GaAs показано на рис. 4.7.
Принцип его работы аналогичен полевому транзистору с управляющим
p-n- переходом. Подложка может выбираться n- и p-типа.

Рис. 4.7
4.5. Полевые транзисторы с изолированным затвором
Структуры полевых транзисторов с индуцированным и встроенным каналами приведены на рис. 4.8, а, б, в.
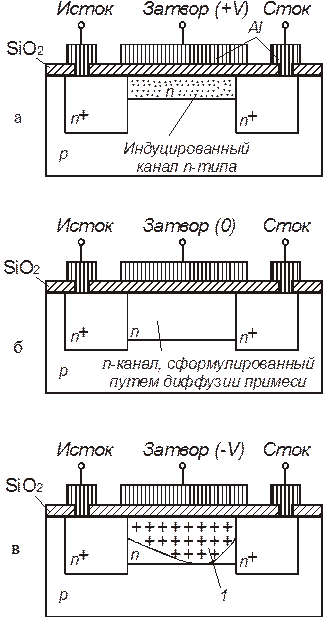
Рис. 4.8
В транзисторах с индуцированным каналом (рис. 4.8, а) на подложке n- или p-типа методом диффузии создаются области истока и стока, не имеющие между собой соединения и с противоположным относительно подложки типом электропроводности. Поверхность подложки покрывается слоем диэлектрика (двуокись кремния), на которую наносится металлический электрод, являющийся затвором. В результате получается структура металл-диэлектрик-полупроводник.
При напряжении на затворе относительно истока равном нулю и заданном напряжении между стоком и истоком ток в цепи стока ничтожно мал. Он представляет собой обратный ток p-n-перехода между подложкой и областью стока.
При положительном напряжении на затворе больше Uз.и.пор. в результате проникновения электрического поля через слой диэлектрика в полупроводник под затвором возникает инверсный слой, который является проводящим каналом между истоком и стоком: n+-n-n+. С изменением напряжения на затворе изменяется концентрация носителей заряда в канале, а также поперечное сечение канала, в результате чего изменяется ток стока. Так как ток в цепи затвора очень мал, мала и мощность, потребляемая от источника сигнала в цепи затвора, необходимая для управления относительно большим током стока, это значит МДП-транзистор с индуцированным каналом работает в режиме обогащения канала носителями заряда.
В транзисторах со встроенным каналом (рис. 4.8, б) проводящий канал под затвором может быть сформирован на стадии изготовления транзистора. Тип проводимости канала противоположен типу подложки. Принцип действия и физические процессы в транзисторах с индуцированным и встроенным каналом одинаковы. Модуляция сопротивления проводящего канала МДП-тран-зистора со встроенным каналом (рис. 4.8, в) может происходить при изменении напряжения на затворе как положительной, так и отрицательной полярности. Такой транзистор может работать в режиме обогащения и в режиме обеднения канала носителями заряда. Эта особенность МДП-транзистора со встроенным каналом отражается на статических характеристиках.

Рис. 4.9
На рис. 4.9, а-г приведены схемы включения МДП-транзисторов с ОИ. Для транзисторов с индуцированными каналами цепь исток – сток изображается штриховой линией (рис. 4.9, а, б), а для транзисторов со встроенными каналами – сплошной (рис. 4.9, в, г). Для транзисторов с каналом n-типа стрелка направлена в сторону канала от подложки, для транзисторов с каналом р-типа направление стрелки противоположно.
4.6. Статические характеристики МДП-транзисторов
Выходные характеристики 
 при
при  с индуцированным и встроенным каналами приведены на рис. 4.10, а, б.
с индуцированным и встроенным каналами приведены на рис. 4.10, а, б.
Дата добавления: 2020-10-14; просмотров: 210;










