Обратное рассеяние Резерфорда
Этот метод применяется для определения наличия аморфных областей или нахождения расположения примесных атомов в кристаллической решетке. Если направление первичного ионного пучка параллельно кристаллографической плоскости высокой симметрии решетки, то можно сказать, что пучок идет вдоль кристаллографических каналов. Ионы отражаются под малыми углами в результате столкновений с ядрами атомов, расположенных в узлах кристаллической решетки, и пучок углубляется в образец на расстояния, много большие, чем при произвольной ориентации "пучок - образец". Вследствие этого, очень сильно снижается интенсивность обратного рассеяния Резерфорда.

Рис. 1.
На рис.1 представлена зависимость интенсивности от угла наклона и от энергии первичного пучка ионов. Нарушения совершенства кристаллической структуры образца (межузельные атомы или линейные дефекты) приводят к значительному повышению интенсивности, при нахождении в области каналирования. В предельном случае аморфного образца интенсивность становится равной интенсивности ОРР от случайно расположенного образца.
Для анализа распределения атомов примеси регистрируют спектры ОРР от образца в случайном положении (Н) и в положении каналирования (НА). Затем сравнивают минимальные интенсивности для сигналов легирующей примеси и для кремния. Атомы примеси в узлах решетки (примеси замещения) экранируются атомами кремния, поэтому не вносят никаких особенностей в интенсивность вторичного пучка. Если же атомы примеси находятся в междоузлиях (примеси внедрения), то отношение интенсивностей НА/Н пропорционально возрастает. По степени этого роста и определяют долю примесных атомов.
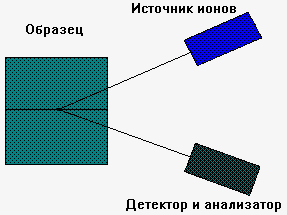
Рис. 2.
На рис. 2 приводится примерная схема измерений ОРР. Облучение происходит пучком ионов (обычно Не+) с энергией от 1 до 3 МэВ. Диаметр пучка составляет от 10 мкм до 1 мм.
Метод ОРР часто применяют для химического анализа сложных структур.
Исследование химического состава пленок
Оже-спектроскопия
Требования к пространственному разрешению, предъявляемые к многочисленным методам химического анализа материалов, применяемых при изготовлении СБИС, варьируются от атомных размеров (как при исследовании профилей распределения по глубине интерметаллидов и атомов легирующих примесей) до макроскопических величин (например, при интегральном анализе больших участков пленок или подложек). Для разных методов анализа различаются требования к разрешению в плоскости и по глубине. Требования к чувствительности анализа варьируются от 1011 до 1021 см-3. Химическими веществами, присутствие которых необходимо контролировать при таких исследованиях, являются легирующие примеси в кремнии (мышьяк, фосфор, бор), а также кислород, углерод, следы резиста, различные компоненты металлизации и металлические примеси. Таким образом, спектр исследуемых химических элементов распространяется от легких до тяжелых, таких, как платина, золото и вольфрам элементов.
Дата добавления: 2020-11-18; просмотров: 232;










