Эпитаксия в технологии ИМС
Эпитаксия это процесс ориентированного выращивания монокристал-лических слоёв на поверхности монокристаллических подложек. В технологии кремниевых полупроводниковых приборов и ИМС эпитаксия используется для создания слабо легированных слоёв на сильно легированных подложках или подложках другого типа проводимости.
Пример использования эпитаксии для создании дискретного СВЧ биполярного транзистора показан на рис. 4.1. Использование эпитаксии в данном примере позволяет получить биполярный транзистор с пониженным сопротивлением коллектора при достаточно высоком пробивном напряжении перехода «коллектор–база».
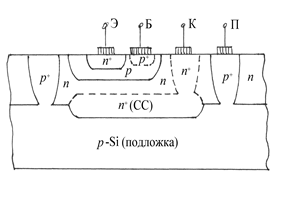
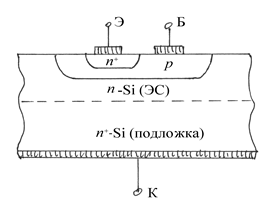 |
В биполярных ИМС эпитаксиальный слой вместе с разделительной диффузией бора позволяет осуществлять электрическую изоляцию карманов и находящихся в них элементов друг от друга (рис. 4.2). Для уменьшения сопротивления коллектора интегральных биполярных транзисторов используются сильно легированные скрытые n+-слои, создаваемые локальной диффузией сурьмы перед процессом эпитаксии. С этой же целью создают глубокие (до соединения со скрытым слоем) n+-области подлегирования коллектора.
 |  |
В технологии ИМС на арсениде галлия используется гетероэпитаксия слоёв тройного полупроводникового соединения AlxGa1–xAs на подложках GaAs. С её помощью создают полевые транзисторы на барьерах Шоттки с высокой подвижностью носителей заряда – электронов (HEMT) (рис. 4.3). В канале таких транзисторов, расположенных на межфазной границе AlxGa1–xAs/GaAs, образуется область двумерного электронного газа с повышенной подвижностью носителей заряда. Ещё одним примером
 |  | ||
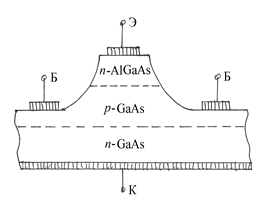
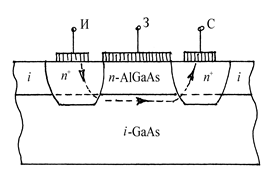 применения гетероэпитаксии являются биполярные гетероэпитаксиальные транзисторы (ГБТ), в которых гетеропереход AlxGa1–xAs–GaAs служит эмиттером (рис. 4.4). Гетероэпитаксия полупроводниковых соединений широко используется при создания светодиодов и гетеролазеров.
применения гетероэпитаксии являются биполярные гетероэпитаксиальные транзисторы (ГБТ), в которых гетеропереход AlxGa1–xAs–GaAs служит эмиттером (рис. 4.4). Гетероэпитаксия полупроводниковых соединений широко используется при создания светодиодов и гетеролазеров.
Эпитаксия кремния
В технологии кремниевых полупроводниковых приборов и ИМС используются два метода эпитаксии – хлоридный и гидридный.
В хлоридном методе используется реакция восстановления хлоридов кремния водородом,
SiCl4 + 2H2 « Si + 4HCl;
SiHCl3 + H2 « Si + 3HCl;
SiH2Cl2 « SiCl2 + H2;
SiCl2 + H2 « Si + 2HCl.
Зависимость скорости эпитаксиального роста от температуры имеет аррениусовский характер для всех приведённых реакций (рис. 4.5, кривые 1–3). Оптимальная температура процесса 1150…1250 °С, которая выбирается в области В с меньшей энергией активации, чем в области A (EB < EA). В области B лимитирующей стадией является диффузионная доставка реагентов и отвод продуктов (диффузионный контроль), тогда как в области A лимитирующей стадией является скорость поверхностных химических реакций (кинетический контроль). Скорость эпитаксиального роста с увеличением молярной концентрации исходного реагента хлорида кремния сначала линейно растёт, затем после достижения максимума падает, и, наконец, при больших концентрациях хлорида кремния рост эпитаксиального слоя сменяется его травлением (рис. 4.6). Травление осуществляется продуктом реакции – газообразным хлористым водородом при больших его концентрациях.
В гидридном методе используется реакция разложения гидрида кремния на поверхности нагретой подложки
SiН4 « Si + 2H2.
 |  | ||
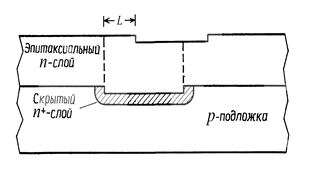
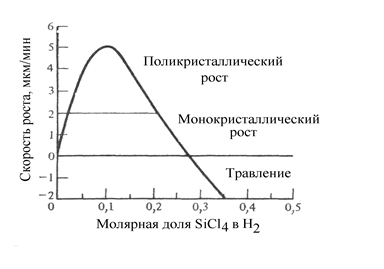
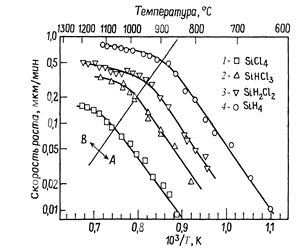 Зависимость скорости эпитаксиального роста от температуры также имеет аррениусовский характер (рис. 4.5, кривая 4). Оптимальная температура процесса ниже, чем у хлоридного, и составляет 1050...1150 °С. Зависимость скорости эпитаксиального роста от молярной концентрации исходного реагента гидрида кремния имеет линейный характер.
Зависимость скорости эпитаксиального роста от температуры также имеет аррениусовский характер (рис. 4.5, кривая 4). Оптимальная температура процесса ниже, чем у хлоридного, и составляет 1050...1150 °С. Зависимость скорости эпитаксиального роста от молярной концентрации исходного реагента гидрида кремния имеет линейный характер.
 В обоих методах при высоких скоростях эпитаксии наблюдается поли-кристаллический рост (см. 4.6), а также имеет место зависимость скорости эпитаксиального роста от ориентации поверхности кремниевой подложки: U(110) : U(100) : U(111) = = 1.3 : 1 : 0.6. Ориентационная зависимость эпитаксиального роста обуславливает снос рельефа подложки L в процессе эпитаксиального роста (рис. 4.7), который необходимо учитывать при проведении после-дующих операций фотолитографии.
В обоих методах при высоких скоростях эпитаксии наблюдается поли-кристаллический рост (см. 4.6), а также имеет место зависимость скорости эпитаксиального роста от ориентации поверхности кремниевой подложки: U(110) : U(100) : U(111) = = 1.3 : 1 : 0.6. Ориентационная зависимость эпитаксиального роста обуславливает снос рельефа подложки L в процессе эпитаксиального роста (рис. 4.7), который необходимо учитывать при проведении после-дующих операций фотолитографии.
Хлоридный метод характеризуется меньшей плотностью эпитаксиальных дефектов упаковки в эпитаксиальных слоях. Гидридный метод с менее высокой температурой процесса эпитаксии приводит к меньшему уширению концентрационного перехода «эпитаксиальный слой–подложка».
Дата добавления: 2016-12-16; просмотров: 2551;










