Физические основы излучения света в p-n переходе
В полупроводниках, которые используются для изготовления светоизлучающих p-n переходов, разрешенные уровни энергии электронов образуют зонную структуру, содержащую зону проводимости, валентную и запрещенную зоны.
Значения энергии, которыми может обладать электрон, представляют собой набор отдельных уровней, разделенных интервалами энергий, которыми электроны обладать не могут. На каждом энергетическом уровне, согласно принципу Паули, может находиться не более двух электронов (с противоположными спинами). Остальные электроны, если они имеются в атоме, распределены по другим разрешенным уровням.
Поскольку вне разрешенных уровней электрон находиться не может, он изменяет свою энергию в атоме скачкообразно, перепрыгивая с одного уровня энергии на другой.
 Рис. 5.2. Энергетические зоны
Рис. 5.2. Энергетические зоны
|
При образовании кристалла атомы сближаются и в кристаллическую решетку попадает огромное число электронов, имеющих в изолированных атомах одни и те же уровни энергии. В такой ситуации на каждом энергетическом уровне должно было бы оказаться число электронов, равное удвоенному числу атомов (а плотность атомов в кристалле составляет 5.1022см-3). Но это противоречит принципу Паули. На самом деле уровни энергий взаимодействующих атомов расщепляются, образуя целые группы подуровней, так чтобы на каждом находилось не более двух электронов. Так возникают энергетические зоны (рис. 5.2). При ширине зоны около 1 эВ расстояние между соседними подуровнями примерно 10-22 эВ, поэтому зону можно рассматривать как сплошную полосу и считать, что в ее пределах электрон может изменять свою энергию не скачками, а почти плавно.
Самая высокая зона разрешенных уровней внутри материала - зона проводимости. Она обычно мало заселена при низких температурах, при этом валентная зона заселена почти полностью. В невозбужденном состоянии (T = 0 K) валентная зона заполнена, а зона проводимости пуста. Поскольку электропроводность создается свободными электронами в зоне проводимости, то при T = 0 K полупроводник ведет себя как диэлектрик.
Зона проводимости отделена от валентной зоны энергетическим зазором Wg(ширина запрещенной зоны).
 Рис. 5.3. Кристаллическая решетка кремния
Рис. 5.3. Кристаллическая решетка кремния
|
На рис. 5.3 показан кристалл кремния. При его образовании атомы сближаются настолько, что их электронные оболочки перекрываются. На внешней (валентной) оболочке кремния имеется 4 электрона, которые могут использоваться для образования связей с четырьмя соседними атомами. За счет того, что каждый из соседних атомов отдает в образующиеся связи по электрону, во внешней оболочке каждого атома оказывается как бы по 8 электронов и она полностью заполняется. Это состояние с минимальной энергией, следовательно оно является стабильным. Любое разрушение связей, например, для удаления из них электронов (для превращения их в свободные носители зарядов) требует сообщения дополнительной энергии – энергии активации (для кремния 1.12 эВ).
Электрон-вольт (эВ) - внесистемная единица энергии, равная энергии, приобретаемой элементарным зарядом (электроном) под действием разности потенциалов 1 В (1эВ = 1,6·10-19 Дж).
Под действием внешней энергии в результате поглощения фонона (теплового кванта) или фотона (светового кванта) с энергией, превышающей ширину запрещенной зоны, электрон из валентной зоны может занять одно из состояний в зоне проводимости и оставить в валентной зоне свободное место (называемое дыркой). Происходит генерация электрона и дырки.
Одновременно с генерацией носителей идет процесс регенерации (рекомбинации), в результате которого электрон из зоны проводимости переходит в валентную зону. Электрон и дырка исчезают с выделением кванта энергии (фотона или фонона). Оба процесса идут одновременно и в стационарном режиме (режиме динамического равновесия) их скорости одинаковы.
Полупроводник, не содержащий примесей, или полупроводник, в котором можно пренебречь влиянием примесей при данной температуре, называется собственным полупроводником или полупроводником i‑типа (от английского intrinsic [in’trinsik] - собственный, присущий). В собственном полупроводнике концентрации электронов n и дырок p одинаковы и зависят от температуры.

 (5.1)
(5.1)
где me и mh - эффективные массы электронов и дырок, которые могут быть меньше массы покоя электрона (9,11×10-31 кг), k = 1,38×10-23 Дж/град - постоянная Больцмана, h = 6,624×10-34 Дж×с – постоянная Планка.
Электрические свойства собственных полупроводников могут быть изменены добавлением некоторого количества примесей, которые могут создавать избыток электронов (n-тип) или дырок (p-тип). Различают два вида примесей донорные и акцепторные.
Примером донорной примеси может служить примесь атомов мышьяка As в кристалле кремния (рис. 5.4а). As является пятивалентным. Поэтому четыре его валентных электрона образуют ковалентные связи с атомами кремния, а пятый оказывается незадействованным. Энергия активации для такого электрона значительно меньше (0.049 эВ), то есть атомы-доноры значительно быстрее теряют донорные электроны. Такие полупроводники называют донорными или полупроводниками n‑типа.
| а) | 
| б) | 
|
| Рис. 5.4. Кремний с донорной (а) и акцепторной (б) примесями |
Примером акцепторной примеси является примесь трехвалентного индия In в кристалле кремния (рис. 5.4б). Для образования связей с четырьмя соседними атомами ему не хватает одного валентного электрона. В этом случае атом примеси может легко захватить недостающий электрон у соседнего атома кремния. В результате у атома кремния возникает неполная связь, способная перемещаться по кристаллу (дырка). Такие полупроводники называют акцепторными или полупроводниками p‑типа.
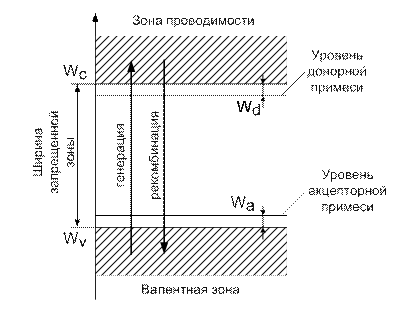 Рис. 5.6. Энергетическая диаграмма легированного материала
Рис. 5.6. Энергетическая диаграмма легированного материала
|
Энергетические диаграммы для легированных материалов приведены на рис. 5.5.
В легированном материале имеются основные носители (свободные электроны в материале n-типа и дырки в материале p-типа) и неосновные носители (дырки в материале n-типа и электроны в материале p-типа). В легированных материалах обычно концентрация примесей настолько высока, что она, а не температура, является основным фактором, определяющим число свободных носителей и, следовательно, электрическую проводимость.
Произведение концентрации n носителей отрицательного заряда (электронов) на концентрацию p носителей положительного заряда (дырок) равно постоянной величине  , которая зависит только от вида вещества и температуры.
, которая зависит только от вида вещества и температуры.
 , (5.2)
, (5.2)
гдеni -концентрация носителей заряда в материале без примесей.
В целом полупроводник остается нейтральным. Можно показать, что если концентрация донорных примесей NDнамного больше концентрации акцепторных примесей NA (  ), то выполняются соотношения
), то выполняются соотношения
 :
: 
 (5.3)
(5.3)
и, наоборот, если  , то
, то
 :
: 
 .
.
Рассмотрим электрический переход, образованный полупроводником p‑типа и полупроводником n‑типа, имеющими одинаковую ширину запрещенной зоны. Такой переход называют гомогенным p‑n переходом (рис. 5.5).

|
| Рис. 5.6. Гомогенный p-n переход в состоянии равновесия. |
Поскольку в полупроводнике p‑типа концентрация дырок существенно выше концентрации дырок в полупроводнике n‑типа (  ), то при возникновении контакта этих полупроводников возникнет диффузионный поток дырок из p‑области в n‑область. Аналогично, поскольку
), то при возникновении контакта этих полупроводников возникнет диффузионный поток дырок из p‑области в n‑область. Аналогично, поскольку  возникнет диффузионный поток электронов из n‑области в p‑область (рис. 5.6). Диффундируя во встречных направлениях через пограничный слой, дырки и электроны рекомбинируют. Поэтому область контакта оказывается сильно обедненной свободными носителями заряда и приобретает большое сопротивление. Кроме того, на границе оказывается двойной электрический слой, образованный отрицательными ионами акцепторной примеси и положительными ионами донорной примеси. Этот слой создает электрическое поле, препятствующее дальнейшему переходу основных носителей заряда. Под действием поля возникают дрейфовые потоки неосновных носителей заряда. Средняя скорость дрейфа по направлению вектора напряженности электрического поля пропорциональна напряженности поля. Коэффициент пропорциональности называется подвижностью соответствующих носителей заряда.
возникнет диффузионный поток электронов из n‑области в p‑область (рис. 5.6). Диффундируя во встречных направлениях через пограничный слой, дырки и электроны рекомбинируют. Поэтому область контакта оказывается сильно обедненной свободными носителями заряда и приобретает большое сопротивление. Кроме того, на границе оказывается двойной электрический слой, образованный отрицательными ионами акцепторной примеси и положительными ионами донорной примеси. Этот слой создает электрическое поле, препятствующее дальнейшему переходу основных носителей заряда. Под действием поля возникают дрейфовые потоки неосновных носителей заряда. Средняя скорость дрейфа по направлению вектора напряженности электрического поля пропорциональна напряженности поля. Коэффициент пропорциональности называется подвижностью соответствующих носителей заряда.
Через некоторое время диффузионный и дрейфовый потоки уравновешивают друг друга:
 ,
,  . (5.4)
. (5.4)
Это означает отсутствие переноса носителей через переход.
Энергетическая диаграмма p-n перехода приведена на рис. 5.6. На ней видно, что в приграничной области происходит изгиб энергетических зон таким образом, что для перехода из одного полупроводника в другой носителям требуется дополнительная энергия. В p-полупроводнике зоны изгибаются вниз, создавая потенциальный барьер для дырок, в n-полупроводнике изгибаются вверх, создавая потенциальный барьер для электронов.
При приложении к p‑n переходу внешнего напряжения равновесие (5.4) нарушится и через переход потечет ток. Говорят, что к p‑n переходу приложено прямое напряжениеили, что переход смещен в прямом направлении, если «+» источника подан на p‑область, а «‑» — на n‑область. Напряжение обратной полярности называют обратными говорят, что переход смещен в обратном направлении. За положительное принимают направление тока, протекающего под действием прямого напряжения.
Внешнее напряжение изменяет высоту потенциального барьера в переходе (рис. 5.7). При приложении прямого напряжения потенциальный барьер уменьшается на величину внешнего напряжения. Таким образом, большее число основных носителей может его преодолеть и через переход начинает течь большой ток. При обратном напряжении потенциальный барьер увеличивается на величину внешнего напряжения. Ток через переход мал.
| а) | 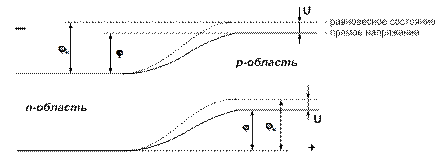
|
| б) | 
|
| Рис. 5.7. Энергетические диаграммы гомогенного p-n перехода, смещенного в прямом (а) и обратном (б) направлении |
Излучение в p-n переходе возможно только при его прямом смещении, когда через переход протекает значительный ток.
Концентрация носителей заряда в переходе возрастает с увеличением тока, что приводит к возрастанию скорости рекомбинации носителей, при которой исчезает пара носителей электрон и дырка. Рекомбинация бывает излучательная, когда при исчезновении электрона и дырки возникает фотон, и безызлучательная, когда энергия носителей переходит в тепловую энергию решетки (возникает фонон – тепловой квант) или передается третьему носителю в виде кинетической энергии (ударная рекомбинация или рекомбинация Оже).
Одним из параметров источника излучения является внутренняя квантовая эффективность hвнутр, которую можно определить как отношение числа актов излучательной рекомбинации к общему числу актов рекомбинации. Хороший источник, конечно, должен иметь высокую внутреннюю квантовую эффективность. Однако этого недостаточно, необходимо также эффективно вывести излучение из перехода. Можно выделить несколько основных причин, по которым нельзя вывести из перехода все возникшие фотоны (рис. 5.8).

|
| Рис. 5.8. Вывод излучения |
1. Излучение, возникающее в результате излучательной рекомбинации, характеризуется отсутствием направленности – оно генерируется равномерно во все стороны. Часть его вообще не достигает излучающей поверхности источника, образуя обратное (лучи 3 на рис. 5.8) и торцевое (лучи 4) излучение. Таким образом, при одностороннем выводе света теряется, как минимум, половина.
2. К излучающей поверхности свет подходит под разными углами. Материал полупроводника имеет показатель преломления больше воздуха. Поэтому для части излучения (лучи 2) выполняется условие полного внутреннего отражения и оно остается внутри полупроводника. Кроме того, на границе раздела возникают и обычные потери на отражение.
3. Наконец, часть излучения поглощается материалом полупроводника, не успев достичь излучающей поверхности (лучи 1). Это явление называют самопоглощением.
Отношение числа фотонов, вышедших из полупроводника, к общему числу актов рекомбинации, называется внешней квантовой эффективностью hвнеш или квантовым выходом. Внешняя квантовая эффективность hвнеш всегда меньше внутренней hвнутр.
Дата добавления: 2020-10-25; просмотров: 325;










