Принцип действия переключательного диода
Для выполнения функций переключения СВЧ сигналов и ограничения мощности используются диоды с pin-структурой с протяженным слоем, близким по свойствам с собственному полупроводнику. Такой диод был впервые применен Холлом в 1952 г. а качестве мощного выпрямительного диода. При добавлении i-слоя, называемого базовой областью, увеличивается напряжение пробоя и снижается удельная емкость структуры, поэтому можно увеличить ее площадь сечения и максимальный допустимый ток при умеренной емкости. Эти же достоинства сыграли главную роль при последующем использовании pin-диодов для переключения мощных сигналов СВЧ диапазона [8, 10].
Профиль pin-структуры с тонкими p+- и n+-слоями, сформированными диффузией примесей, показан на рис. 4.1.
| |
| |
|
Рис. 4.1. Типичный профиль легирования pin-диода
|
| | | |
Как правило, мощные переключательные диоды изготавливаются из Si. Чтобы задать определенные параметры базовой области, очищенный материал легируют с низкой концентрацией акцепторной примеси (слаболегированный p-тип на рисунке обозначен буквой p) или донорной примеси (слаболегированный n-тип обозначается буквой n). Типичное удельное сопротивление слоя составляет 104 Ом · см при концентрации примеси порядка 1012 см–3. Толщина высокоомной базы может изменяться от единиц микрометров до десятых долей миллиметра в зависимости от мощности диода и его рабочей частоты. Тонкие приконтактные слои имеют максимальный уровень легирования, который может превышать 1020 см–3.
Эквивалентная схема диода представлена на рис. 4.2.
| |
| |
| Рис. 4.2. Эквивалентная схема pin-диода
|
| | | |
Она содержит следующие элементы:
Cp – емкость корпуса;
Ls – индуктивность выводов;
Rs – последовательное сопротивление, относящееся к сильнолегированным областям диода, включая сопротивление контактов;
Cf – краевая емкость, определяемая подводимыми контактами при отсутствии полупроводниковой структуры с металлизацией;
Cd – диффузионная емкость диода (при прямом смещении).
Базовая область в общем случае содержит 2 участка: с концентрацией носителей, заданной легированием, и обедненный (при обратном смещении). В эквивалентной схеме они представлены соответственно цепочками Ri Ci и Rj Cj (пояснение см. ниже).
Рассмотрим работу pin-диода при обратном смещении (см. рис. 4.3), для упрощения взята структура со ступенчатыми переходами; базовая область толщиной w представляет собой слаболегированный акцепторный полупроводник. Рис. 4.3 , а соответствует режиму малого обратного напряжения на диоде. ОПЗ сосредоточена вблизи pn+-перехода, ее основная часть находится в базе, которая разделена на участок полного обеднения толщиной a и необедненный участок толщиной w – a . При увеличении (по абсолютному значению) обратного смещения граница этих участков смещается влево вплоть до обеднения всей базовой области и затем проникает на небольшую глубину в p+-область, как показано на рис. 4.3 , б.
Таким образом, наиболее важные физические процессы происходят в базовой области, которая вносит основной вклад в импеданс диода. Для отражения этих процессов эквивалентная схема, приведенная на рис. 4.2, может быть существенно упрощена, как показано на рис. 4.4 , а. Диффузионная емкость диода в режиме обратного смещения отсутствует.
| |
| |
|
Рис. 4.4. Упрощение эквивалентной схемы переключательного диода при обратном смещении
|
| | | |
Для обедненного участка базы оправдано допущение Rj Þ¥ , это сопротивление может быть удалено из схемы. При низкой концентрации примеси в i-области для СВЧ диапазона справедливо также допущение  . Поэтому сопротивление Ri вносит вклад в активную компоненту импеданса диода, но практически не влияет на его реактивную компоненту. Можно считать, что
. Поэтому сопротивление Ri вносит вклад в активную компоненту импеданса диода, но практически не влияет на его реактивную компоненту. Можно считать, что  , где S – площадь диодной структуры. Это означает, что при изменении напряжения смещения и перемещении границы участков базовой области изменяется соотношение компонент Xi и Xj , а их сумма остается практически постоянной, она определяется размерами слаболегированного i-слоя. Сопротивление Ri легко рассчитывается для каждого значения напряжения смещения с учетом концентрации примеси и толщины w – a необедненного участка базы. После этого можно найти элементы последовательной эквивалентной схемы i‑области, которая чаще используется при анализе и проектировании приборов и устройств на их основе.
, где S – площадь диодной структуры. Это означает, что при изменении напряжения смещения и перемещении границы участков базовой области изменяется соотношение компонент Xi и Xj , а их сумма остается практически постоянной, она определяется размерами слаболегированного i-слоя. Сопротивление Ri легко рассчитывается для каждого значения напряжения смещения с учетом концентрации примеси и толщины w – a необедненного участка базы. После этого можно найти элементы последовательной эквивалентной схемы i‑области, которая чаще используется при анализе и проектировании приборов и устройств на их основе.
Типичная зависимость параметров этой схемы от напряжения смещения представлена на рис. 4.5. Расчетное значение сопротивления i‑области снижается до нуля при напряжении полного обеднения базы, его экспериментальное значение при этом перестает изменяться, оно близко к паразитному последовательному сопротивлению Rs .
| | 
| |
|
Рис. 4.5. Зависимость параметров упрощенной эквивалентной схемы pin‑диода от напряжения обратного смещения
|
| | | |
На практике обратное рабочее напряжение для переключательного диода выбирается немного ниже напряжения обеднения, как показано на рисунке. Реактивная компонента импеданса диода практически не изменяется, она значительно превышает активную компоненту. Можно считать, что импеданс диода при обратном смещении фактически определяется емкостью i‑области с незначительной активной добавкой. Емкостная проводимость pin-диода на рабочей частоте мала, и импеданс оказывается весьма высоким, т. е. диод в таком режиме близок по параметрам к разомкнутому ключу. Возможности дополнительного повышения импеданса диодного переключателя на рабочей частоте обсуждаются в разделе 4.3.
Рассмотрим теперь работу pin-диода при прямом смещении. В этом режиме снижаются энергетические барьеры на границах i‑области, и в нее инжектируются носители заряда обоих знаков (поэтому pin-диод называют также диодом с двойной инжекцией). При высоком уровне инжекции базовая область заполняется электронно-дырочной плазмой в которой концентрация частиц может быть значительно выше уровня легирования. Качественная картина распределения концентрации носителей заряда в структуре показана на рис. 4.6. Использованы общепринятые обозначения для концентраций частиц. Уровень легирования i‑области мал, он соответствует значению pi .
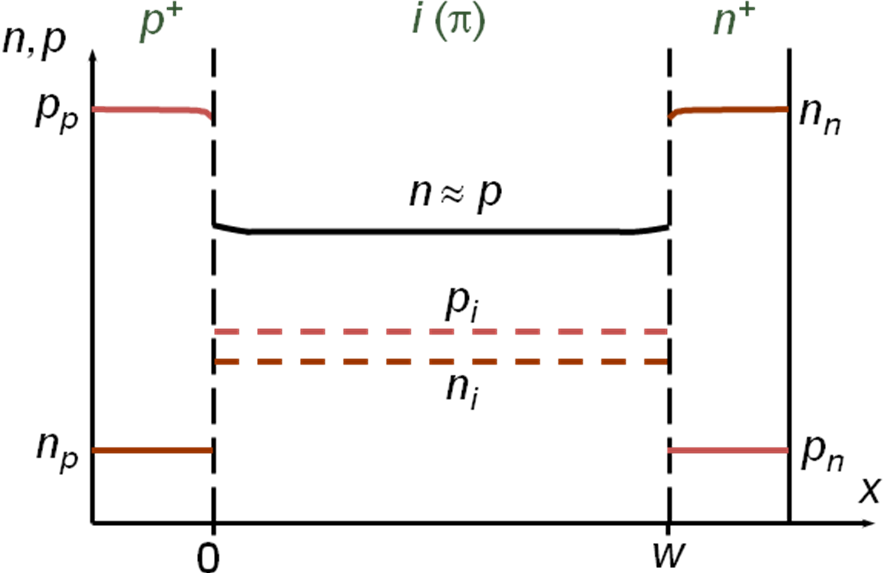
|
|
Рис. 4.6. Распределение концентрации носителей заряда в pin-диоде при высоком прямом смещении
|
В рассматриваемом режиме выполняется упрощенное неравенство
 . .
| (4.1)
|
Инжекционные токи электронов и дырок на границах i‑области определяются соответствующими концентрациями носителей, т. е. на левой границе преобладает ток дырок, а на правой – ток электронов. С учетом соотношения (4.1) можно записать
 ; ;  , ,
| (4.2)
|
где I 0 – полный ток в структуре.
Это означает что входящие в базовую область токи электронов и дырок равны и идут практически полностью на рекомбинацию носителей друг с другом. Связь концентрации носителей заряда в i‑области с током удовлетворяет уравнению
 , ,
| (4.3)
|
где Qn , и Qp равны соответственно зарядам накопленных электронов и дырок в базе, при которых скорость рекомбинации уравновешивает потоки инжектируемых током I 0 носителей. Их взаимная рекомбинация требует равенства значений времени жизни носителей заряда. Следовательно, согласно (4.3), концентрации накопленных в i‑области электронов и дырок в рассматриваемом режиме должны быть равны, что и отражено на рис. 4.6.
Необходимо отметить, что приведенное на рисунке слабое изменение концентраций инжектированных носителей вдоль структуры реализуется только при условии, что их диффузионные длины превышают толщину i‑области. Напомним что в чистом Si эти длины могут достигать 1 мм [6].
С учетом полученных соотношений можно оценить удельное сопротивление базовой области в режиме высокого уровня инжекции в зависимости от заданного прямого тока смещения:
 , ,
| (4.4)
|
где  – среднее значение подвижности электронов и дырок.
– среднее значение подвижности электронов и дырок.
Окончательное выражение для сопротивления базы при рассмотренных условиях принимает вид
 . .
| (4.5)
|
При увеличении тока смещения обратно пропорционально ему снижается сопротивление базы, определяемое концентрацией инжектированных носителей заряда. Эта зависимость может выполняться в диапазоне изменения тока на несколько порядков, как показано на рис. 4.7. При этом активное сопротивление быстро становится ниже включенного параллельно ему реактивного сопротивления и определяет полный импеданс диода. При малых значениях сопротивления (обычно порядка 1 Ом) кривая перестает снижаться, остаточное значение соответствует паразитному последовательному сопротивлению Rs , не зависящему от тока. Дальнейшее повышение тока не имеет смысла, и рабочий ток обычно задается вблизи начала участка насыщения сопротивления, его значение для различных диодов может составлять от единиц до 100 мА.
| |
| |
| Рис. 4.7. Изменение активного сопротивления базы диода в зависимости от тока прямого смещения
|
| | | |
В данном режиме в эквивалентной схеме диода следует дополнительно учитывать последовательно соединенную с Ri индуктивность выводов, которая на СВЧ может дать заметный вклад при столь низком значении импеданса активной области прибора.
Изменение импеданса диода между двумя рассмотренными состояниями при переключении смещения от обратного к прямому и обратно качественно иллюстрируется на рис. 4.8.
| |
| |
| Рис. 4.8. Изменение импеданса диода при переключении
|
| | | |
Инерционность процессов установления низкоомного состояния и восстановления высокого импеданса определяется эффектами накопления носителей заряда в базовой области и их вытягивания при обратном напряжении диода. Для приборов различного уровня мощности время переключения может составлять от единиц наносекунд (при управляемой импульсной мощности в несколько ватт) до единиц микросекунд и выше (при мощности в несколько киловатт). При этом мощность, рассеиваемая в самом диоде, оказывается примерно на порядок ниже.
Следует отметить, что для pin-диодов с довольно протяженной базовой областью ВАХ на СВЧ не проявляется, т. к. время пролета носителей заряда через базу и время переключения обычно значительно превышает период колебаний. Поскольку время жизни в слаболегированном Si на несколько порядков превышает период, колебание заряда, накопленного при подаче сравнительно небольшого тока прямого смещения, остается незначительным даже при протекании через открытый диод СВЧ тока, многократно (на порядки) превышающего I 0 . Аналогичная ситуация реализуется при обратном смещении: высокий импеданс диода сохраняется при больших амплитудах СВЧ напряжения, которое может далеко заходить в область положительного смещения (но не должно превышать напряжения пробоя, которое в pin-диоде часто составляет сотни вольт и более).
Варианты конструкции переключательного диода
Основные варианты конструкции pin-диодов показаны на рис. 4.9. Простейший из них используется для наиболее мощных приборов (см. рис. 4.9,а). Пластина высокоомного Si легируется с двух сторон (методом диффузии или ионной имплантации) и после нанесения металлических контактных слоев разрезается на квадратные кристаллы площадью до 1 мм2, которые монтируются в корпус. Толщина базовой области может достигать 0,5 мм. Такие приборы обычно применяются на низкочастотном краю СВЧ диапазона.
При увеличении рабочей частоты требуются приборы с меньшими активными размерами. Для этого изготавливается пластина на сильнолегированной подложке с эпитаксиальным i-слоем нужной толщины. Поверхность слоя легируется и покрывается металлом. После фотолитографии и травления формируются меза-структуры требуемой площади (см. рис. 4.9,б).
Для гибридных СВЧ ИС удобна конструкция планарно-эпитаксиального диода с балочными выводами. Его топологическая схема и разрез структуры приведены на рис. 4.9 , в , при изготовлении используются методы эпитаксии и ионной имплантации.
| |
| |
| Рис. 4.9. Конструкции pin-диодов
|
| | | |
Значительный интерес представляет отечественная разработка pin-диода, не имеющего зарубежных аналогов. Приборы изготавливаются на тонкой мембране, полученной травлением Si пластины определенной ориентации (см. рис. 4.10,а). По периметру мембраны сохраняется кольцо, обеспечивающее ее механическую прочность при дальнейших операциях. Толщина рабочей части мембраны задается из условия последующего формирования структур с заданной толщиной базы и может быть снижена до единиц микрометров. Вид области изготовленной пластины с диодами приведен на рис. 4.10,б, где указаны основные размеры в миллиметрах. Готовый бескорпусный pin-диод с балочными выводами из золота (в укрупненном масштабе) изображен на рис. 4.10,в.
| |
| |
| Рис. 4.10. Диоды, изготовленные на основе Si мембраны
|
| | | |
Схема с указанием основных этапов технологического процесса приведена на рис. 4.11.
| | Формирование кремниевой мембраны
| | Диффузия для создания p+- и n+-слоев
| | Нанесение Au на обе поверхности
| | Травление Si до формирования структур заданного диаметра
| | Разрезание на отдельные диоды
|
|
|
Рис. 4.11. Этапы технологического процесса изготовления диодов типа «Самшит»
|
Основным достоинством разработанных диодов является минимальный объем кремния, необходимый для формирования активной области. Отсутствие пассивных участков снижает потери, вносимые прибором, что исключительно важно для переключательных и ограничительных диодов.
Как правило, диоды, изготовленные по мембранной технологии, используются в бескорпусном варианте, защита диодной структуры может выполняться с помощью смолы. Для монтажа приборов в планарные линии гибриных ИС применяюткя пайка или контактная сварка.
Как было показано, традиционным материалом для переключательных pin-диодов является кремний, который характеризуется высоким временем жизни носителей заряда (его значение для чистых кристаллов может превышать 1 мс [6]). Благодаря этому достигается малое сопротивление диода при прямом смещении, см. соотношение (4.5). Однако этот же фактор увеличивает время переключения приборов. В GaAs время жизни на несколько порядков ниже, что частично компенсируется более высокой подвижностью носителей. Кроме этого, GaAs эффективно используется для создания монолитных СВЧ ИС (см. раздел 9.4). Поэтому для наиболее быстродействующих переключателей применяются GaAs pin-диоды, а также полевые транзисторы (см. раздел 9.3). Для устройств высокой мощности предпочтительным материалом остается Si, который обладает также более высокой удельной теплопроводностью.
Дата добавления: 2018-05-25; просмотров: 2692;
 . Поэтому сопротивление Ri вносит вклад в активную компоненту импеданса диода, но практически не влияет на его реактивную компоненту. Можно считать, что
. Поэтому сопротивление Ri вносит вклад в активную компоненту импеданса диода, но практически не влияет на его реактивную компоненту. Можно считать, что  , где S – площадь диодной структуры. Это означает, что при изменении напряжения смещения и перемещении границы участков базовой области изменяется соотношение компонент Xi и Xj , а их сумма остается практически постоянной, она определяется размерами слаболегированного i-слоя. Сопротивление Ri легко рассчитывается для каждого значения напряжения смещения с учетом концентрации примеси и толщины w – a необедненного участка базы. После этого можно найти элементы последовательной эквивалентной схемы i‑области, которая чаще используется при анализе и проектировании приборов и устройств на их основе.
, где S – площадь диодной структуры. Это означает, что при изменении напряжения смещения и перемещении границы участков базовой области изменяется соотношение компонент Xi и Xj , а их сумма остается практически постоянной, она определяется размерами слаболегированного i-слоя. Сопротивление Ri легко рассчитывается для каждого значения напряжения смещения с учетом концентрации примеси и толщины w – a необедненного участка базы. После этого можно найти элементы последовательной эквивалентной схемы i‑области, которая чаще используется при анализе и проектировании приборов и устройств на их основе.
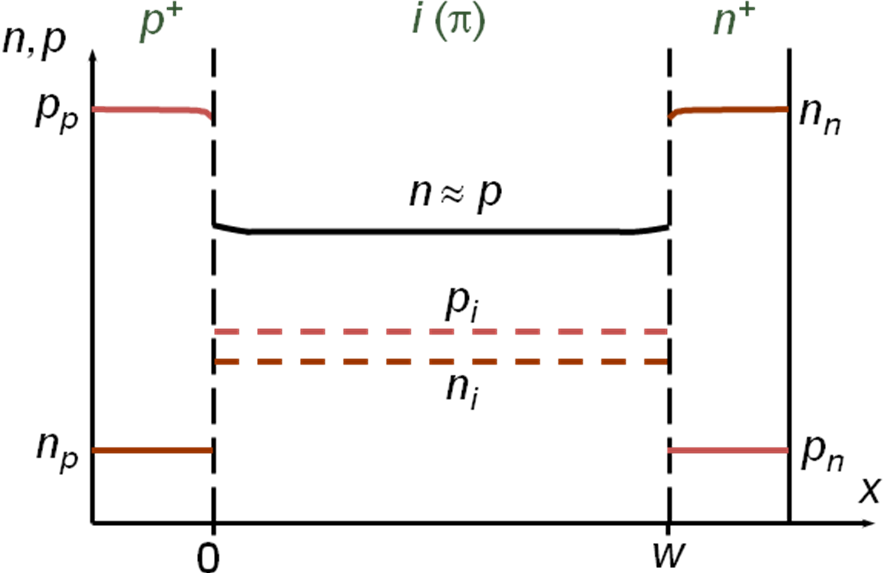
 .
.
 ;
;  ,
,
 ,
,
 ,
,
 – среднее значение подвижности электронов и дырок.
– среднее значение подвижности электронов и дырок. .
.










