Электрофизические и магнитные свойства материалов
Электропроводность – свойство материалов проводить электрический ток обусловленное наличием в них подвижных зарядов – носителей тока. Природу электропроводности твердых тел объединяет зонная теория – квантовая теория энергетического спектра элементов в твердых телах, согласно которой этот спектр состоит из чередующихся зон разрешенных и запрещенных энергий.
В нормальном состоянии электроны могут иметь только определённые значения энергии, т.е. занимать разрешённые энергетические уровни. Эти уровни образуют в твердом теле валентную зону, которую при температуре абсолютного нуля целиком заполнена электронами. Пустые или частично заполненные более высокие уровни образуют зону проводимости. Возбуждаясь, т.е. приобретая добавочную энергию (нагревание, излучение, электрическое поле и др.), валентные электроны могут переходить в зону проводимости. Основной вклад в электропроводность дают ионы, образованные в результате разрыва химических связей [1].
Электрическое сопротивление постоянному току, приводящие к переходу электрической энергии в теплоту, называют активным или омическим. Для кристаллических материалов оно связано с рассеянием электронов проводимости и может быть записано:
ρΣ=ρф +ρпр + ρд +ρгр
где ρф – рассеяние на тепловых колебаниях кристаллической решетки (фононах), ρпр , ρд и ρгр - примесных атомах, дефектах структуры и границах зерен, соответственно. Видно, что электрическое сопротивление зависит от температуры и только при Т=0 К, когда тепловые колебания атомов отсутствуют, оно полностью определяется составом и кристаллической структурой материала.
Электрическое сопротивление переменному току называется полным – в его цепи любой проводник, помимо активного (Ra), обладает емкостным R e и индуктивным RL сопротивлениями, которые обусловлены передачей энергии электрическому и магнитному полям.
С увеличением частоты полное Ra возрастает, поскольку растут R e и RL и ток вытесняется к поверхности проводника (скин-эффект).
Основными электрическими свойствами материалов являются:
- удельное электрическое сопротивление: ρ =R хS/L, где S- площадь поперечного сечения образца, L и R - его длина и сопротивление;
-удельная электропроводность: σ=1/ ρ. Для проводников σ = 105 … 108 (Ом/м)-1, для полупроводников σ = 10-3…105Ом/м) -1 , для диэлектриков σ= 10 -16 …10-3(Ом/м)-1[2]..
Связь с коэффициентом теплопроводности
Закон Видемана — Франца устанавливает однозначную связь удельной электрической проводимости σ с коэффициентом теплопроводности K:
К/ σ = π2 /3 х (k /e )2 T
где k — постоянная Больцмана, e — элементарный заряд [3].
Проводниковые металлы и сплавы
Проводниковые металлы и сплавы должны обладать высокой электропроводностью, достаточно высокими механическими свойствами, сопротивляемостью к атмосферной коррозии, способностью поддаваться обработке давлением в горячем и холодном состоянии.
После серебра наиболее высокой электропроводностью обладают медь и алюминий. Они и являются наиболее распространенными проводниковыми материалами. Проводимость отожженного проводникового алюминия составляет приблизительно 62% проводимости стандартной меди. Но плотность алюминия мала, поэтому проводимость 1 кг алюминия составляет 214% проводимости 1 кг меди. Следовательно, алюминий экономически более выгоден для использования в качестве проводникового материала.
Применяемые в настоящее время проводниковые материалы можно разделить на следующие группы: проводниковая медь, проводниковый алюминий, проводниковые сплавы, проводниковое железо, сверхпроводники [4]..
Проводниковая медь. При наличии в меди даже небольшого количества примесей ее электропроводность быстро уменьшается (рисунок 3.1). Для изготовления электрических проводов применяют электролитическую (катодную) медь, с суммарным содержанием примесей не более 0,05%. Катоды переплавляются в слитки, при этом содержание примесей в меди повышается. Проводниковая медь марки Ml должна содержать не более 0,1% примесей, в том числе не более, %: 0,001 Bi; 0,002 Sb; 0,002 As; 0,005 Fe; 0,002 Ni; 0,005 Pb; 0,002 Sn; 0,005 S; 0,05 O; 0,003 Ag. Фосфор для раскисления меди марки М1 не применяется.
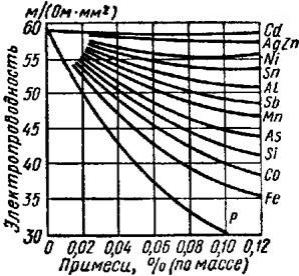
Рисунок 3.1 – Влияние примесей на электропроводность меди
Проводниковая медь имеет в отожженном состоянии предел прочности 270 МПа. Предел прочности меди может быть повышен до 480 МПа путем холодной деформации, но при этом ее удельное сопротивление увеличивается (рисунок 3.2).
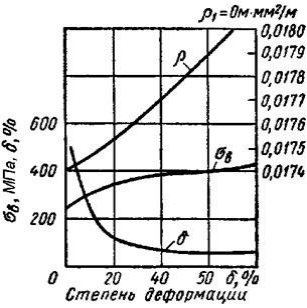
Рисунок 3.2 – Зависимость механических свойств и удельного электрического сопротивления меди марки М1 от степени деформации
Проводниковый алюминий. Недостатком алюминия является его сравнительно низкая прочность. Отожженный алюминий почти в три раза менее прочен на разрыв, чем медь. Поэтому при изготовлении проводов его упрочняют путем холодной деформации. В этом случае предел прочности составляет 250 МПа, что является недостаточным для сопротивления сильному натяжению, которое испытывают провода в линиях электропередач. Поэтому для линий электропередач применяют провода со стальной сердцевиной [5].
Для кабельных и токопроводящих изделий применяют алюминий марок А00, А0, Al, A2. Проводниковый алюминий обычно содержит десятые доли процента примесей, из которых основными являются железо и кремний (таблица 3.1).
Таблица 3.1.Химический состав алюминия технического деформируемого,(%):
| Марка | Al(не менее) | Примеси (не более) | Сумма допустимых примесей (не более) | |||||||
| Fe | Si | Cu | Mn | Zn | Тi | Mg | Прочие | |||
| А00 А0 А1 А2 | 99,70 99,50 99,30 98,80 | 0,16 0,30 0,30 0,50 | 0,16 0,30 0,30 0,50 | 0,015 0,02 0,05 0,1 | 0,02 0,025 0,025 0,1 | 0,08 0,1 0,1 0,1 | 0,05 0,1 0,15 0,15 | 0,03 0,05 0,05 0,1 | 0,015 0,02 0,02 0,02 | 0,30 0,50 0,70 1,2 |
Термическая обработка проводникового алюминия для снижения его сопротивления обычно не применяется, так как холодная обработка алюминия мало снижает его электропроводность. Так при обжатии до 95 – 98% электропроводность уменьшается не более чем на 1,2% электропроводности стандартной меди [6].
Проводниковые сплавы. В тех случаях, когда требуется повышенная прочность или специальные свойства (например, повышенное сопротивление истиранию), применяют сплавы на алюминиевой и медной основе. Композицию сплавов подбирают таким образом, чтобы легирующий металл не растворялся в основном металле, а упрочнение сплавов достигалось за счет интерметаллических фаз.
Проводниковое железо. Удельное электрическое сопротивление железа в 7 – 8 раз выше, чем у меди. Тем не менее, железо применяют в промышленности, т.к. оно является недефицитным материалом и имеет повышенную механическую прочность. При использовании железа в качестве проводникового материала оно должно быть достаточно чистым. Обычно для этих целей применяют армко-железо.
Железо используют при изготовлении биметаллических проводов, в этом случае сердцевину провода изготовляют из железа, а поверхностный слой из материала, имеющего более высокую электрическую проводимость (медь, алюминий).
Полупроводниковые материалы — вещества с чётко выраженными свойствами полупроводников в широком интервале температур, включая комнатную (~ 300 К), являющиеся основой для создания полупроводниковых приборов. Для полупроводниковых материалов характерна высокая чувствительность электрофизических свойств к внешним воздействиям (нагрев, облучение, деформации и т. п.), а также к содержанию структурных дефектов и примесей.
Полупроводниковые материалы по структуре делятся на кристаллические, твёрдые, аморфные и жидкие [7].
Кристаллические полупроводниковые материалы
Наибольшее практическое применение находят неорганические кристаллические полупроводниковые материалы, которые по химическому составу разделяются на следующие основные группы.
Элементарные полупроводники: Ge, Si, углерод (алмаз и графит), В, α-Sn (серое олово), Те, Se. Важнейшие представители этой группы — Ge и Si имеют кристаллическую решётку типа алмаза (алмазоподобны). Являются непрямозонными полупроводниками; образуют между со-бой непрерывный ряд твёрдых расплавов,также обладающих полупроводниковыми свойствами.
Соединения элементов III и V группы периодической системы имеют в основном кристалл-лическую структуру типа сфалерита. Связь атомов в кристаллической решётке носит преимущественно ковалентный характер с некоторой долей (до 15 %) ионной составляющей. Плавятся конгруэнтно (без изменения состава). Обладают достаточно узкой областью гомогенности, то есть интервалом составов, в котором в зависимости от параметров состояния (температуры, давления и др.) преимуществ. тип дефектов может меняться, а это приводит к изменению типа проводимости (n, р) и зависимости удельной электрической проводимости от состава. Важнейшие представители этой группы: GaAs, InP, InAs, InSb, GaN, являющиеся прямозонными полупроводниками, и GaP, AlAs — непрямозонные полупроводники. Многие полупроводниковые материалы типа образуют между собой непрерывный ряд твёрдых расплавов — тройных и более сложных.
Рассмотрим соединения элементов VI группы с элементами I—V групп периодической системы, а также с переходными металлами и редко-земельными элементами. В обширной группе этих полупроводниковых материалов наибольший интерес представляют соединения с кристаллической структурой типа сфалерита или вюрцита, реже типа NaCl. Связь между атомами в решётке носит ковалентно-ионный характер (доля ионной составляющей достигает 45-60 %). Имеют большую, чем у полупроводниковых материалов типа AIIIBV, протяженность области гомогенности. Для соединений типа AIIBVI характерен полиморфизм и наличие политипов кубической и гексагональной модификаций. Являются в основном прямозонными полупроводниками. Важнейшие представители этой группы полупроводниковых материалов — CdTe, CdS, ZnTe, ZnSe, ZnO, ZnS. Многие соединения типа AIIBVI образуют между собой непрерывный ряд твёрдых расплавов, характерными представителями которых являются CdxHg1-xTe, CdxHg1-xSe, CdTexSe1-x. Физические свойства соединений типа AIIBVI в значительной мере определяются содержанием собственных точечных дефектов структуры, имеющих низкую энергию ионизации и проявляющих высокую электрическую активность.
Тройные соединения типа AIIBIVCV2 кристаллизуются в основном в решётке халькопирита. Обнаруживают магнитное и электрическое упорядочение. Образуют между собой твёрдые расплавы. Во многом являются электронными аналогами соединений типа АIIIВV. Типичные представители: CuInSe2, CdSnAs2, CdGeAs2, ZnSnAs2.
Карбид кремния SiC — единственное химическое соединение, образуемое элементами IV группы. Обладает полупроводниковыми свойствами во всех структурных модификациях: β-SiC (структура сфалерита); α-SiC (гексагональная структура), имеющая около 15 разновидностей. Один из наиболее тугоплавких и широкозонных среди широко используемых полупроводниковых материалов.
Некристаллические полупроводниковые материалы
Типичными представителями этой группы являются стеклообразные полупроводниковые материалы — халькогенидные и оксидные. К первым относятся сплавы Tl, P, As, Sb, Bi с S, Se, Те, характеризующиеся широким диапазоном значений удельной электрической проводимости, низкими температурами размягчения, устойчивостью к кислотам и щелочам. Типичные представители: As2Se3-As2Te3, Tl2Se-As2Se3. Все стеклообразные полупроводниковые материалы имеют электронную проводимость, обнаруживают фотопроводимость и термоэдс. При медленном охлаждении обычно превращаются в кристаллические полупроводниковые материалы. Другим важным классом некристаллических полупроводниковые материалы являются твёрдые расплавы ряда аморфных полупроводников с водородом, так называемые гидрированные некристаллические полупроводниковые материалы: a-Si:H, a-Si1-xCx:H, a-Si1-xGex:H, a-Si1-xNx:H, a-Si1-xSnx:H. Водород обладает высокой растворимостью в этих полупроводниковых материалах и замыкает на себя значительное количество «болтающихся» связей, характерных для аморфных полупроводников. В результате резко снижается плотность энергетических состояний в запрещенной зоне и появляется возможность создания р-n-переходов. Полупроводниковыми материалами являются также ферриты, сегнетоэлектрики и пьезоэлектрики[14]..
Основные электрофизические свойства
Основные электрофизические свойства важнейших полупроводниковых материалов представлены в табл.3. 2.
Таблица 3.2. Основные свойства важнейших полупроводниковых материалов.
| В-во | Тпл, оС | Тип крист.решетки | Постоян-ные решетки, нМ (300К) | Плот-ность г/см2 | Коэф.лин. расшир. αх10 4 К -1 | Подвижность электронов, см2/К . с | Подвижность дырок, см2/К . с |
| Элементарные полупроводники | |||||||
| Si Ge | Кубич. типа алмаза | 0,543072 0,565754 | 2,3283 5,326 | 2,4 (300К) 5,75 (300К) | 1500(300К) 4500(300К) | 480(300К) 1900(300К) | |
| Соединения АШ ВV | |||||||
| GaAs InAs GaSb InSb GaP InP | Кубический типа сфалерита (обозначение К1) | 0,56335 0,605838 0,609686 0,64795 0,54495 0,586875 | 5,3161 5,667 5,6122 5.775 4,1297 4,787 | 6,0(300К) 5,19(300К 6(300К) 5,04(300К 5,1(300К) 4,75(300К | 8500(300К) 35000(300К 4000(300К) 80000(300К 300(300К) 5000(300К) | 450(300К) 540(300К) 1400(300К) 750(300К) 100(300К) 200(300К) | |
| Соединения АП ВVI | |||||||
| ZnS CdS CaSe CdTe HgTe ZnSe ZnTe | Кубический типа сфалерита (обозначение К1) | 5.4093 5,84 0,6050 6,482 6,463 5,6687 6,1033 | 4,09 4,825 5,81 5,85 8,076 5,264 5,633 | 6,14(300К) 6,5(300К) - 4,9(300К) 4,0(300К) 9,44(300К) 9,2(300К) | 300(300К) 500(300К) 40000(300К - | - - - 38000(77К) - | |
| Соединения АIV ВVI | |||||||
| PbS PbSe SnSe PbTe SnTe | Кубическая типа NaCl Орторомбическая Кубическая типа NaCl | 5,935 6,1265 a=4,46;d= 4,14;c=11,47 6,4603 6,3272 | 7,6068 8,274 6,179 8,242 6,445 | 20,3 19,4 -26,6;35,5; 26,7 19,8 20,8 | 614 (293К) 30000(77К) - 40000(77К) - | 800(300К) 30000(77К) 70000(77К) 30000(77К) 10000(77К) |
Ширина запрещенной зоны DEg является одним из фундаментальных параметров полупроводниковых материалов. Чем больше DEg, тем выше допустимая рабочая температура и тем более сдвинут в коротковолновую область спектра рабочий диапазон приборов, создаваемых на основе соответствующих полупроводниковых материалов. Например, максимальная рабочая температура германиевых приборов не превышает 50-60 °C, для кремниевых приборов она возрастает до 150—170 °C, а для приборов на основе GaAs достигает 250—300 °C; длинноволновая граница собственной фотопроводимости составляет: для InSb — 5,4 мкм (77 К), InAs — 3,2 мкм (195 К), Ge — 1,8 мкм (300 К), Si — 1 мкм (300 К), GaAs — 0,92 мкм (300 К). Величина DEg хорошо коррелирует с температурой плавления. Обе эти величины возрастают с ростом энергии связи атомов в кристаллической решётке, поэтому для широкозонных полупроводниковых материалов характерны высокие температуры плавления, что создает большие трудности на пути создания чистых и структурно совершенных монокристаллов таких полупроводниковых материалов. Подвижность носителей тока в значительной мере определяет частотные характеристики полупроводниковых приборов. Для создания приборов сверхвысокочастотного диапазона необходимы полупроводниковые материалы, обладающие высокими значениями m.Аналогичное требование предъявляется и к полупроводниковым материалам, используемым для изготовления фотоприемников. Температура плавления и период кристаллической решётки, а также коэффициент линейного термического расширения играют первостепенную роль при конструировании гетероэпитаксиальных композиций. Для создания совершенных гетероструктур желательно использовать полупроводниковые материалы, обладающие одинаковым типом кристаллической решётки и минимальными различиями в величинах её периода и коэффициентах термического расширения. Плотность полупроводниковых материалов определяет такие важные технические характеристики, как удельный расход материала, масса прибора.
Необходимым условием достижения высоких электрофизических характеристик полупроводниковых материалов является их глубокая очистка от посторонних примесей. В случае Ge и Si эта проблема решается путём синтеза их летучих соединений (хлоридов, гидридов) и последующей глубокой очистки этих соединений с применением методов ректификации, сорбции, частичного гидролиза и специальных термических обработок. Хлориды особой чистоты подвергают затем высокотемпературному восстановлению водородом, прошедшим предварительную глубокую очистку, с осаждением восстановленных продуктов на кремниевых или германиевых прутках. Из очищенных гидридов Ge и Si выделяют путём термического разложения. В результате получают Ge и Si с суммарным содержанием остаточных электрически активных примесей на уровне 10−7−10−9%. Получение особо чистых полупроводниковых соединений осуществляют синтезом из элементов, прошедших глубокую очистку. Суммарное содержание остаточных примесей в исходных материалах не превышает обычно 10−4−10−5%. Синтез разлагающихся соединений проводят либо в запаянных кварцевых ампулах при контролируемом давлении паров летучего компонента в рабочем объёме, либо под слоем жидкого флюса (например, особо чистого обезвоженного В2О3). Синтез соединений, имеющих большое давление паров летучего компонента над расплавом, осуществляют в камерах высокого давления. Часто процесс синтеза совмещают с последующей дополнительной очисткой соединений путём направленной или зонной кристаллизации расплава.
Для выращивания монокристаллов полупроводниковых материалов также широко используют методы направленной и зонной кристаллизации расплава в контейнере. В случае разлагающихся соединений для получения монокристаллов требуемого стехиометрического состава процесс проводят в запаянных кварцевых ампулах, поддерживая равновесное давление паров летучего компонента над расплавом; часто для этого требуются камеры высокого давления, в которых поддерживается противодавление инертного газа. При получении монокристаллов необходимой кристаллографической ориентации используют ориентированные соответствующим образом монокристаллические затравки.
Для выращивания монокристаллов полупроводниковых материалов, обладающих подходящим сочетанием плотности и поверхностного натяжения расплава, используют метод бестигельной зонной плавки. Наибольшее распространение этот метод получил в технологии получения монокристаллов Si, имеющего сравнительно невысокую плотность и достаточно большое поверхностное натяжение расплава. Отсутствие контакта расплава со стенками контейнера позволяет получать этим методом наиболее чистые монокристаллы. Обычно процесс выращивания монокристалла совмещают с предварительной дополнительной очисткой полупроводниковых материалов зонной плавкой.
Для получения монокристаллов ряда тугоплавких разлагающихся полупроводниковых соединений (например, CdS, ZnS, SiC, AlN и др.) используют кристаллизацию из газовой фазы (методы сублимации и химических транспортных реакций). В случае если при выращивании монокристаллов не удается получить соединение требуемого стехиометрического состава, кристаллы разрезают на пластины, которые подвергают дополнительному отжигу в парах недостающего компонента. Наиболее часто этот прием используют в технологии получения монокристаллов узкозонных соединений типа AIIBVI и AIVBVI, где собственные точечные дефекты сильно влияют на концентрацию и подвижность носителей тока, то есть проявляют высокую электрическую активность (PbTe, PbxSn1-xTe, CdxHg1-xTe и др.). При этом удается снизить концентрацию носителей заряда в кристаллах на несколько порядков.
Широко распространено получение полупроводниковых материалов в виде монокристаллических пленок на разного рода монокристаллических подложках. Такие пленки называют эпитаксиальными, а процессы их получения — эпитаксиальным наращиванием. Если эпитаксиальная пленка наращивается на подложку того же вещества, то получаемые структуры называют гомоэпитаксиальными; при наращивании на подложку из другого материала — гетероэпитаксиальными. Возможности получения тонких и сверхтонких однослойных и многослойных структур разнообразной геометрии с широкой вариацией состава и электрофизических свойств по толщине и поверхности наращиваемого слоя, с резкими границами р-n-переходов и гетеропереходов обусловливают широкое использование методов эпитаксиального наращивания в микроэлектронике и интегральной оптике, в практике создания больших и быстродействующих интегральных схем, а также оптоэлектронных приборов.
Для получения эпитаксиальных структур полупроводниковых материалов используют методы жидкостной, газофазной и молекулярно-пучковой эпитаксии. Методом жидкостной эпитаксии получают гомо- и гетероэпитаксиальные структуры на основе соединений типа AIIIBV, AIIBVI, AIVBVI и их твёрдых расплавов. В качестве растворителя обычно используют расплав нелетучего компонента соответствующего соединения. Наращивание эпитаксиального слоя проводят либо в режиме программируемого снижения температуры, либо из предварительно переохлажденного расплава. Этим методом можно воспроизводимо получать многослойные структуры с толщинами отдельных слоев до ~ 0,1 мкм при толщинах переходных слоев на гетерограницах порядка десятков нм[15]..
Легирование
Для получения полупроводниковых материалов электронного типа проводимости (n-типа) с изменяющейся в широких пределах концентрацией носителей заряда (электронов) обычно используют донорные примеси, образующие «мелкие» энергетические уровни в запрещенной зоне вблизи дна зоны проводимости (энергия ионизации ≤ 0,05 эВ). Для полупроводниковых материалов дырочного типа проводимости (р-типа) аналогичная задача решается путём введения акцепторных примесей, образующих «мелкие» энергетические уровни в запрещенной зоне вблизи потолка валентной зоны. Такие примеси при комнатной температуре практически полностью ионизованы, так что их концентрация приблизительно равна концентрации носителей заряда, которая связана с подвижностями носителей соотношениями: sn = emnn для полупроводниковых материалов n-типа и sр = empp для полупроводниковых материалов р-типа (sn и sр — проводимость; mn и mр — подвижности электронов и дырок соответственно). Для Ge и Si основными донорными легирующими примесями являются элементы V гр. периодической системы: Р, As, Sb, a акцепторными — элементы III гр.: В, Al, Ga. Для соединений типа AIIIBV — соотв. примеси элементов VI гр. (S, Se, Те), а также Sn, и элементов II гр. (Be, Mg, Zn, Cd). Элементы IV гр. (Si, Ge) в зависимости от условий получения кристаллов и эпитаксиальных слоев соед. типа AIIIBV могут проявлять как донорные, так и акцепторные св-ва. В соед. типа AIIBVI и AIVBVI поведение вводимых примесей сильно осложняется присутствием собств. точечных структурных дефектов. Необходимые тип и величина проводимости в них обычно достигаются прецизионным регулированием отклонения состава от стехиометрического, обеспечивающего заданную концентрацию определённого типа собственных точечных дефектов структуры в криcталлах.
Перечисленные выше легирующие примеси образуют, как правило, твёрдые р-ры замещения и обладают достаточно высокой растворимостью (1018−1020 атомов/см³) в широком интервале температур. Растворимость их носит ретроградный характер, при этом максимум растворимости приходится на температурный интервал 700—900 °C в Ge, 1200—1350 °C в Si и 1100—1200 °C в GaAs. Эти примеси являются малоэффективными центрами рекомбинации носителей и сравнительно слабо влияют на величину их времени жизни.
Примеси тяжелых и благородных металлов (Fe, Ni, Cr, W, Cu, Ag, Аи и др.) в большинстве полупроводниковых материалов образуют глубокие, часто многозарядные донорные или акцепторные уровни в запрещенной зоне, имеют большие сечения захвата носителей заряда и являются эффективными центрами рекомбинации носителей, приводя к значительному снижению их времени жизни. Эти примеси обладают малой и обычно ярко выраженной ретроградной растворимостью в полупроводниковых материалах и имеют очень малые значения коэффициента распределения между кристаллом и расплавом. Легирование ими производят в тех случаях, когда надо получить полупроводниковые материалы с малым временем жизни носителей или с высоким удельным электрическим сопротивлением, достигаемым компенсацией мелких энергетических уровней противоположной природы. Последнее часто используют для получения полуизолирующих кристаллов широкозонных полупроводниковых материалов типа AIIIBV (GaAs, GaP, InP); легирующими примесями служат Cr, Fe, Ni.
Легирование полупроводниковых материалов обычно осуществляют непосредственно в процессах получения монокристаллов и эпитаксиальных структур. Примесь вводится в расплав либо в виде элемента, либо в виде сплава с данным полупроводниковым материалом (лигатуры). Часто легирование осуществляют из газовой фазы (паров) данного элемента или его легколетучих соединений. Это основной способ легирования в процессах эпитаксии при кристаллизации из газовой фазы. При молекулярно-пучковой эпитаксии источником легирующей добавки обычно является сама элементарная примесь. Расчет необходимого содержания легирующей примеси требует знания точной количественной связи между её концентрацией и заданными свойствами полупроводниковых материалов, а также основных физико-химических характеристик примеси: коэффициента распределения между газовой фазой и кристаллом (К), упругости паров и скорости испарения в широком интервале температур, растворимости в твёрдой фазе и т. п.
Одна из главных задач легирования — обеспечение равномерного распределения вводимой примеси в объёме кристалла и по толщине эпитаксиального слоя. При направленной кристаллизации из расплава равномерное распределение примеси по длине слитка достигается либо путём поддержания её постоянной концентрации в расплаве за счёт его подпитки из твёрдой, жидкой или газовой фазы, либо путём программированного изменения эффективного коэффициента распределения примеси при соответствующем изменении параметров процесса роста. При зонной перекристаллизации для примесей с К << 1 обычно используют целевую загрузку примеси в начальную расплавленную зону с последующим её проходом через всю заготовку. Эффективный способ повышения объемной однородности монокристаллов — воздействие на массоперенос в расплаве наложением магнитного поля. Однородного распределения примеси по толщине слоя в процессе жидкофазной эпитаксии достигают кристаллизацией при постоянной температуре в условиях подпитки расплава, а при газофазной эпитаксии — поддержанием постоянной концентрации легирующей примеси в газовой фазе над подложкой на протяжении всего процесса наращивания.
Легирование полупроводниковых материалов может быть осуществлено также путём радиационного воздействия на кристалл, когда в результате ядерных реакций с участием собственных атомов вещества образуются электрически активные примеси. Наибольший интерес для радиационного легирования представляет воздействие тепловыми нейтронами, которые обладают большой проникающей способностью, что обеспечивает повышенную однородность легирования. Легирование облучением тепловыми нейтронами обеспечивает строго контролируемое введение заданных концентраций примеси и равномерное её распределение в объёме кристалла. Однако в процессе облучения в кристалле образуются радиационные дефекты, для устранения которых необходим последующий высокотемпературный отжиг. Кроме того, может появиться наведенная радиоактивность, требующая выдержки образцов после облучения.
При создании структур с p-n-переходами для полупроводниковых приборов широко используют легирование путём диффузионного введения примеси. Профиль концентрации примеси при диффузии описывается обычно функцией ошибок и имеет вид плавной кривой, характер которой определяется следующими факторами: температурой и временем проведения процесса; толщиной слоя, из которого осуществляется диффузия; концентрацией и формой нахождения примеси в источнике, а также её электрическим зарядом и возможностью взаимодействия с сопутствующими примесями и дефектами в полупроводниковом материале. Из-за малых значений коэффициента диффузии основных легирующих примесей диффузионное легирование обычно проводят при высоких температурах (для Si, например, при 1100—1350 °C) и в течение длительного времени; при этом оно, как правило, сопровождается генерированием в кристалле значительного количества структурных дефектов, в частности дислокаций. При диффузионном легировании возникают трудности в получении тонких легированных слоев и достаточно резких p-n-переходов.
Для получения тонких легированных слоев перспективны процессы ионного легирования (ионной имплантации), при которых введение примесных атомов в приповерхностный слой материала осуществляется путём бомбардировки соответствующими ионами с энергией от нескольких КэВ до нескольких МэВ. Возможность введения практически любой примеси в любой полупроводниковый материал, низкие рабочие температуры процесса, гибкое управление концентрацией и профилем распределения вводимой примеси, возможность легирования через диэлектрические покрытия с получением тонких, сильно легированных слоев обеспечили широкое распространение этого метода в технологии полупроводниковых приборов. Однако в процессе ионного легирования генерируются собственные точечные дефекты структуры, возникают области разупорядочения решётки, а при больших дозах — аморфизованные слои. Поэтому для получения качественных легированных слоев необходим последующий отжиг введенных дефектов. Отжиг проводят при температурах существенно более низких, чем при диффузии (для Si, например, не выше 700—800 °C). После отжига свойства имплантированных слоев близки к свойствам материала, легированного до тех же концентраций традиционными методами [4].
Применение
Важнейшая область применения полупроводниковых материалов — микроэлектроника. Полупроводниковые материалы составляют основу современных больших и сверхбольших интегральных схем, которые делают главным образом на основе Si. Дальнейший прогресс в повышении быстродействия и в снижении потребляемой мощности связан с созданием интегральных схем на основе GaAs, InP и их твёрдых растворов с др. соединениями типа АIIIВV. В больших масштабах используют полупроводниковые материалы для изготовления «силовых» полупроводниковых приборов (вентили, тиристоры, мощные транзисторы). Здесь также основным материалом является Si, а дальнейшее продвижение в область более высоких рабочих температур связано с применением GaAs, SiC и др. широкозонных полупроводниковых материалов. С каждым годом расширяется применение полупроводниковых материалов в солнечной энергетике. Основными полупроводниковыми материалами для изготовления солнечных батарей являются Si, GaAs, гетероструктуры GaxAl1-xAs/GaAs, Cu2S/CdS, α-Si:H, гетероструктуры α-Si:H/α-SixC1-x:H. С применением в солнечных батареях некристаллических гидрированных полупроводниковых материалов связаны перспективы резкого снижения стоимости солнечных батарей. Полупроводниковые материалы используют для создания полупроводниковых лазеров и светодиодов. Лазеры делают на основе ряда прямозонных соединений типа AIIIBV, AIIBIV, AIVBVI и др. Важнейшими материалами для изготовления лазеров являются гетероструктуры: GaxAl-xAs/GaAs, GaxIn1-xAsyP1-y/InP, GaxIn1-xAs/InP, GaxIn1-xAsyP1-y/GaxAs1-xPx, GaN/AlxGa1-xN. Для изготовления светодиодов широко используют: GaAs, GaP, GaAs1-xPx, GaxIn1-xAs, GaxAl1-xAs, GaN и др. Полупроводниковые материалы составляют основу современных приемников оптического излучения (фотоприемников) для широкого спектрального диапазона. Их изготовляют на основе Ge, Si, GaAs, GaP, InSb, InAs, GaxAl1-xAs, GaxIn1-xAs, GaxIn1-xAsyP1-y, CdxHg1-xТе, PbxSn1-xTe и ряда др. полупроводниковых материалов. Полупроводниковые лазеры и фотоприемники — важнейшие составляющие элементной базы волоконно-оптической линий связи. Полупроводниковые материалы используются для создания различных СВЧ приборов (биполярных и полевых транзисторов, транзисторов на «горячих» электронах, лавинопролетных диодов и др.). Другие важные области применения полупроводниковых материалов: детекторы ядерных излучений (используют особо чистые Ge, Si, GaAs, CdTe и др.), изготовление термохолодильников (теллуриды и селениды висмута и сурьмы), тензодатчиков, высокочувствительных термометров, датчиков магнитных полей и др [5].
Диэлектрики
Ток в диэлектриках называют током утечки и различают Io протекающий через объём материала и Iп- протекающий по поверхности образца. Соответственно диэлектрики характеризуют объёмным ρо (Ом*м) и поверхностным ρп (Ом) удельным электрическим сопротивлением.
Поляризация диэлектриков - смещение связанных электрических зарядов под действием внешнего электрического поля. При этом в материале создаётся собственное внутреннее электрическое поле, направленное против внешнего поля. Механизмы поляризации обусловлены природой химических связей в диэлектриках, но при любом из них в материале образуется электрические диполи, которые характеризуются дипольным моментом: Р= g l, где q-точечный заряд диполя, l-расстояние между зарядами (плечо диполя). Поляризацию диэлектриков количественно характеризуют дипольным моментом единого объёма материала или вектором поляризации:
Особый класс диэлектриков составляют сегнетоэлектрики, обладающие в определенном интервале температур произвольной (спонтанной) поляризацией, сильно зависящей от внешних воздействий (активные диэлектрики).
Диэлектрические потери – часть энергии переменного электрического поля, необратимо переходящая в теплоту.
Пробой диэлектрика – резкое возрастание его электропроводности в электрических полях с напряженностью, превышающей некоторое критическое значение. Пробой м.б. разной природы, но всегда приводит к необратимой потере диэлектриками изоляционных свойств в результате шнурования тока по каналу пробоя. Напряженность однородного электрического поля, при которой наступает пробой, называют электрической прочностью или напряженностью пробоя диэлектрика.
Сверхпроводимость
С понижением температуры наблюдается монотонное падение электрического сопротивления материалов. Вблизи абсолютного нуля у многих металлов и сплавов происходит резкое падение электрического сопротивления, и они становятся сверхпроводниками (рисунок 3.3).
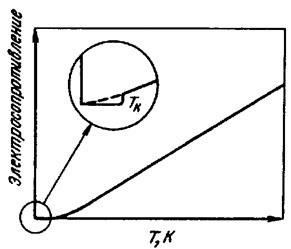
Рисунок 3.3 – Влияние температуры на электрическое сопротивление сверхпроводниковых материалов
Сверхпроводимость – способность материалов не оказывать сопротивления электрическому току при температурах ниже характерной для них критической температуры Тк.
Впервые сверхпроводимость обнаружил в 1911 г. голландский ученый Гейке Камерлинг-Оннес, который наблюдал скачкообразное исчезновение сопротивления ртути до неизмеримо малой величины при температуре 4,2 К.
К настоящему времени сверхпроводимость обнаружена у большинства чистых металлов, причем сверхпроводящее состояние легче всего возникает в металлах с низкой обычной проводимостью. Открыто и изучено около трех тысяч сверхпроводящих сплавов и интерметаллических соединений, и их число непрерывно растет. Чистые металлы принято относить к сверхпроводникам первого рода, а спл
| <== предыдущая лекция | | | следующая лекция ==> |
| Механические свойства материалов | | | ФУНКЦИОНАЛЬНЫЕ ЭЛЕМЕНТЫИ ФУНКЦИОНАЛЬНЫЕ МОДУЛИ АВИАЦИОННЫХ СИЛОВЫХ УСТАНОВОК |
Дата добавления: 2018-05-10; просмотров: 842;










